Содержание
- 2. В 1979 г. компания Intel разработала новый вид памяти — EEPROM Или по-нашему… ФЛЭШ-ПАМЯТЬ
- 3. Что такое Флэш-память Флэш-память (англ. Flash-Memory) — разновидность твердотельной полупроводниковой энергонезависимой перезаписываемой памяти Флэш-память может быть
- 4. преимущества её энергонезависимость более компактна чем CD-ROM , жёсткие диски, DVD дешева (с учётом стоимости устройств
- 5. малый объём (до 16 Гб ) недостатки
- 6. DVD
- 7. в качестве элементарных ячеек хранения информации используются полевые двухзатворные МОП-транзисторы (транзисторы с плавающим затвором).
- 8. Микросхемы NOR архитектура NOR предпочтительней, поскольку скорость произвольного доступа у нее выше. (например, для хранения программного
- 9. Микросхемы NAND обеспечивают более высокую плотность хранения информации, поэтому для записи/хранения большого количества информации используется преимущественно
- 10. МОП (металл-окисел-полупроводник) — это самый простой тип полевого транзистора. работает очень медленно высокая степень интеграции (занимают
- 11. Процесс записи информации для ячеек NOR сигнал ∆U на плавающий затвор инжектируются (впрыскиваются) электроны, изменяя его
- 12. Архитектура ячейки NAND
- 13. запись в ячейках NAND методом туннелирования электронов желтые частицы проходят сквозь барьер; красные частицы перепрыгивают его
- 14. Процесс стирания информации в ячейках NOR и NAND туннельный эффект: На управляющий затвор подается высокое напряжение
- 15. В настоящее время основные усилия разработчиков сосредоточены на наращивании объемов памяти и сокращении размеров носителей с
- 16. новые разработки
- 17. Перспективные запоминающие устройства (FRАМ, РFRАМ, МRАМ, OUM)
- 18. Успехи создания ЗУ на основе полупроводниковой технологии не снимают проблемы дальнейшего совершенствования микросхем памяти. Чтобы прибиться
- 19. ЗУ типа FRАМ (ферроэлектрические) В ферроэлектрических FRАМ (Ferroelectric RАМ) основой запоминающего элемента служит материал, в кристаллической
- 20. С помощью электрического поля можно придать внутреннему диполю тот или иной знак. Под воздействием внешнего электрического
- 21. ЗУ типа PFRAM (полимерно-ферроэлектрические) ЗУ типа PFRAM (Polimeric Ferroelectric RAM) – разновидность ферроэлектрических ЗУ. Они построены
- 22. В пленке, толщина которой меньше 0,1 мкм, образуются ориентированные диполи, которые служат запоминающими элементами, хранящими различные
- 23. Рисунок 16.3 Схематическая конструкция полимерно-ферроэлектрического ЗУ. Рисунок 16.3 Схематическая конструкция полимерно-ферроэлектрического ЗУ.
- 24. Процессы записи и чтения идентичны по быстродействию — и тот, и другой занимают приблизительно по 50
- 25. ЗУ типа MRAM (магниторезистивные) В ЗУ типа MRAM (Magnetoresistive RAM) битам двоичных данных соответствуют участки намагниченности,
- 26. Для создания MRAM можно использовать два типа эффектов — так называемый гигантский магниторезистивный эффект (Giant Magnetic-resistive
- 27. Конструкция запоминающего элемента типа MTJ включает в себя два ферромагнитных слоя, разделенных тонким слоем диэлектрика, действующим
- 28. Рисунок 16.4 Схематическая конструкция запоминающего элемента типа MTJ Рисунок 16.4 Схематическая конструкция запоминающего элемента типа MTJ
- 29. Современные разработки MRAM еще далеки от теоретически достижимых, уровень которых очень высок: время записи 2,3 не,
- 30. ЗУ типа ОUМ (с использованием фазовых переходов вещества) ЗУ типа OUM (Ovonyx Unified Memory, по названию
- 31. Фазовое состояние халкогенида программируется пропусканием через элемент импульсов тока, имеющих разные параметры. Управление током производится с
- 32. В элементе памяти с халкогенидом можно программировать сопротивление не только для двух его значений (максимального и
- 33. Запоминающие элементы OUM просты по конструкции, потребляют малую мощность, энергонезависимы, имеют неразрушающее чтение, допускают до 1012
- 34. Рисунок 16.5 Конструкция и схема запоминающего элемента памяти OUM Рисунок 16.5 Конструкция и схема запоминающего элемента
- 35. Параметры перспективных микросхем памяти, имеющих наибольшую степень практического освоения, приведены в табл. 1.
- 37. Скачать презентацию





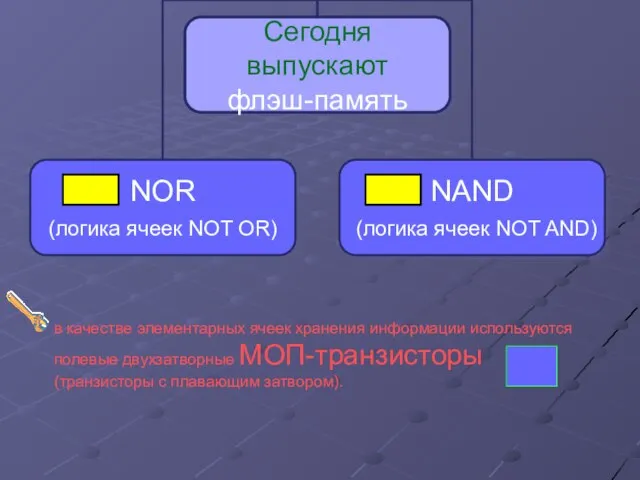



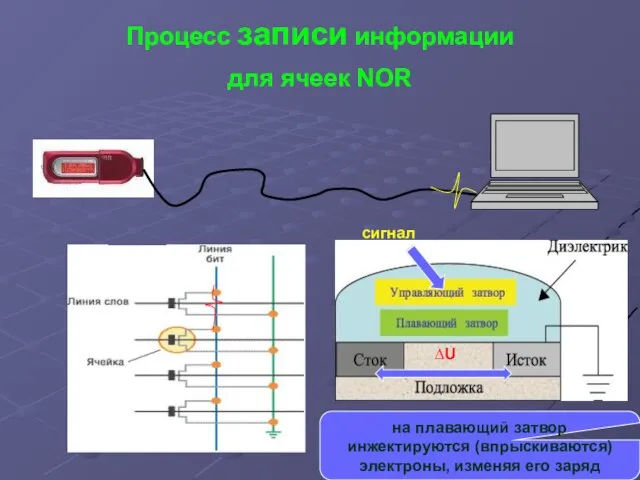











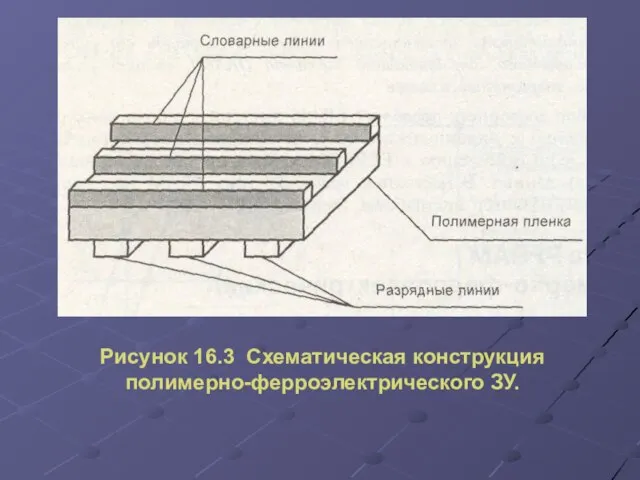












 Вселенная, или космос 1 класс
Вселенная, или космос 1 класс Технология выполнения штукатурных работ Выполнил мастер п/о Гордеюк А.Л.
Технология выполнения штукатурных работ Выполнил мастер п/о Гордеюк А.Л. Метод сокращенных таблицдля генерации автоматовс большим числом входных воздействий
Метод сокращенных таблицдля генерации автоматовс большим числом входных воздействий Депрессия и стресс
Депрессия и стресс Модернизация страхового рынка в России и роль ОЭСР в этом процессе
Модернизация страхового рынка в России и роль ОЭСР в этом процессе Муниципальное образовательное учреждение «Пежемскаяобщеобразовательная средняя школа №14»
Муниципальное образовательное учреждение «Пежемскаяобщеобразовательная средняя школа №14» В чём секрет русской орфографии
В чём секрет русской орфографии Метание малого мяча
Метание малого мяча SMO
SMO Рычаг Архимеда
Рычаг Архимеда Экономика России 2-й половины XVIII века
Экономика России 2-й половины XVIII века Цикл жизни IT-специалиста в современной компании. IT и HR: взаимодействие
Цикл жизни IT-специалиста в современной компании. IT и HR: взаимодействие Proyecto en Lengua Española
Proyecto en Lengua Española Вторжение на советскую землю началось На улицах осажденного Ленинграда.
Вторжение на советскую землю началось На улицах осажденного Ленинграда. Ферма Пьер
Ферма Пьер Презентация на тему Сочинение-описание помещения (6 класс)
Презентация на тему Сочинение-описание помещения (6 класс) Концепция духовно-нравственного развития и воспитания личности гражданина России
Концепция духовно-нравственного развития и воспитания личности гражданина России Презентация на тему создатель толкового словаряживого великорусского языка
Презентация на тему создатель толкового словаряживого великорусского языка Тема 10. ПРОФЕССИОНАЛЬНО-ПРИКЛАДНАЯ ФИЗИЧЕСКАЯ ПОДГОТОВКА СТУДЕНТОВ
Тема 10. ПРОФЕССИОНАЛЬНО-ПРИКЛАДНАЯ ФИЗИЧЕСКАЯ ПОДГОТОВКА СТУДЕНТОВ Seoul
Seoul Отчет Совета старшеклассников
Отчет Совета старшеклассников 7кл технические открытия
7кл технические открытия Лекция по дисциплине «Внешнеторговая документация» ТЕМА 1.1. Международная классификация внешнеторговых документов Принципы к
Лекция по дисциплине «Внешнеторговая документация» ТЕМА 1.1. Международная классификация внешнеторговых документов Принципы к Темперамент человека и мотивация
Темперамент человека и мотивация Давай поговорим поподробнее о зиме
Давай поговорим поподробнее о зиме Орфоэпические нормы
Орфоэпические нормы Презентация на тему Первые люди
Презентация на тему Первые люди  Надпредметная программа как способ приобщения школьников к чтению Ирина Евгеньевна Козлова, учитель русского языка и литератур
Надпредметная программа как способ приобщения школьников к чтению Ирина Евгеньевна Козлова, учитель русского языка и литератур