Содержание
- 2. Упругие напряжения и псевдоморфизм в гетероэпитаксиальных структурах При гетероэпитаксиальном росте слоев с различными межатомными расстояниями происходит
- 3. (111) Ромбоэдрический характер искажений Тетрагональный характер искажений Упругие напряжения и псевдоморфизм в гетероэпитаксиальных структурах При псевдоморфном
- 4. Характер упругих искажений кристаллической решетки при псевдоморфном росте (100) При псевдоморфном росте подложка навязывает свой период
- 5. Особенности распределения деформаций и напряжений: 1) изменение величины знака σ и ε при переходе через межфазную
- 6. Упругие напряжения и псевдоморфизм в гетероэпитаксиальных структурах При механическом равновесии - i-ый компонент силы на единицу
- 7. Закон Гука в применении к деформированным гетероструктурам Закон Гука Переход от тензорной записи к матричной тенз.:
- 8. Упругие напряжения и псевдоморфизм в гетероэпитаксиальных структурах Модули упругости соединений AIIIBV и AIIBVI [S. Adachi, Properties
- 9. Для полупроводников AIIIBV и AIIBVI Закон Гука в применении к деформированным гетероструктурам При ориентации слоя в
- 10. Закон Гука в применении к деформированным гетероструктурам Плотность упругой энергии для кубических кристаллов: При ориентации слоя
- 11. Закон Гука в применении к деформированным гетероструктурам Правило преобразования компонент тензоров при переходе из одной системы
- 12. Закон Гука в применении к деформированным гетероструктурам
- 13. Закон Гука в применении к деформированным гетероструктурам
- 14. Пример расчета деформированного состояния гетероструктуры Система ZnSySe1-y/GaAs (001) TS=300°C, x=0.06 Характеристики эпит. слоя: TS=300K Химически обусловленное
- 15. Пример расчета деформированного состояния гетероструктуры Система ZnSySe1-y/GaAs (001) TS=300°C, x=0.06 Характеристики эпит. слоя: TS=300°C (температура эпитаксии)
- 16. Пример расчета деформированного состояния гетероструктуры Система GaxIn1-xP/GaAs(111) TS=800°C, x=0.5 Характеристики эпит. слоя: TS=300K Химически обусловленное несоответствие
- 17. Пластическая релаксация и критические параметры гетероструктур При превышении толщины слоя, осаждаемого по механизму псевдоморфизма, некоторого критического
- 18. (100) Контур Бюргерса всегда замкнут Контур Бюргерса Совершенный кристалл: Пластическая релаксация и критические параметры гетероструктур Контур
- 19. Краевая дислокация образуется путем внедрения в кристалл лишней плоскости атомов ABCD, (экстраплоскости). Граница экстраплоскости - линия
- 20. Винтовая дислокация образуется при смещении части кристалла, разделенного плоскостью ABCD, относительно другой в направлении АВ. Линия
- 21. Принято считать, что устранение дилатационного несоответствия вдоль каждого направления в гетерогранице происходит независимым образом. Экспериментальным подтверждением
- 22. Экспериментальные данные позволяют выявить несколько механизмов генерации ДН: Пластическая релаксация и критические параметры гетероструктур Изгиб наклонных
- 23. Зарождение полупетель наиболее вероятно в процессе осаждения слоя на участках с высокими локальными напряжениями. Такими концентраторами
- 24. Пластическая релаксация и критические параметры гетероструктур Пластическая деформация приводит к уменьшению напряжений. Часть упругой энергии превращается
- 25. Если плоскость гетерограницы ориентирована по грани (100), то =54,74° Пластическая релаксация и критические параметры гетероструктур В
- 26. Пластическая релаксация и критические параметры гетероструктур Устойчивому состоянию отвечает минимум энергии деформации: Упругая энергия однородно деформированного
- 27. Пластическая релаксация и критические параметры гетероструктур Уравнение Мэттьюза-Блэксли. Получено на основе деформационного равновесия гетероструктур. Не содержит
- 28. Пластическая релаксация и критические параметры гетероструктур Пример расчета критической толщины по модели М-Б для системы ZnCdSe/GaAs(001)
- 29. Гетероструктуры с КЯ CdZnSe/ZnSe Неопределенность в определении hcr (разброс экспериментальных данных для системы ZnSe/GaAs) hcrZnSe/GaAs ~
- 30. Модификация модели MB (ρ – численный фактор, учитывающий энергию ядра дислокации) [C.A.B. Ball, J.H. van der
- 31. Пластическая релаксация и критические параметры гетероструктур Модель Пипла-Бина строится на балансе энергий. Предположено, что ДН возникают
- 32. Пластическая релаксация и критические параметры гетероструктур Поверхностная плотность энергии, связанная с изолированной винтовой дислокацией для слоя
- 33. Пластическая релаксация и критические параметры гетероструктур [L.B. Freund , W.D. Nix, A critical thickness condition for
- 34. Пластическая релаксация и критические параметры гетероструктур [Jan H. van dar Merwe and W. A. Jesser, Appl.
- 35. МПЭ широкозонных соединений А2В6
- 36. Схематическая зонная диаграмма лазерной ГС с сверхрешеточным волноводом и профиль напряжений в ГС Концепция компенсации упругих
- 37. Гетероструктуры с КТ CdSe/CdZnSe/ZnSe, излучающие в желтом спектральном диапазоне высокая плотность дефектов низкая эффективность ФЛ hcr
- 38. Wavelength, nm КТ Cd(Zn)Se ZnSe ZnCdSe КЯ Гетероструктуры с КТ CdSe/CdZnSe/ZnSe, излучающие в желтом спектральном диапазоне.
- 39. Зависимость среднего рассогласования по периоду решетки с подложкой GaAs для различных СР типа ZnS0.15Se0.85/ZnSe С.В. Сорокин
- 40. КТ CdSe-3.0МС/КЯ ZnCd0.5Se-2.1нм/ZnSe Ith – 2.5 кВт/см2 λ – 593 нм Несимметричный GIW СР волновод Спектры
- 41. Пластическая релаксация в градиентных слоях (на примере системы InxGa1-xAs) Изображение, полученное методом просвечивающей электронной микроскопии в
- 42. Пластическая релаксация в градиентных слоях (на примере системы InxGa1-xAs) In situ измерения аккомодированных напряжений при МПЭ
- 43. Согласно модели Данстана [Appl. Phys. Lett. 72, 1875 (1998) ] для слоев с линейным градиентом состава
- 44. Взаимодействие пучка рентгеновского излучения с веществом сводится к рассеянию излучения на электронных оболочках атомов. Длина волны
- 45. Метод двухкристальной ренгеновской дифрактометрии 1 2,3 4 5 6 Схема дифракционного эксперимента: 1 — трубка, 2
- 46. Метод двухкристальной ренгеновской дифрактометрии Поперечное сечение рентгеновской трубки X-лучи образуются при столкновении электронов высокой энергии с
- 47. Однородная деформация. Пик сдвигается без изменения формы. Неоднородная деформация. Пик уширяется. Интерпретация кривых качания ренгеновской дифрактометрии
- 48. Кривая РД для слоя Al0.5Ga0.5As0.12Sb0.88, выращенного на подложке InAs (100) при температуре 480ºС Кривая РД для
- 49. HRXRD дифракционные кривые вблизи рефлекса GaAs (004) для слоёв ZnSe различной толщины. Хорошо видна эволюция напряжений
- 50. и - угловые положения соседних сателлитов - угол Брэгга - длина волны ренгеновского излучения Метод двухкристальной
- 51. Метод поляризации фотолюминесценции Плосконапряженное состояние эпитаксиального слоя эквивалентно одноосной деформации, которая вызывает снятие вырождения валентной зоны
- 52. 2D слоистые материалы [A.K. Geim & I.V. Grigorieva, Van der Waals heterostructures, Nature 499, 419–425 (2013)]
- 53. Халькогениды металлов группы IIIA: Соединения типа MX (InS, InSe, InTe, GaS, GaSe и GaTe) Соединения типа
- 54. Объемные кристаллы GaSe состоят из вертикально упорядоченных слоев, которые удерживаются вместе силами Ван-дер-Ваальса. Различные варианты упаковки
- 55. Переход от непрямозонного к прямозонному полупроводнику в монослойных пленках MoS2 [K.F. Mak et al., Atomically Thin
- 56. Методы получения кристаллов и тонких пленок халькогенидов группы IIIA Ion intercalation top-down methods Sonication assisted exfoliation
- 57. Методы получения кристаллов и тонких пленок халькогенидов группы IIIA (эпитаксия vdW) Эпитаксия Ван-дер-Ваальса (vdW) Отсутствие требования
- 58. (a) ideal As terminated model, (b) Se-terminated model, (c) T4-site model, (d) H3-site model, (e) on-top
- 59. vdW Epitaxy of GaSe on Si(100) and mica substrates [X. Yuan et al., Arrayed van der
- 61. Скачать презентацию
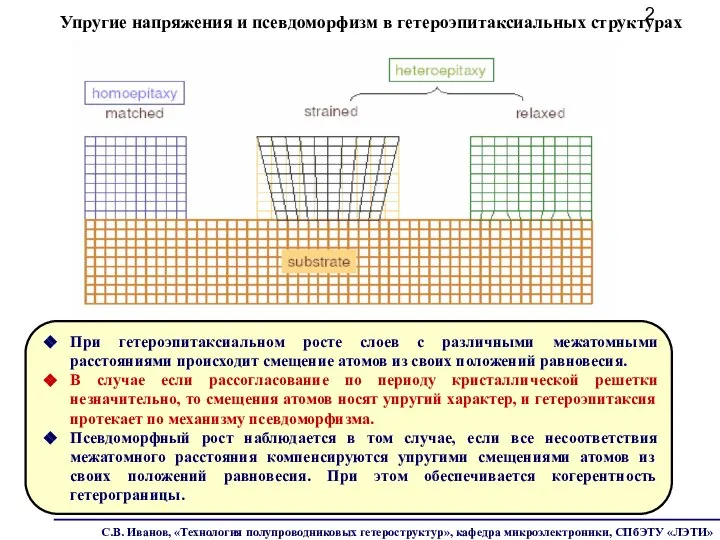














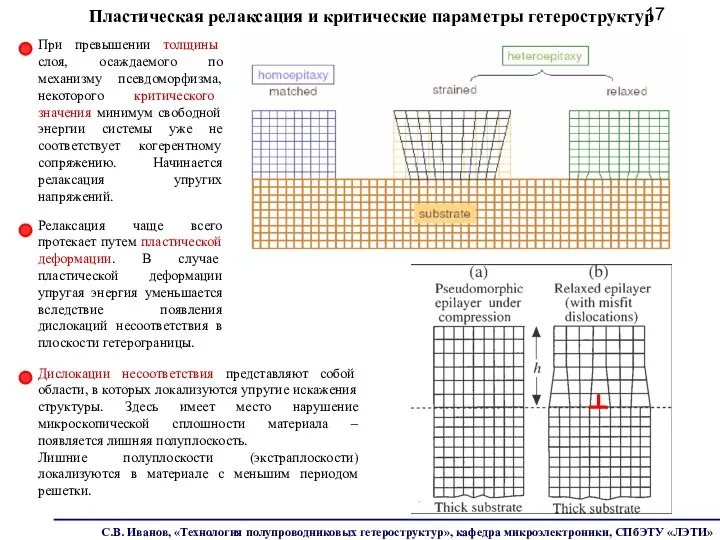




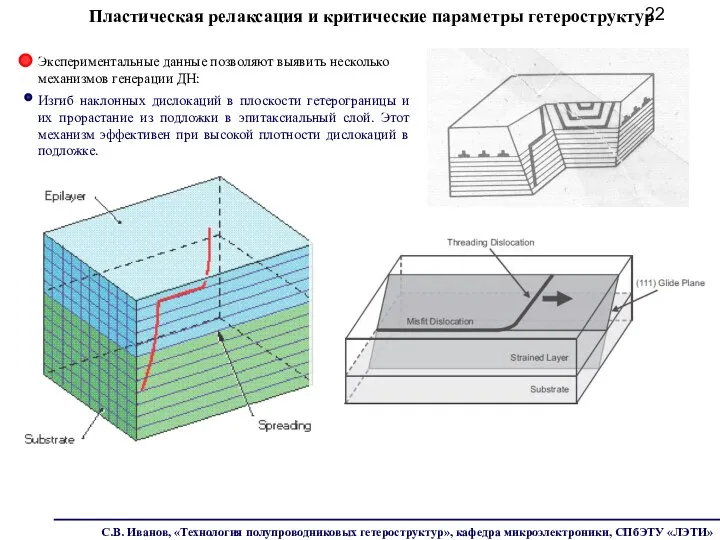






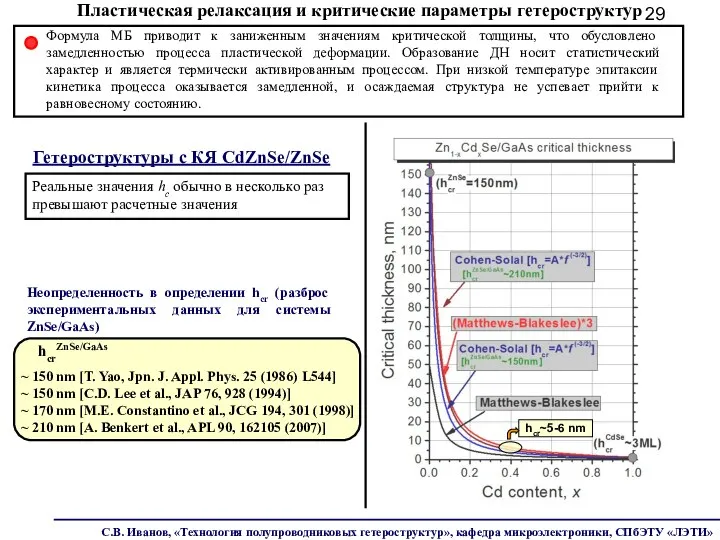
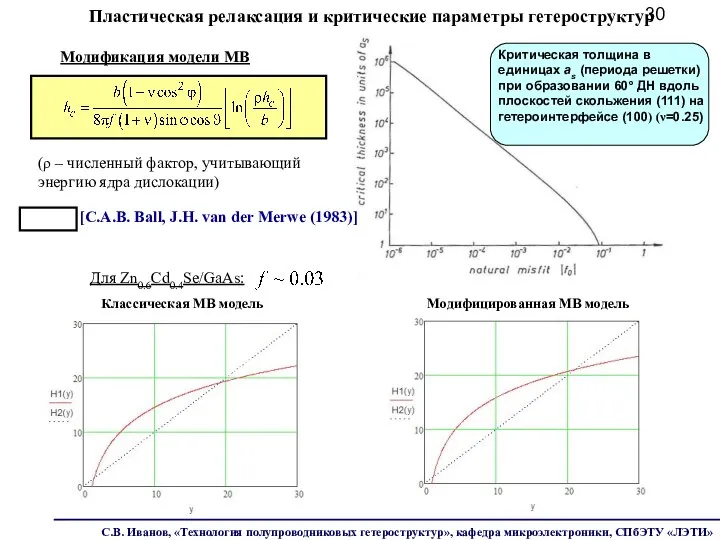






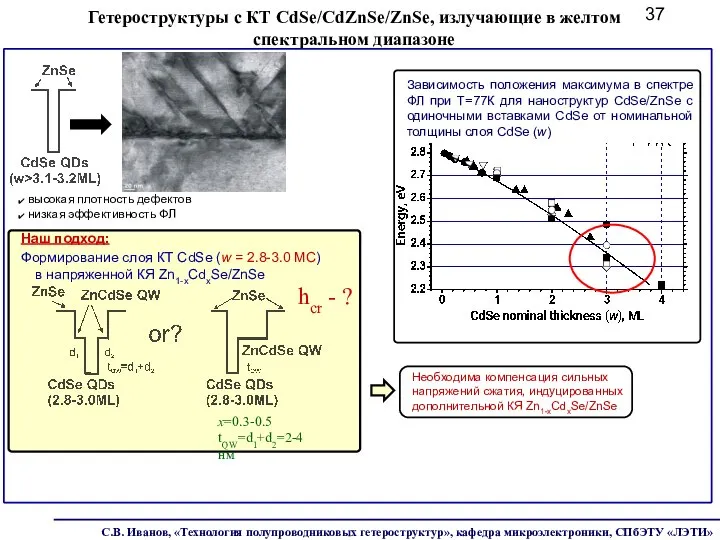





![Согласно модели Данстана [Appl. Phys. Lett. 72, 1875 (1998) ] для слоев](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1127031/slide-42.jpg)


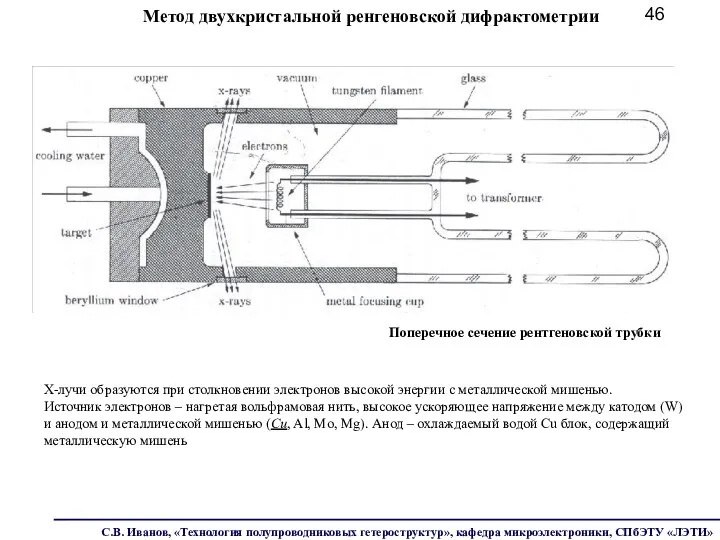

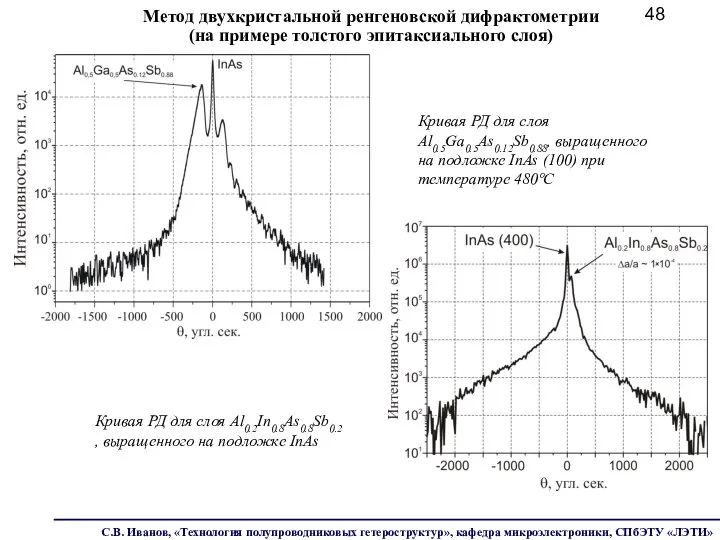
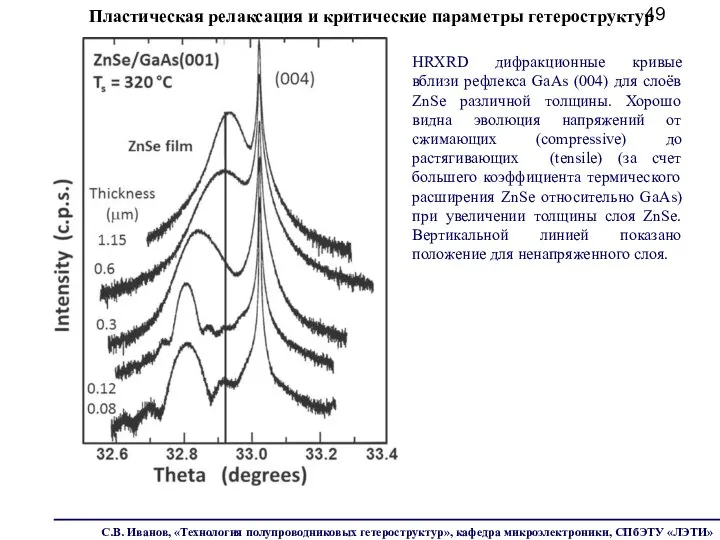






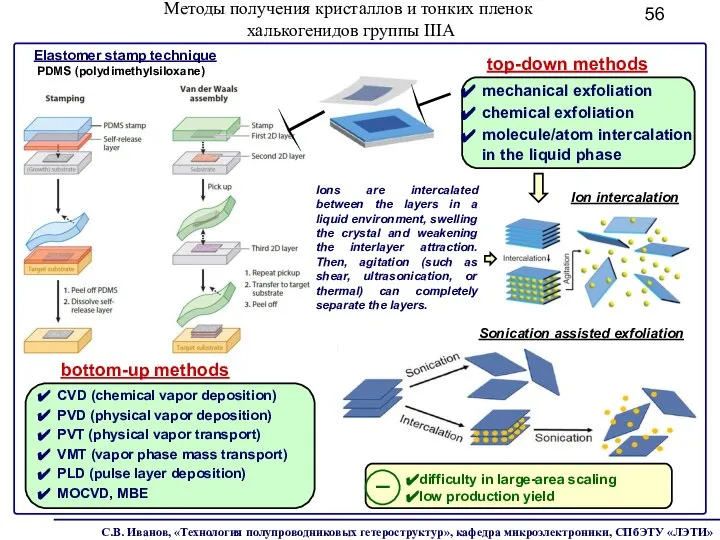



 «1С:Зарплата и управление персоналом 8» Сложные вопросы учета отпусков, командировок и листов нетрудоспособности на практически
«1С:Зарплата и управление персоналом 8» Сложные вопросы учета отпусков, командировок и листов нетрудоспособности на практически Презентация на тему Профилактика алкоголизма
Презентация на тему Профилактика алкоголизма Верхнеднепровский таможенный пост
Верхнеднепровский таможенный пост Latviešu virtuve
Latviešu virtuve 198188, г. Санкт-Петербург, пр. Стачек, 72, тел.(812)924-2-925
198188, г. Санкт-Петербург, пр. Стачек, 72, тел.(812)924-2-925 Мировая Религия. Буддизм
Мировая Религия. Буддизм Психология формирования ученического коллектива
Психология формирования ученического коллектива Особенности организации губок
Особенности организации губок Чары. Секретный день…
Чары. Секретный день… Ю Е К О И Ь Н Я Р ЮОИЕЯ КНР Ь Ю Е К О И Ь Н Я Р.
Ю Е К О И Ь Н Я Р ЮОИЕЯ КНР Ь Ю Е К О И Ь Н Я Р. ФОРМИРОВАНИЕКОММУНИКАТИВНОЙ КОМПЕТЕНТНОСТИ УЧАЩИХСЯ НА УРОКАХ ИНОСТРАННОГО ЯЗЫКА
ФОРМИРОВАНИЕКОММУНИКАТИВНОЙ КОМПЕТЕНТНОСТИ УЧАЩИХСЯ НА УРОКАХ ИНОСТРАННОГО ЯЗЫКА Инвестиционный проект. Аспекты анализа инвестиционных проектов. Жизненный цикл проекта. Принципы анализа проектов.
Инвестиционный проект. Аспекты анализа инвестиционных проектов. Жизненный цикл проекта. Принципы анализа проектов. Ночь искусств
Ночь искусств Вольная борьба, специфика, методы, направления
Вольная борьба, специфика, методы, направления Программное обеспечение для ювелирной отрасли
Программное обеспечение для ювелирной отрасли РЕГИОНАЛЬНАЯ ГЕОГРАФИЯ
РЕГИОНАЛЬНАЯ ГЕОГРАФИЯ Техника безопасности на уроках гимнастики
Техника безопасности на уроках гимнастики Якутские охотничьи традиции и обряды
Якутские охотничьи традиции и обряды Родительское собрание в дистанционном режиме: итоги психолого-педагогической работы в группе
Родительское собрание в дистанционном режиме: итоги психолого-педагогической работы в группе Газбен улану
Газбен улану Scientific research work
Scientific research work Психология риска
Психология риска Феварин (флувоксамин) в амбулаторном лечении алкогольной зависимости, осложненной психическими расстройствами
Феварин (флувоксамин) в амбулаторном лечении алкогольной зависимости, осложненной психическими расстройствами Пространство и время в кино
Пространство и время в кино 20140130_konkurs._ugaday_stranu
20140130_konkurs._ugaday_stranu Коммерческая деятельность в розничной торговой (корпоративной) сети, пути ее развития
Коммерческая деятельность в розничной торговой (корпоративной) сети, пути ее развития Интуитивные игры. Развиваем интуицию с научным подходом
Интуитивные игры. Развиваем интуицию с научным подходом Английский фольклор
Английский фольклор