Содержание
- 2. Вступ Скануюча зондова мікроскопія і зондові мікроскопи (СЗМ) на сьогоднішній день є передовою областю мікроскопії, яка
- 3. Коротка історія становлення Основні складові СЗМ Класи СЗМ за типом взаємодії наносенсор – поверхня Скануюча атомно-силова
- 4. Коротка історія становлення Історично першими приладам, здатними у певній мірі відобразити форму поверхні досліджуваного зразка, були
- 5. Ідея скануючого тунельного мікроскопу запропонована Р. Янгом ще в 1966 році, а у 1971 році його
- 6. Початком другого етапу у розвитку скануючої зондової мікроскопії вважають роботи Бінніга з колегами. У 1982 році
- 7. У 1986 році група Бінніга опублікувала роботу, у якій були виміряні сили взаємодії між гострим зондом
- 8. Коротка історія становлення Ідеї та інженерно-конструкторські рішення, висунуті Гердом Біннігом і Xейні Рорером, суттєво спрощували апаратну
- 9. Коротка історія становлення Зараз існує безліч моделей СЗМ різного призначення: 9
- 10. Основні складові СЗМ Особливості конструкції СЗМ визначаються їх призначенням: для досліджень атомарної будови поверхонь - надвисоковакуумні
- 11. Однак незалежно від середовища функціонування основні складові СЗМ залишаються незмінними: 1 - наносенсор (зонд), 2 -
- 12. Силовий привід - сканер, виготовлений з п’єзокерамічного матеріалу (титанат цирконію або титанат цирконату свинцю) у вигляді
- 13. Класи СЗМ за типом взаємодії наносенсор – поверхня На основі базової системи сканування можна реалізувати різні
- 14. Скануюча силова мікроскопія силова спектроскопія силові криві (Force-distance curves) амплітудні криві (Amplitude-distance curves) фазові криві (
- 15. Скануюча силова мікроскопія силова спектроскопія силові криві (Force-distance curves) амплітудні криві (Amplitude-distance curves) фазові криві (
- 16. Скануюча силова мікроскопія В АСМ використовуються, як правило, зонди виготовлені із Si та Si3N4 Типова технологія
- 17. Скануюча силова мікроскопія Схема АСМ 17
- 18. 08/11/2023 Основні складові СЗМ 18
- 19. Скануюча силова мікроскопія Силова спектроскопія Силові криві (Force-distance curves) 19
- 20. Скануюча тунельна мікроскопія (СТМ) Скануюча силова мікроскопія силова спектроскопія силові криві (Force-distance curves) амплітудні криві (Amplitude-distance
- 21. Скануюча силова мікроскопія контактні методики режим постійної сили 21 Si3N4 ~3 мкм 70o
- 22. Топометрія поверхонь Ростові процеси Топологія приладів 22
- 23. Плівка PbGeTe/BaF2 X: 1 мкм Y: 1 мкм Z: 30 нм 23
- 24. Скануюча силова мікроскопія контактні методики (Contact Mode) мікроскопія сил тертя (lateral force mode) 24
- 25. Скануюча силова мікроскопія контактні методики (Contact Mode) 25 6H-SiC - лазерна обробка поверхні
- 26. Скануюча силова мікроскопія методики періодичного контакту (Tapping Mode) режим фазового контрасту Si ~10 мкм 26
- 27. 27 Скануюча силова мікроскопія методики періодичного контакту (Tapping Mode) С60 +Сu на Si Скануюча силова мікроскопія
- 28. Квантові структури на основі Si-Ge X 1000 нм Y 1000 нм Z 34 нм 28
- 29. 29
- 30. АСМ механічна літографія Нанолітографія та наноманіпуляції СТМ літографія АСМ механічна літографія АСМ електрохімічна літографія АСМ електрохімічна
- 31. АСМ механічна літографія С60 +Сu на Si 31
- 32. Поверхня Si після обробки в HF 32
- 33. Артефакти АСМ зображень і способи їх усунення Артефакти, пов'язані із накладанням форми зонду на реальний рельєф
- 34. X: 35 нм Y: 35 нм Z: 11 нм Мінімальна велична елементу поверхні, який може відобразити
- 35. виміряна поверхня реконструйована поверхня Поверхня пористого кремнію виміряна поверхня
- 36. Артефакти пов'язані із накладанням форми зонду на реальний рельєф поверхні Зламаний зонд Зонд із сторонньою наночастинкою
- 37. Артефакти сканера Сканер не може миттєво реагувати на зміну керуючого сигналу. При різкій зміні розміру поля
- 38. Артефакти системи зворотного зв'язку Надто висока швидкість сканування Нормальна швидкість 38
- 40. Скачать презентацию




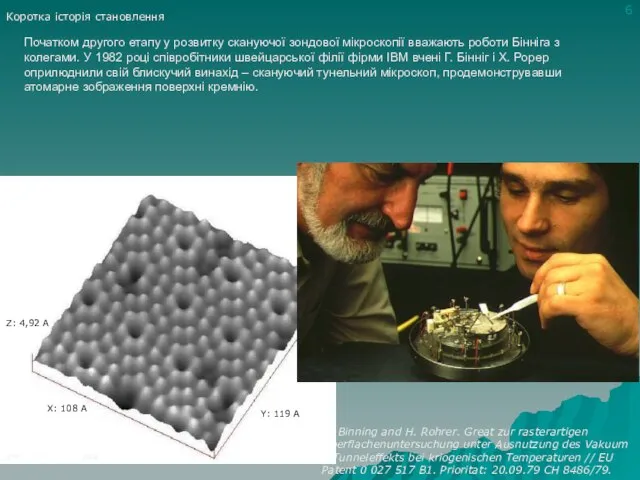




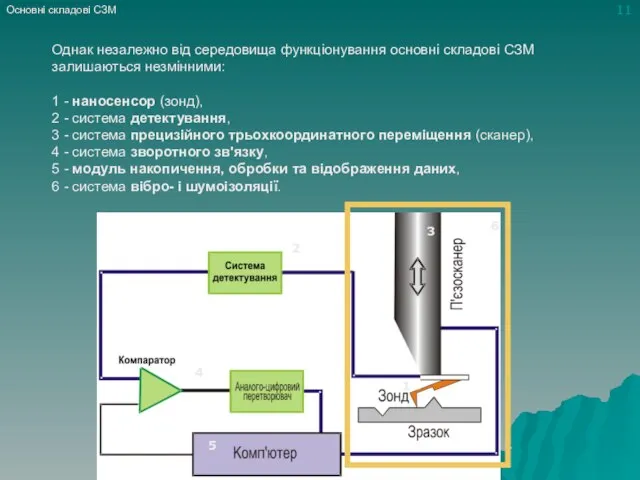



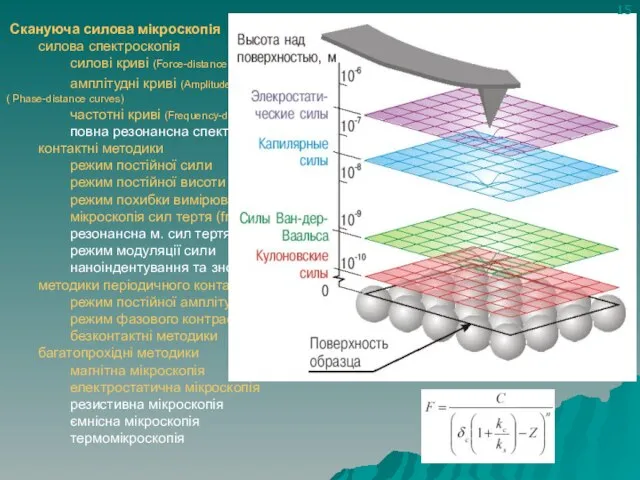

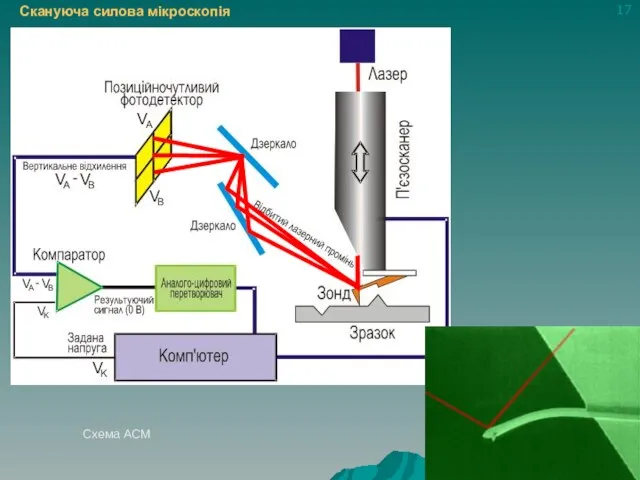
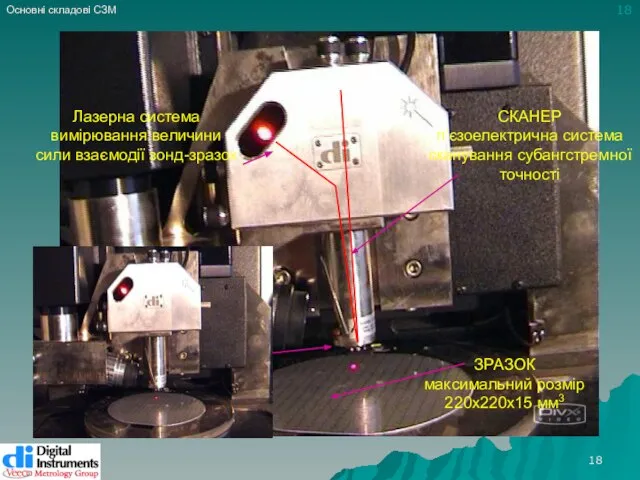
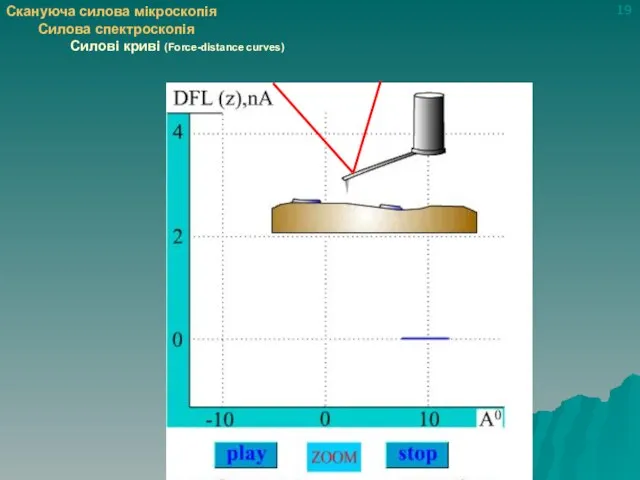

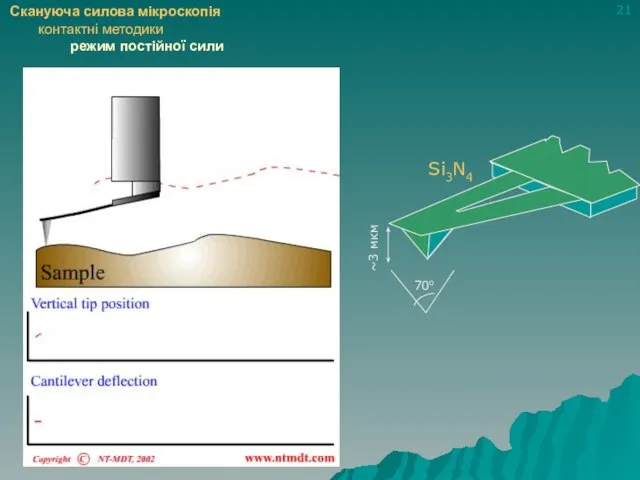


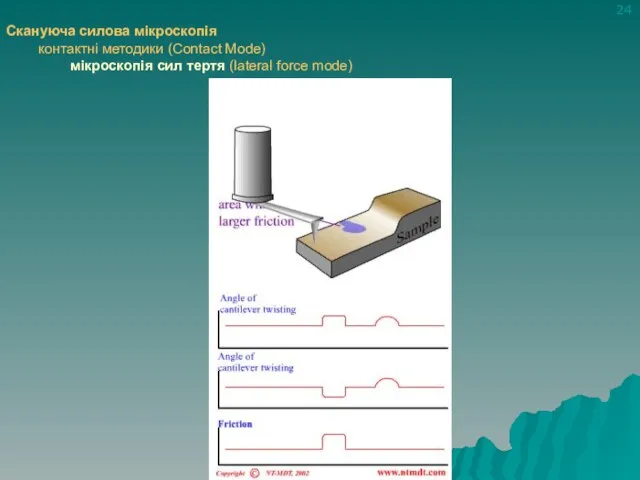
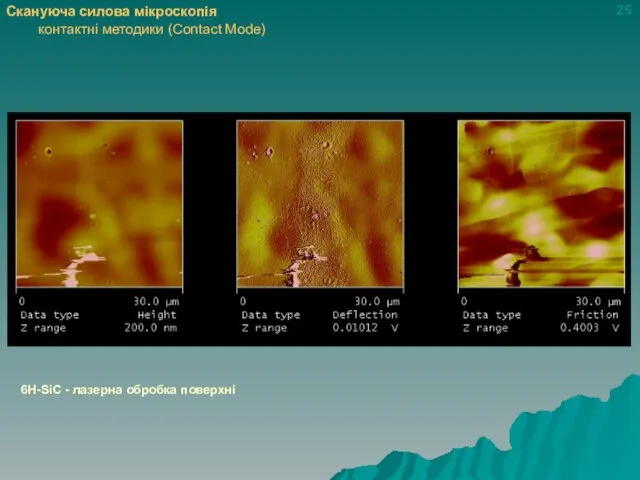
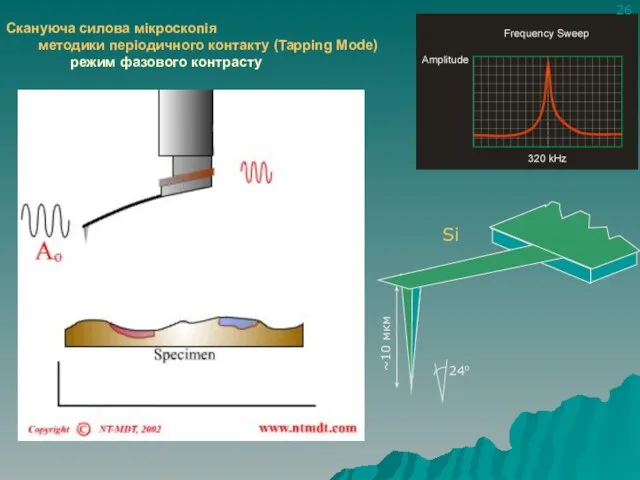
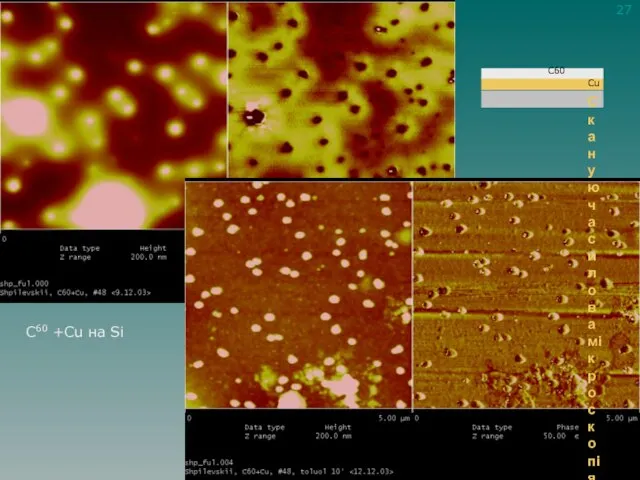
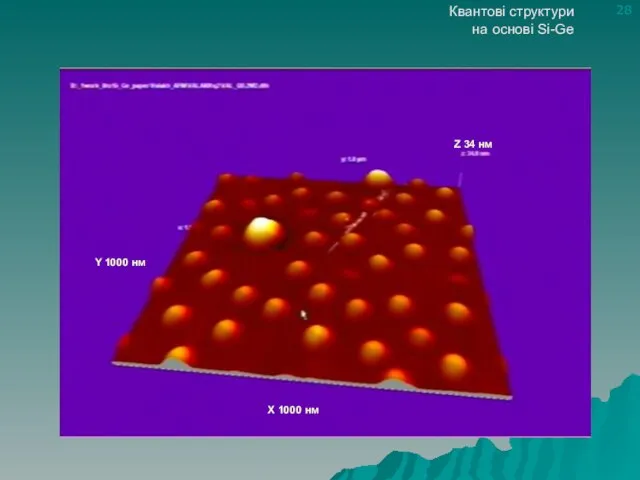

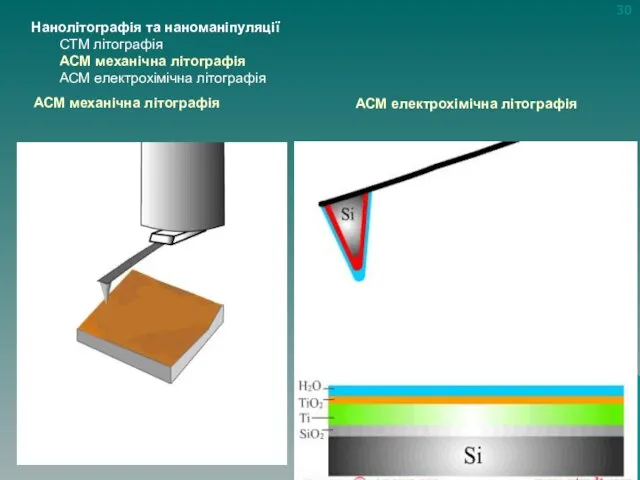




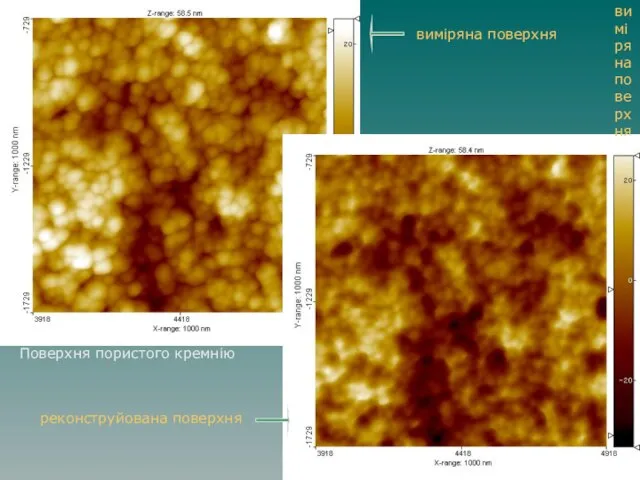

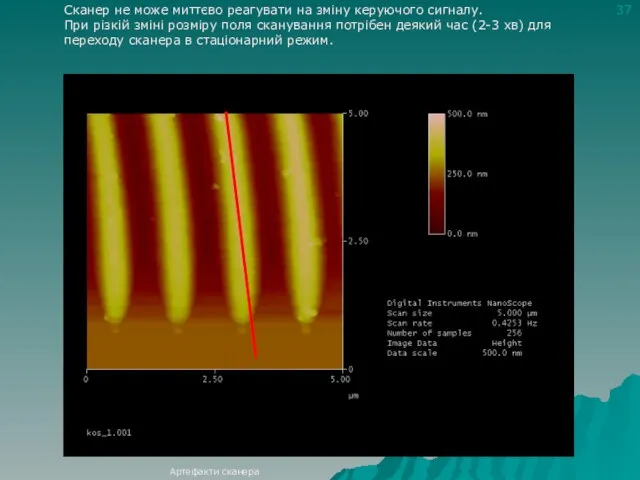

 Useless Inventions
Useless Inventions  Моделирование объектов и систем
Моделирование объектов и систем Личное благовестие
Личное благовестие Презентация на тему: Работа классного руководителя с родителями
Презентация на тему: Работа классного руководителя с родителями 2_5325994725348481395
2_5325994725348481395 Организация туриндустрии. Комплекс услуг предприятий питания и его роль в туризме
Организация туриндустрии. Комплекс услуг предприятий питания и его роль в туризме Организация внеурочной деятельности при реализации федерального государственного образовательного стандарта начального общего
Организация внеурочной деятельности при реализации федерального государственного образовательного стандарта начального общего Презентация на тему Формы взаимодействия педагогов с семьей ребенка дошкольного возраста с особыми образовательными потребностя
Презентация на тему Формы взаимодействия педагогов с семьей ребенка дошкольного возраста с особыми образовательными потребностя К вопросу о цикличности развития диатомовых водорослей Байкала
К вопросу о цикличности развития диатомовых водорослей Байкала О мерах, направленных на снижение темпов роста потребительских цен
О мерах, направленных на снижение темпов роста потребительских цен «Своя игра»
«Своя игра» ГУО Туринский учебно-педагогический комплекс детский сад – базовая школа
ГУО Туринский учебно-педагогический комплекс детский сад – базовая школа Презентация на тему Удельный период русской истории (6 класс)
Презентация на тему Удельный период русской истории (6 класс) Красная книга Курганской области
Красная книга Курганской области Презентация на тему have to - must
Презентация на тему have to - must Что такое ДМС страхование? Полис(пластиковый, эл. вариант, бумажный)
Что такое ДМС страхование? Полис(пластиковый, эл. вариант, бумажный) Производство бумаги
Производство бумаги СДД как инструмент хеджирования ценовых рисков в РСВ
СДД как инструмент хеджирования ценовых рисков в РСВ Конкурс курсовых проектов (КМИП)
Конкурс курсовых проектов (КМИП) Менеджмент. Организация, мотивации, контроль, понятие регулирования и его место в системе управления (Часть 3)
Менеджмент. Организация, мотивации, контроль, понятие регулирования и его место в системе управления (Часть 3) Лаборатория 812 – это содружество людей, абсолютно разных, но уже состоявшихся в своих профессиональных сферах. Художники, психолог
Лаборатория 812 – это содружество людей, абсолютно разных, но уже состоявшихся в своих профессиональных сферах. Художники, психолог Должность и прием персонала
Должность и прием персонала Возникновение головных уборов
Возникновение головных уборов Почва – важнейшая часть экосистемы 3 класс
Почва – важнейшая часть экосистемы 3 класс Свойства и функции белков
Свойства и функции белков  Самопрезентация учителя начальных классов
Самопрезентация учителя начальных классов Демонстрационный эксперимент по геометрической оптике
Демонстрационный эксперимент по геометрической оптике Презентация на тему Предложения с вводными конструкциями (8 класс)
Презентация на тему Предложения с вводными конструкциями (8 класс)