Содержание
- 2. Преимущества КМОП ИС над биполярными ИС Малые размеры и площадь Упрощенная изоляция Низкая потребляемая и рассеиваемая
- 3. КМОП структура
- 4. КМОП процесс
- 10. Базовые операции технологического маршрута создания n-МОП – транзистора А - А а) Нанесение фоторезиста б) Совмещение
- 11. г) Проявление д) Формирование рельефа в маскирующем слое (травление)
- 12. 3. Подзатворное окисление (отжиг в окисляющей среде) 4. Осаждение поликремния
- 13. 5. Фотолитография 2, шаблон поликремния А - А
- 14. 6. Легирование и термический отжиг N+-слоя Р (Аs) N+ N+ 7. Осаждение маскирующего окисла
- 15. 8. Фотолитография 3, шаблон контактных окон 9. Вскрытие контактных окон А - А АI – АI
- 16. 10. Осаждение металла 11. Фотолитография 4, шаблон металлизации
- 17. 12. Формирование разводки в слое Металл 1 (травление) А - А АI – АI В -
- 18. Основные технологические операции Фотолитография Осаждение Ионное легирование Отжиг Травление Любая интегральная структура формируется с помощью одних
- 19. Литография Литография (от греческого lithos – камень, grapho – пишу, рисую) –технологический процесс, предназначенный для формирования
- 20. Фотошаблон – стеклянная пластина со сформированным на ее поверхности рисунком элементов схем из материала, не пропускающего
- 21. Экспонирование – процесс облучения светочувствительного материала (фоторезиста) электромагнитным излучением. Воздействие либо разрушает фоторезист, или, наоборот, вызывает
- 22. Суть метода фотолитографии На стеклянную пластину наносят топологический рисунок, непрозрачный для излучения (это фотошаблон). При экспонировании
- 23. Установка фотолитографии
- 24. Фотоповторитель Стол фотоповторителя перемещается на нужный шаг, обеспечивая многократный перенос изображения на фотошаблон.
- 25. Проецирование в масштабе 4 : 1 Метки, по которым совмещают фотошаблон с пластиной
- 26. Основные достоинства фотолитографии Гибкость, т. е. простой переход от одной конфигурации к другой путем смены фотошаблонов.
- 27. Фоторезисты — материалы, чувствительные к излучению. Фоторезисты делятся на 2 класса: Негативные – неэкспонированные участки вымываются,
- 28. Основные свойства фоторезистов Экспозиция – количество света, попадающего на светочувствительный фотоматериал за определенный промежуток времени. Светочувствительность
- 29. Экспозиция и светочувствительность Свет проникает на всю глубину фоторезиста и отражается в обратную сторону. Оба потока
- 30. Разрешающая способность Разрешающая способность зависит от многих технологических факторов, а также от свойств фоторезиста и источника
- 31. Фокусировка
- 32. Искажение рисунка при фотолитографии Изгиб подложки может приводить к значительным искажениям рисунка Дифракция светового потока (на
- 33. Литература: 1. Королев М.А., Ревелева М.А. Технология и конструкции интегральных микросхем. ч.1. 2000 М; МИЭТ. 2.
- 35. Скачать презентацию

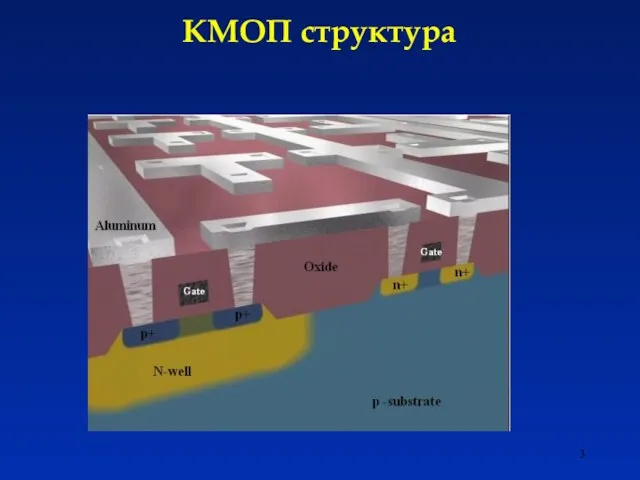

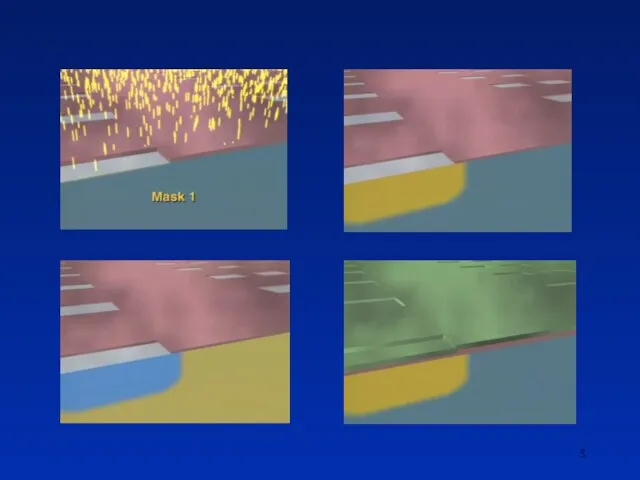
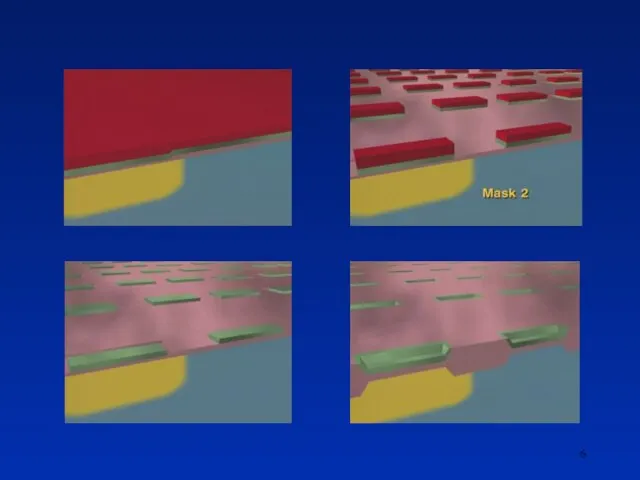

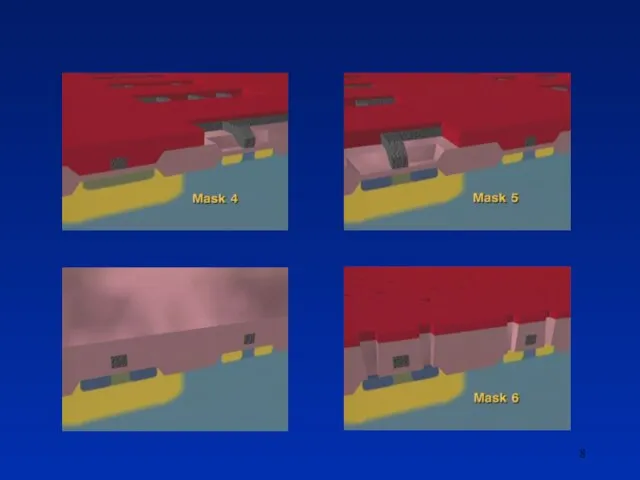
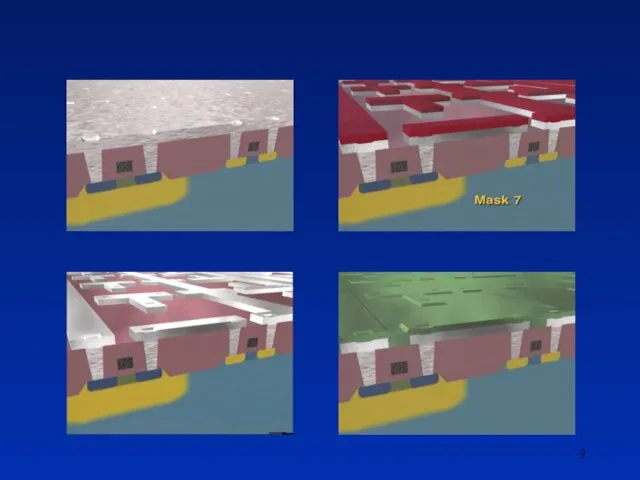


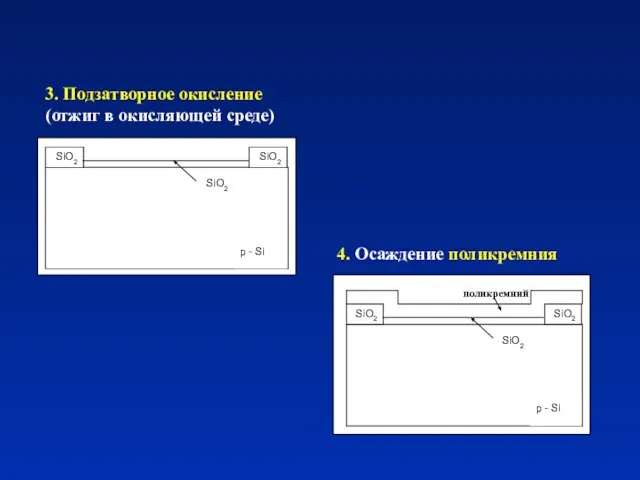
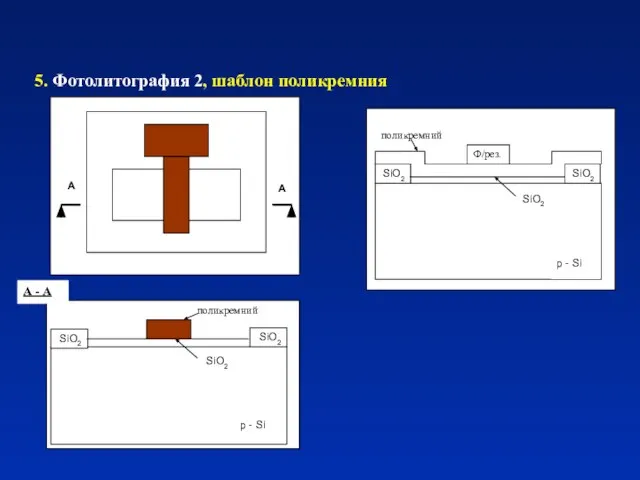
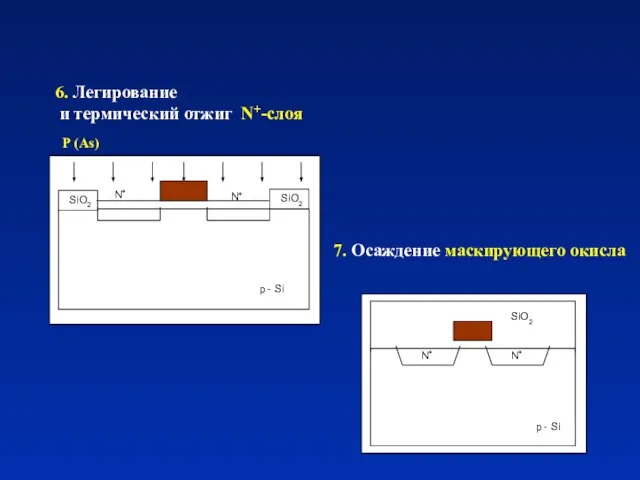
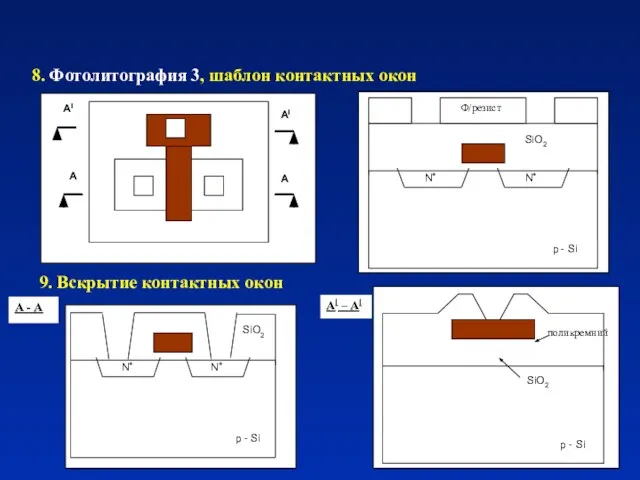
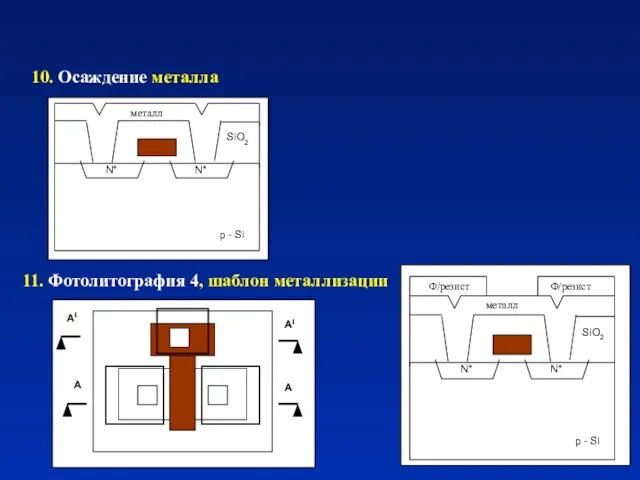







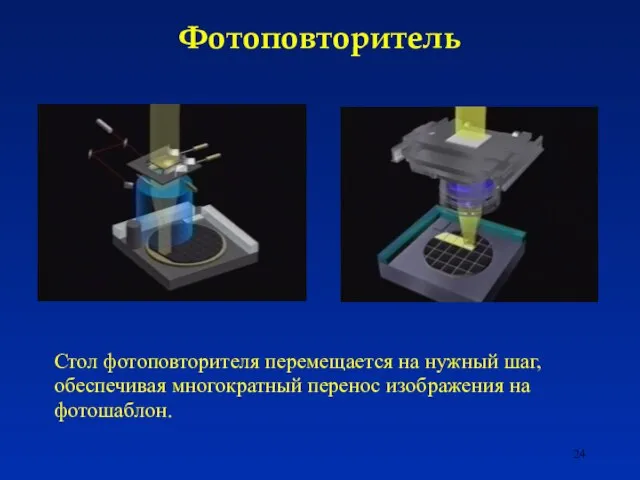
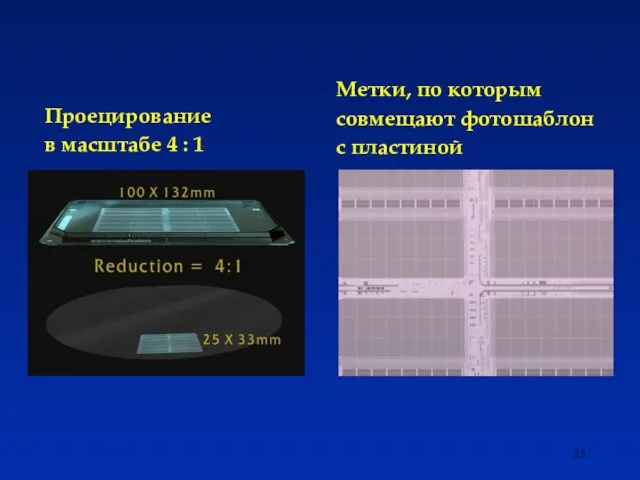








 Подарки дарить приятнее, чем получать
Подарки дарить приятнее, чем получать Формирование информационного мировоззрения учащихся на основе интегративного подхода к обучению и воспитанию в средней школе
Формирование информационного мировоззрения учащихся на основе интегративного подхода к обучению и воспитанию в средней школе Презентация на тему "Зачем животным хвосты" - скачать презентации по Педагогике
Презентация на тему "Зачем животным хвосты" - скачать презентации по Педагогике «Дворцовые ансамбли»в стиле барокко
«Дворцовые ансамбли»в стиле барокко Рекламные возможности RuTube
Рекламные возможности RuTube Энергетическое обследование. Цели, задачи и порядок проведения энергоаудита. Виды энергоаудита. Оформление результатов
Энергетическое обследование. Цели, задачи и порядок проведения энергоаудита. Виды энергоаудита. Оформление результатов Машинное и глубокое обучение для Интернета вещей и тактильного интернета. СПб ГУТ. Магистратура
Машинное и глубокое обучение для Интернета вещей и тактильного интернета. СПб ГУТ. Магистратура Необитаемый остров
Необитаемый остров Типология конфликтов
Типология конфликтов XII традиционный легкоатлетический пробег памяти В.И. Мусихина
XII традиционный легкоатлетический пробег памяти В.И. Мусихина MS EAS experience2006-2011
MS EAS experience2006-2011 Зачётная
Зачётная Очарование женственности
Очарование женственности Картины Джузеппе Арчимбольдо
Картины Джузеппе Арчимбольдо Осаждение и травление
Осаждение и травление  властивість скорочення.ppt (1)
властивість скорочення.ppt (1) Расчет для Даты рождения 27 ноября 1975 года
Расчет для Даты рождения 27 ноября 1975 года Организация производства кирпича стандартного размера, кирпичный завод в Черемшанском районе, Республики Татарстан
Организация производства кирпича стандартного размера, кирпичный завод в Черемшанском районе, Республики Татарстан Макроэволюция. Выявление ароморфозов у растений и идиоадаптаций у животных
Макроэволюция. Выявление ароморфозов у растений и идиоадаптаций у животных Межкультурные тренинги
Межкультурные тренинги Понятие материалоемкости
Понятие материалоемкости Кариология, полиплоидия и отдаленная гибридизация винограда (систематика и цитогенетика винограда) Штефан Г. Топалэ Кишинэу : б. и.,
Кариология, полиплоидия и отдаленная гибридизация винограда (систематика и цитогенетика винограда) Штефан Г. Топалэ Кишинэу : б. и., А.С. Пушкин биография
А.С. Пушкин биография Рисование конуса. Штриховка
Рисование конуса. Штриховка Сутність маркетинговой деятельности
Сутність маркетинговой деятельности  Защита КМО. Интернет-магазин КМО
Защита КМО. Интернет-магазин КМО Электрический ток в электролитах 10 класс
Электрический ток в электролитах 10 класс СДЕК. Экспресс доставка
СДЕК. Экспресс доставка