Содержание
- 2. КМОП-структура
- 3. Основные технологические операции создания МОП – транзистора 1. Формирование маскирующего слоя окисла SiO2 (осаждение) 2. Формирование
- 4. 5. Формирование поликремниевого затвора (фотолитография, травление) N+ N+ 6. Легирование и термический отжиг N+-слоя 7. Осаждение
- 5. 10. Осаждение металла 11. Формирование разводки в слое Металл 1 (фотолитография, травление)
- 6. В технологическом процессе создания МОП-транзисторов осаждение исполь-зуется для формирования следующих слоев: Оксида кремния (окисла, SiO2) Нитрида
- 7. Основными методами осаждения являются: Осаждение из парогазовых смесей (CVD- chemical vapor deposition). Плазмохимическое осаждение (PD -
- 8. CVD - метод В CVD-процессе подложки, как правило, помещаются в пары одного или нескольких веществ, которые,
- 9. Достоинства CVD - метода Простота метода. Хорошая технологическая совместимость с другими процессами создания полупроводниковых микросхем. Сравнительно
- 10. PD - метод Ионно-плазменные процессы используют плазму, генериру-емую в электрическом и магнитном полях. Плазма – ионизированный
- 11. Суть PD - метода Процесс производится в вакуумной камере, запол-ненной инертным газом, в котором возбуждается газовый
- 12. Осаждение оксида кремния Основные параметры процесса: время и температура Методы осаждения: CVD и PD SiH4 +
- 13. Осаждение нитрида кремния Нитрид кремния широко используется в качестве маски, например для создания диэлектрической изоляции между
- 14. Осаждение поликристаллического кремния (поликремния) Поликремний сильно легируют для увеличения его проводимости. Метод осаждения – CVD при
- 15. Осаждение металлов Метод осаждения – CVD при пониженном давлении. CVD-процесс широко используют для нанесения металлов. В
- 16. Травление Травление (etch, unpatented etch) – удаление поверхностного слоя. Используется для получения максимально ровной поверхности пластин
- 17. Основные виды травления Химико-механическая полировка (планаризация) (Chemical Mechanical Polishing (Planarization)). Жидкостное травление (wet etch). Сухое травление
- 18. Жидкостное травление В основе лежит химическая реакция жидкого травителя (кислоты) и твердого тела, в результате которой
- 19. Селективность жидкостного травления Жидкостное травление обладает высокой селективностью (избирательностью), оцениваемой отношением скоростей травления требуемого слоя (например,
- 20. Изотропность жидкостного травления При жидкостном травлении скорость процесса в вертикальном и горизонтальном направлении близки. В результате
- 21. Сухое травление Производят в вакуумной установке в плазме газового разряда. Наиболее распространенная разновидность – плазмо-химическое травление
- 22. Процесс ПХТ Под действием электрического поля электроны в вакууме приобретают значительную энергию и передают ее путем
- 23. Процесс ПХТ При ПХТ можно выделить следующие стадии: - доставка молекул активного газа в зону разряда;
- 24. Химическая реакция радикалов с поверхностными атомами Si + 4 F* SiF4 – при травлении кремния SiO2
- 25. Параметры процесса ПХТ Наиболее важными параметрами процесса ПХТ являются: давление в камере; концентрация реакционных газов; подводимая
- 26. Анизотропия процесса сухого травления Сухое травление идет преимущественно в вертикальном направлении, в котором движутся частицы. Поэтому
- 27. Химико-механическая планаризация ХМП - комбинация химических и механических способов планаризации (удаления неровностей с поверхности изготавливаемой пластины).
- 28. Литература: 1. Королев М.А., Ревелева М.А. Технология и конструкции интегральных микросхем. ч.1. 2000 М; МИЭТ. 2.
- 30. Скачать презентацию
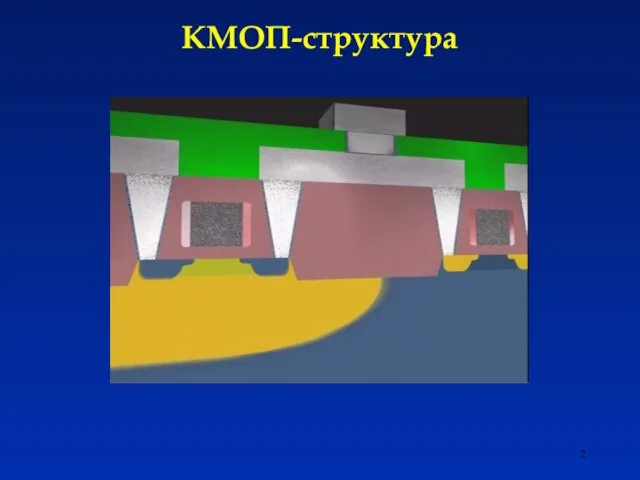

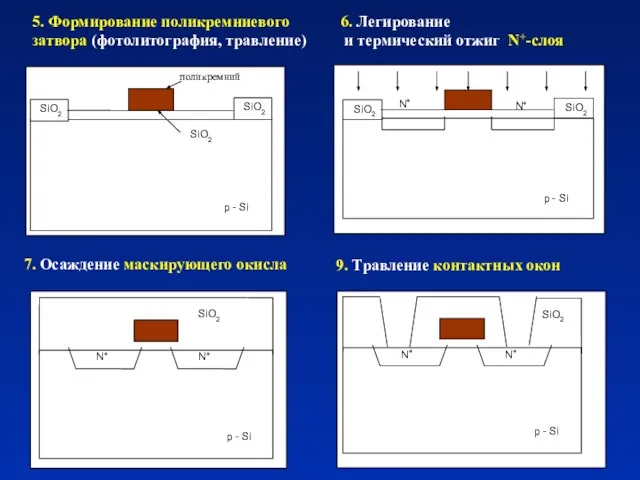
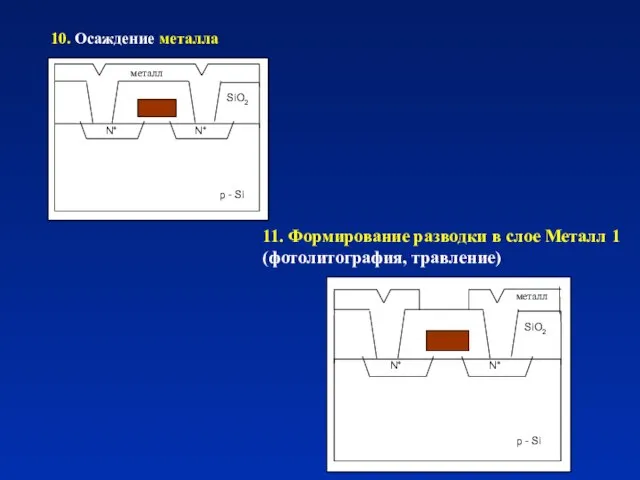






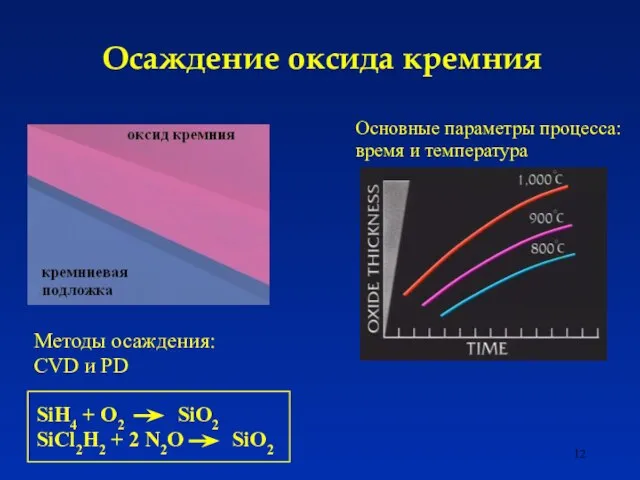

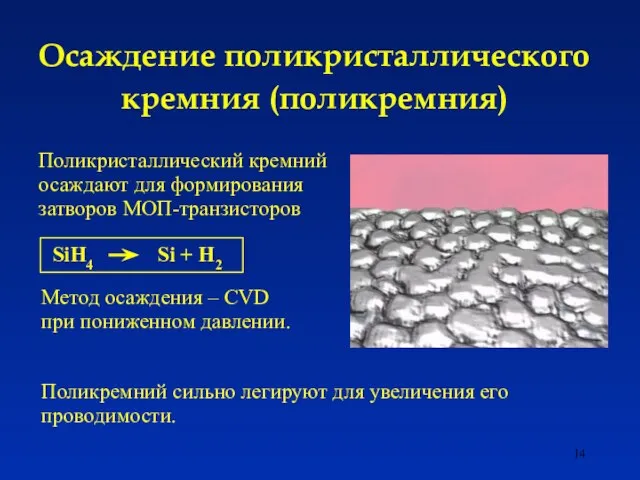




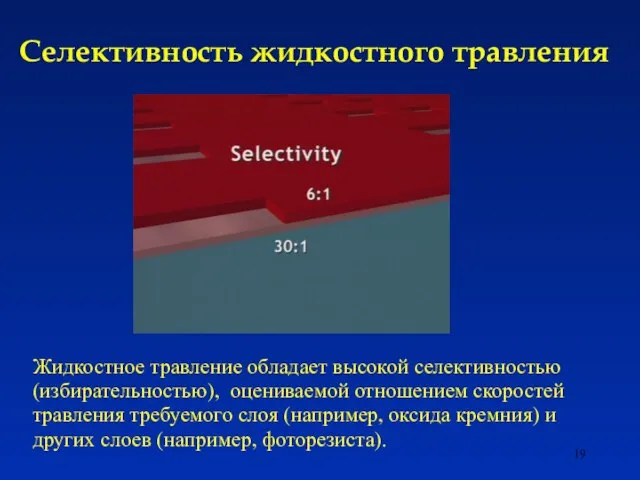









 Понятие правонарушения
Понятие правонарушения . Ответственность сторон в договоре подряда Выполнила Лихачева А.А. Группа МЭ081
. Ответственность сторон в договоре подряда Выполнила Лихачева А.А. Группа МЭ081 Презентация на тему Какая бывает промышленность (3 класс)
Презентация на тему Какая бывает промышленность (3 класс) Биография Ивана Бунина
Биография Ивана Бунина «Проект» - перспективный метод обучения, основанный на самостоятельной, целевой и результативной работе.
«Проект» - перспективный метод обучения, основанный на самостоятельной, целевой и результативной работе. Собрание организаторов теневой экономики
Собрание организаторов теневой экономики Россия на мировом рынке технологий
Россия на мировом рынке технологий ВКР: Методы и формы проведения презентаций организаций
ВКР: Методы и формы проведения презентаций организаций Воинские звания
Воинские звания Практический семинарТЕМА:
Практический семинарТЕМА: Плодоовочева логістика в Україні: проблеми і перспективи розвитку 1. - презентация
Плодоовочева логістика в Україні: проблеми і перспективи розвитку 1. - презентация Центральная тюрьма поселок Киндасово
Центральная тюрьма поселок Киндасово Интернациональ сүзләр
Интернациональ сүзләр Результаты введения НСОТ в регионах – участниках КПМО Государственный Университет – Высшая школа экономики (ГУ-ВШЭ) Абанкина Ири
Результаты введения НСОТ в регионах – участниках КПМО Государственный Университет – Высшая школа экономики (ГУ-ВШЭ) Абанкина Ири Правила проведения ЕГЭ
Правила проведения ЕГЭ Своя игра
Своя игра Детство без жестокости.
Детство без жестокости. Мои и твои права
Мои и твои права СИСТЕМА ПОДГОТОВКИ К ЕГЭ В ВЫПУСКНОМ КЛАССЕ
СИСТЕМА ПОДГОТОВКИ К ЕГЭ В ВЫПУСКНОМ КЛАССЕ Эксплуатационные качества подвижного состава
Эксплуатационные качества подвижного состава ЛУНА
ЛУНА Классный час "Оставь свой след на земле"
Классный час "Оставь свой след на земле" Conditionals
Conditionals Реинжиниринг. Трубопроводная техника и несущие конструкции
Реинжиниринг. Трубопроводная техника и несущие конструкции Инвестиционный климат регионов: тенденции и перспективы (по результатам XVI Рейтинга инвестиционной привлекательности регионов)
Инвестиционный климат регионов: тенденции и перспективы (по результатам XVI Рейтинга инвестиционной привлекательности регионов) Perfektil Plus
Perfektil Plus Финансы и кредит
Финансы и кредит Строение и функции белков
Строение и функции белков