Содержание
- 2. Ширина запрещенной зоны: Количество энергетических уровней в валентной зоне и зоне проводимости одного порядка. Степень заполнения
- 3. 2. Ток в полупроводниковых приборах определяется количеством электронов и дырок находящихся в разрешенных зонах в свободном
- 4. Плотность энергетических состояний в зоне проводимости: 2 Эффективная масса - величина, имеющая размерность массы и применяемая
- 5. Вероятность заполнения уровня с энергией E определяется соотношением Ферми-Дирака 3 Для невырожденных полупроводников уровень Ферми всегда
- 6. Концентрации свободных электронов в зоне проводимости полупроводника: 5 6 Аналогично для электронов можно записать выражения для
- 7. 8 ΔЕ - ширина запрещённой зоны, [эВ]. η - температурный коэффициент ширины запрещенной зоны. Для германия
- 8. μn, μp - подвижность носителей,[см2/В·с] Подвижность - это скорость дрейфа носителей при воздействии единичного электрического поля
- 9. Параметры для расчета подвижности носителей
- 10. τ - время жизни носителей, [с]. Если под воздействием освещения в зоне проводимости полупроводника появятся избыточные
- 11. Dn , Dp - коэффициенты диффузии электронов и дырок, [см2/с] Если в полупроводниковом материале существует градиент
- 12. Ln , Lp - длина диффузионного смещения, [см]. Если в полупроводнике существует градиент концентрации, то носители
- 13. Перечисленные выше параметры связаны между собой следующими соотношениями - соотношение Эйнштейна; (13) (14)
- 14. ni - собственная концентрация носителей, [см-3]. В собственном полупроводнике, свободные электроны и дырки могут появиться только
- 15. Enp - электрическая прочность, [В/см]. Если образец полупроводника разместить между металлическими обкладками и подать на него
- 16. ε - диэлектрическая проницаемость материала. Величина безразмерная. Характеризует материальную среду, в которой происходит перемещение носителей зарядов.
- 17. В твердотельных приборах направленное движение заряженных частиц осуществляется за счет действия сил электрического поля и градиента
- 18. Диффузионный ток - ток, обусловленный направленным движением электронов и дырок за счет градиента концентрации. Если в
- 19. В большинстве полупроводниковых приборов на основе p - n переходов ток по своей природе является диффузионным
- 20. Уравнение Пуассона. Если известна плотность заряда p(x), то значение напряженности электрического поля E и потенциала φ
- 22. Собственный полупроводник
- 24. Поскольку в собственном полупроводнике концентрации электронов и дырок равны, то электропроводность такого полу- проводника равна.
- 25. Зонная диаграмма полупроводника n - типа. Зонная диаграмма полупроводника p - типа.
- 27. Зависимость электропроводности полупроводников от температуры На участке I, называемом участком примесной проводимости, σ растет при увеличении
- 28. Пренебрегая температурной зависимостью подвижности носителей, можно говорить о том, что рост электропроводности обусловлен увеличением концентрации носителей
- 29. Равновесные и неравновесные носители зарядов в полупроводниках. Основные и неосновные носители. В собственном полупроводнике концентрации электронов
- 30. закон действующих масс
- 31. Полупроводники в электрическом поле Угол наклона зон зависит от напряженности поля, а направление наклона - от
- 32. Ударная ионизация. Свободный электрон или дырка под действием сил электрического поля набирают энергию W Туннелирование. В
- 33. Насыщение скорости. В слабых электрических полях дрейфовая скорость носителей меньше, чем тепловые скорости. В сильных полях
- 34. Явления на поверхности полупроводников Энергетические диаграммы полупроводника, поясняющие явления обеднения (а), обогащения (б) и инверсии (в).
- 35. Вблизи поверхности полупроводника находится пластина, на которую подан отрицательный потенциал или на поверхности полупроводника произошла адсорбция
- 36. Если на поверхности полупроводника или вблизи нее образуется положительный заряд, то электроны притягиваются к поверхности и,
- 37. Явления инверсии При наличии у поверхности большего, чем в случае обеднения, отрицательного заряда, изгиб зон будет
- 39. Скачать презентацию
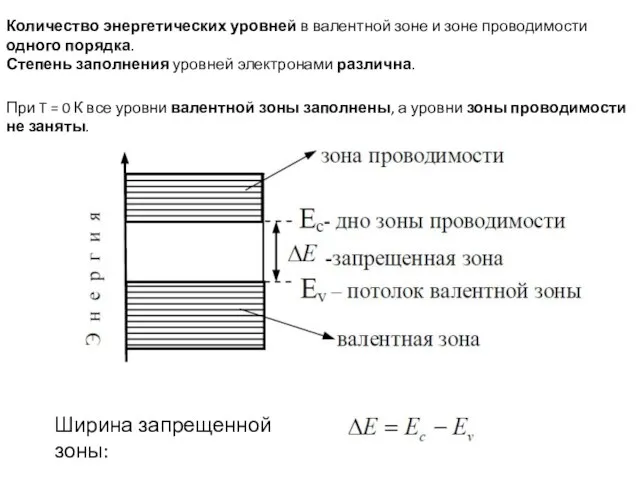




![8 ΔЕ - ширина запрещённой зоны, [эВ]. η - температурный коэффициент ширины](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/856361/slide-6.jpg)
![μn, μp - подвижность носителей,[см2/В·с] Подвижность - это скорость дрейфа носителей при](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/856361/slide-7.jpg)

![τ - время жизни носителей, [с]. Если под воздействием освещения в зоне](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/856361/slide-9.jpg)
![Dn , Dp - коэффициенты диффузии электронов и дырок, [см2/с] Если в](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/856361/slide-10.jpg)
![Ln , Lp - длина диффузионного смещения, [см]. Если в полупроводнике существует](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/856361/slide-11.jpg)

![ni - собственная концентрация носителей, [см-3]. В собственном полупроводнике, свободные электроны и](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/856361/slide-13.jpg)
![Enp - электрическая прочность, [В/см]. Если образец полупроводника разместить между металлическими обкладками](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/856361/slide-14.jpg)






















 Опыт Резерфорда. Строение атома. Спектр. Постулаты Бора
Опыт Резерфорда. Строение атома. Спектр. Постулаты Бора Закон полного тока для магнитного поля в веществе
Закон полного тока для магнитного поля в веществе Внутренняя энергия
Внутренняя энергия Презентация на тему Поверхностное натяжение жидкостей
Презентация на тему Поверхностное натяжение жидкостей  Физика ядра
Физика ядра Основы термодинамики. Тема № 4
Основы термодинамики. Тема № 4 Лекция 1 Ядерно-топливный цикл
Лекция 1 Ядерно-топливный цикл Чи довго пратимете
Чи довго пратимете Презентация на тему Скорости молекул. Опыт Штерна
Презентация на тему Скорости молекул. Опыт Штерна  Электризация тел
Электризация тел Измерение размеров малых тел
Измерение размеров малых тел Атмосферное давление. Решение экспериментальных задач
Атмосферное давление. Решение экспериментальных задач Опыты И. Ньютона и корпускулярная теория цвета
Опыты И. Ньютона и корпускулярная теория цвета Презентация на тему Магнитное поле
Презентация на тему Магнитное поле  Решение задач. Подготовка к контрольной работе
Решение задач. Подготовка к контрольной работе Теплотехника как наука
Теплотехника как наука Кинематика точки
Кинематика точки Напряженность электрического поля
Напряженность электрического поля Закона Кулона
Закона Кулона Концепции пространства и времени. Тема 5
Концепции пространства и времени. Тема 5 Презентация на тему Трансформаторы
Презентация на тему Трансформаторы  Движение и взаимодействие тел. Повторительно-обобщающий урок-игра
Движение и взаимодействие тел. Повторительно-обобщающий урок-игра Практикум по решению задач. Механическое движение
Практикум по решению задач. Механическое движение Период полураспада. Закон радиоактивного распада
Период полураспада. Закон радиоактивного распада Использование инфракрасного и оптического диапазонов радиоволн для передачи информации
Использование инфракрасного и оптического диапазонов радиоволн для передачи информации Бобрышев Анатолий Васильевич учитель физики Школа №30, г. Старый Оскол
Бобрышев Анатолий Васильевич учитель физики Школа №30, г. Старый Оскол Презентация на тему Третий закон Ньютона
Презентация на тему Третий закон Ньютона  Умная колонка на уроках физики
Умная колонка на уроках физики