Содержание
- 2. ЭЛЕКТРОПРОВОДНОСТЬ Классификация твердых тел по величине электропроводности По величине удельной электропроводности все твердые тела можно разделить
- 3. Электронные свойства твёрдых тел Средняя кинетическая энергия одноатомной молекулы идеального газа согласно молекулярно-кинетической теории: mu̅2 /
- 4. ЗОННАЯ ТЕОРИИ ТВЕРДЫХ ТЕЛ Обобществление электронов в кристалле В твердом теле расстояния между атомами настолько малы,
- 5. ЗОННАЯ ТЕОРИИ ТВЕРДЫХ ТЕЛ заполнение зон, ЭЛЕКТРОПРОВОДНОСТЬ
- 6. Электронная проводимость. ЗОННАЯ ТЕОРИИ ТВЕРДЫХ ТЕЛ ЭЛЕКТРОПРОВОДНОСТЬ При наличии в структуре дефектов в запрещенной зоне возникают
- 7. Мемристоры. Новый тип энергонезависимой памяти и другие применения.
- 8. Актуальность Создание резистивной энергонезависимой памяти (RRAM) – интенсивно развивающееся направление в наноэлектронике. - RRAM имеет простую
- 9. Мемристор Мемристивные системы – новая парадигма в электронике Эффект резистивного переключения, известный с 1960-х, в настоящее
- 10. Актуальность
- 11. Резистивная память RRAM RRAM – мемристор – устройство, способное изменять сопротивление в зависимости от величины проходящего
- 12. Электроформовка Электроформовка – радикальное изменения электрических свойств диэлектрика при приложении некоторого минимального напряжения Vф, где Vф
- 13. Today’s understanding of the resistive switching mechanisms are based mainly on the concept of conductive filaments
- 14. В зависимости от конкретной системы МДМ, существуют два типа переключения из состояния с малым сопротивлением (ON)
- 15. Три механизма резистивного переключения, обусловленные атомной перестройкой заряженных дефектов или примесей в материале а) непрерывная проводящая
- 16. Иллюстрация критических размеров памяти Nanotechnology 22 (2011) 254027 (21pp) doi:10.1088/0957-4484/22/25/254027 Scaling limits of resistive memories Victor
- 17. Оценка величины сопротивления одного атома между электродами В квантовом приближении Nanotechnology 22 (2011) 254027 (21pp) doi:10.1088/0957-4484/22/25/254027
- 18. Качественная модель электрополевого биполярного переключения в макроскопических структурах на основе YSZ
- 19. Выбор материалов структуры для элементов RRAM Fig. 1. Typical I-V characteristics of Pt/Cu:MoOx/Cu devices. JOURNAL OF
- 20. Локальная электрополевая модификация проводимости наноразмерного слоя диоксида циркония Токовые изображения поверхности структуры ZrO2(Y)/Si, полученные последовательным сканированием
- 21. a - морфология поверхности; б–токовое изображение. Темный участок на токовом изображении с пониженной проводимостью, получен путем
- 22. Резистивное переключение в структурах TiN – YSZ – (Zr-Au) ВАХ структуры TiN – YSZ – (Zr-Au)
- 23. Локальная электрополевая модификация проводимости наноразмерного слоя диоксида циркония Токовое изображение модифицированного участка поверхности
- 24. Резистивные элементы памяти и кросс-бар структуры
- 25. Другие применения Электронный синапс Изменяя величину электрического поля и длительность его приложения, можно получить любое значение
- 26. Применение мемристоров J. Nickel. IEDM Advanced Memory Technology Workshop (2011) К прорывным научно-техническим результатам ближайших лет
- 27. Год 2019 г. Благодарю за внимание
- 28. Modification of the surface morphology of the yttria stabilized zirconia films during resisitive switching by Conductive
- 29. ВАХ туннельного контакта АСМ зонд – ZrO2 /Si (n-тип) измеренная в направлении от - 8В до
- 30. Температурная зависимость низкоомного и высокоомного состояний Образец Au+Zr(3нм)/ СДЦ(12 нм)/TiN. Измерено при напряжении 1В.
- 31. Сравнительные характеристики устройств памяти
- 32. Мемристор Мемристивные системы – новая парадигма в электронике Эффект резистивного переключения, известный с 1960-х, в настоящее
- 33. Публикационная активность Всплеск работ по RRAM и нейроморфным системам на основе мемристоров начался примерно в одно
- 34. Синаптическое поведение мемристора S.-J. Choi et al. Appl. Phys. A 102, 1019 (2011) Свойство I: Непрерывный
- 35. Синаптическое поведение мемристора Свойство II: Эволюция резистивного состояния в соответствии с историей входного сигнала, соответствующая последовательной
- 36. Синаптическое поведение мемристора Свойство I: Непрерывный набор резистивных состояний Проявляется в изменении сопротивления электронного устройства в
- 37. Синаптическое поведение мемристора Свойство II: Эволюция резистивного состояния в соответствии с историей входного сигнала, соответствующая последовательной
- 38. Наши мемристоры O.N. Gorshkov et al. Tech. Phys. Lett. 40, 12 (2014) Разработанные тонкопленочные структуры демонстрируют
- 39. Наши мемристоры Зависимость сопротивления от амплитуды спайка Зависимость сопротивления от длительности спайка Степень разрыва и восстановления
- 40. Наши мемристоры Зависимость сопротивления от амплитуды спайка Зависимость сопротивления от длительности спайка Степень разрыва и восстановления
- 41. Объемы рынка запоминающих устройств В мире сейчас продается 120-130 миллионов фотоаппаратов ежегодно и порядка 300 миллионов
- 42. Перспективы резистивной памяти (RRAM) RRAM может заменить всю иерархию компьютерной памяти (сверхбыстрая микропроцессорная кэш-память — оперативная
- 43. Патентные исследования FRAM Flash MRAM RRAM
- 44. Благодарю за внимание !
- 45. а –область вблизи края электрода; б – структура островковой Au пленки на SiOx с массовой толщиной
- 46. Локальная электрополевая модификация проводимости наноразмерного слоя диоксида циркония а- Морфология и токовое изображение поверхности структуры ZrO2(Y)/Si.
- 47. Токовое изображение каналов протекания в диэлектрической матрице 4) 2.50 V 6) 3.72 V 5) 3.11 V
- 48. a - морфология поверхности; б–токовое изображение. Темный участок на токовом изображении с пониженной проводимостью, получен путем
- 49. Актуальность
- 50. Актуальность
- 52. Скачать презентацию









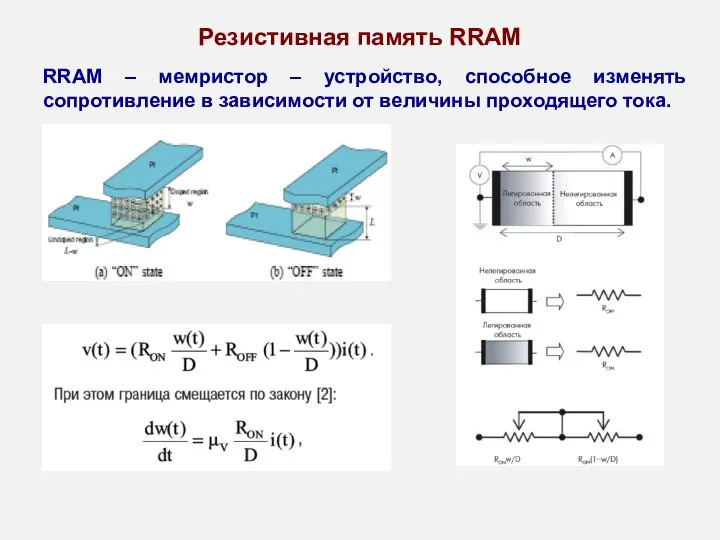


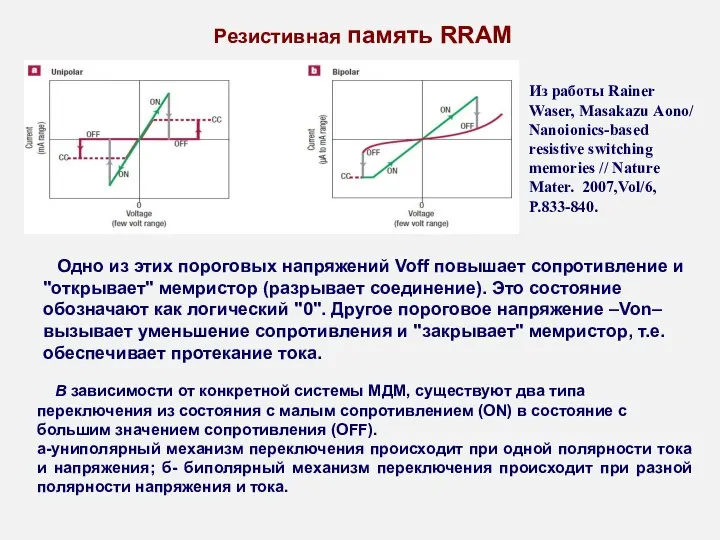
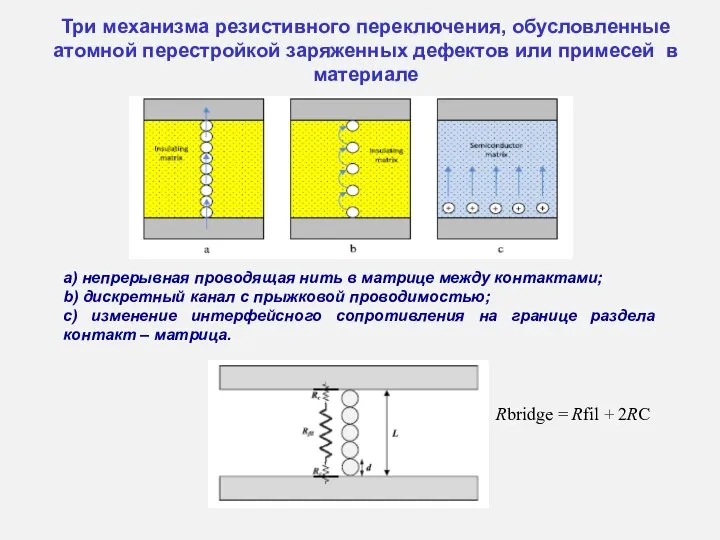


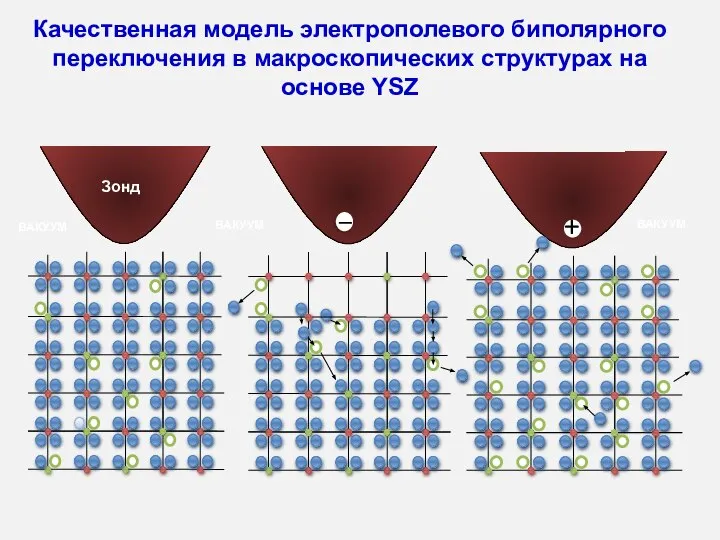


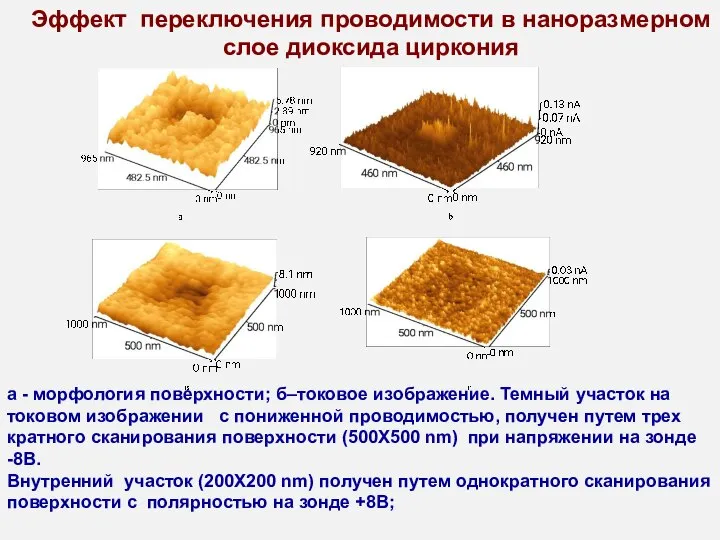
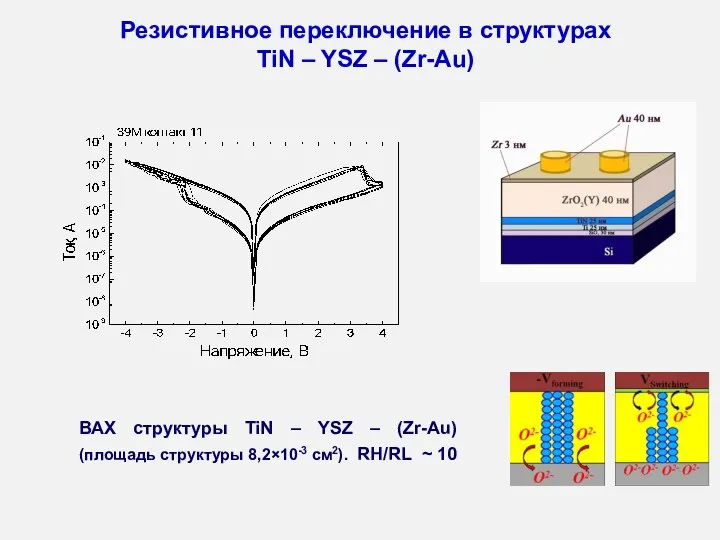
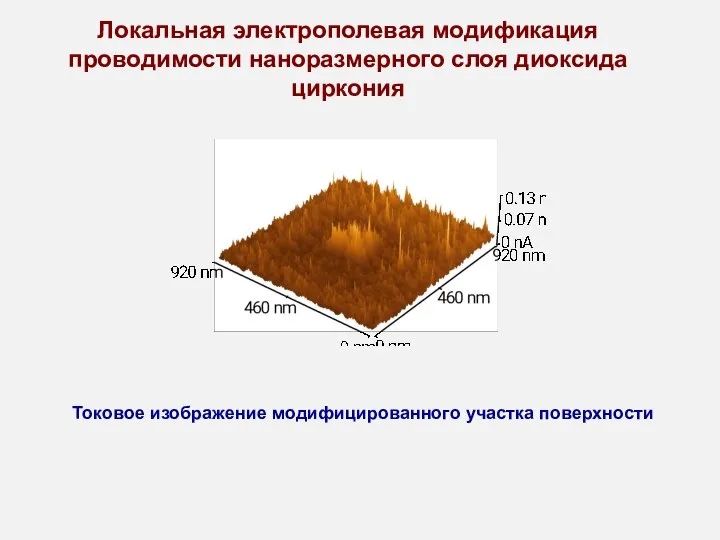
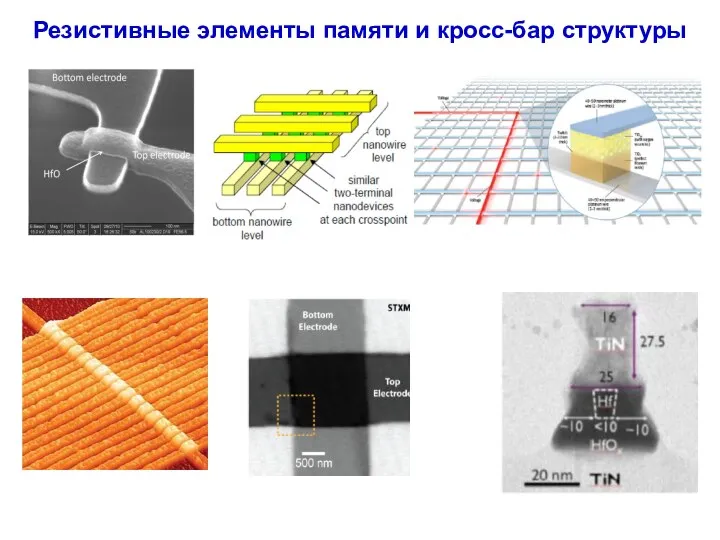




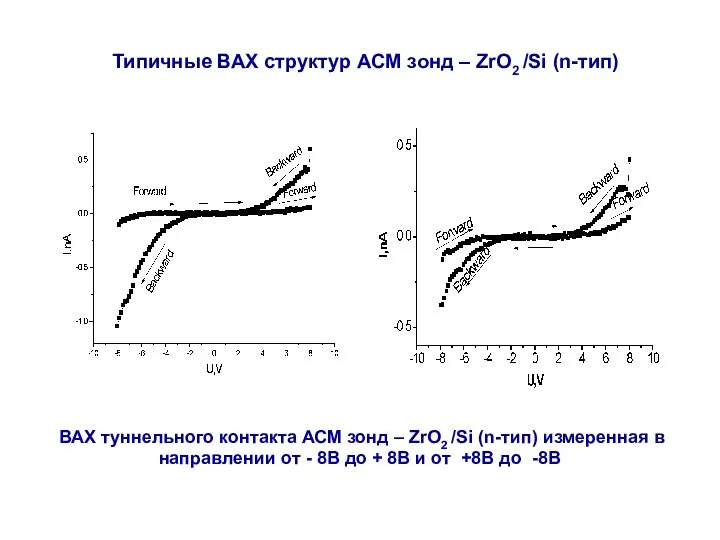



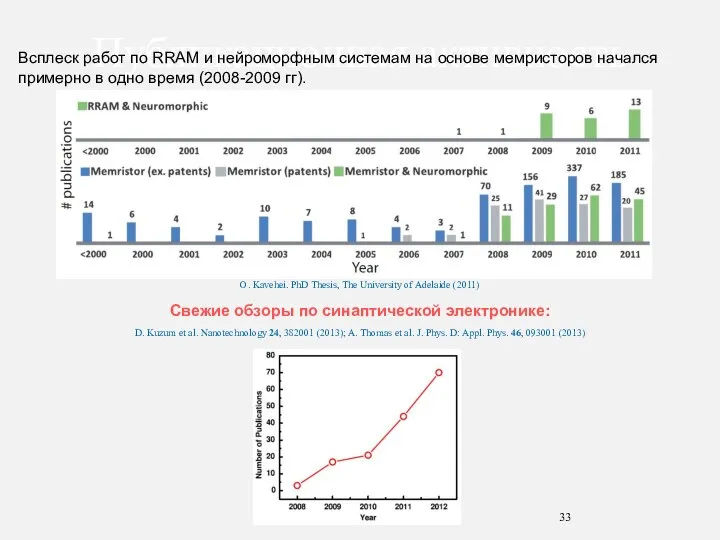



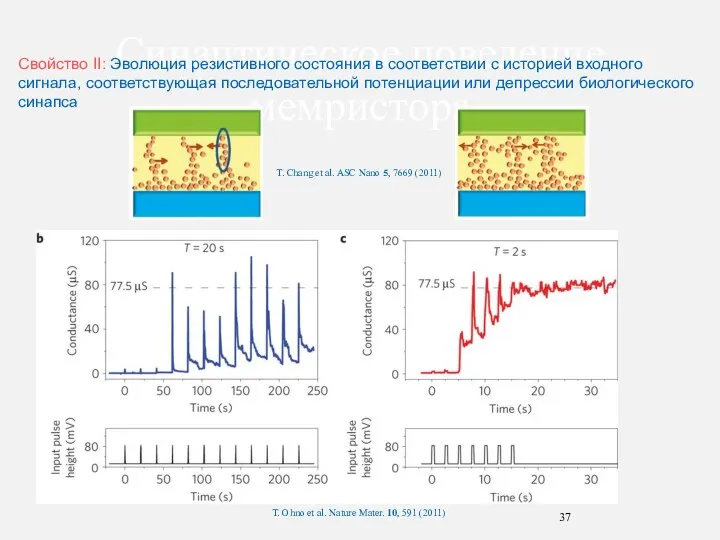
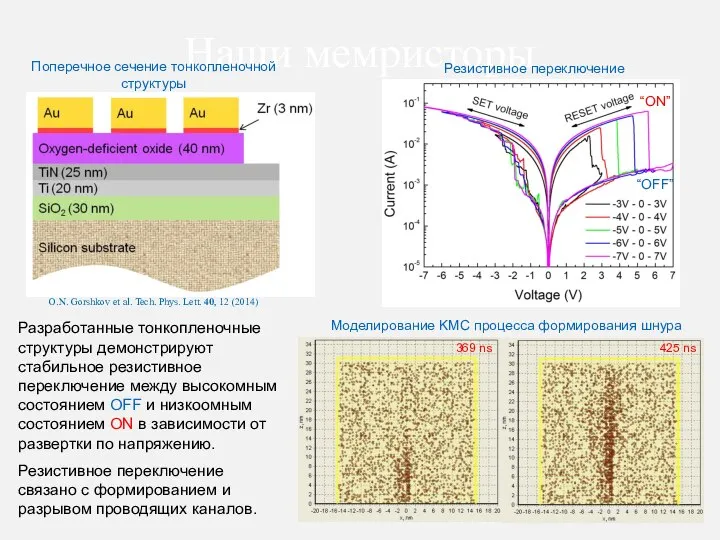








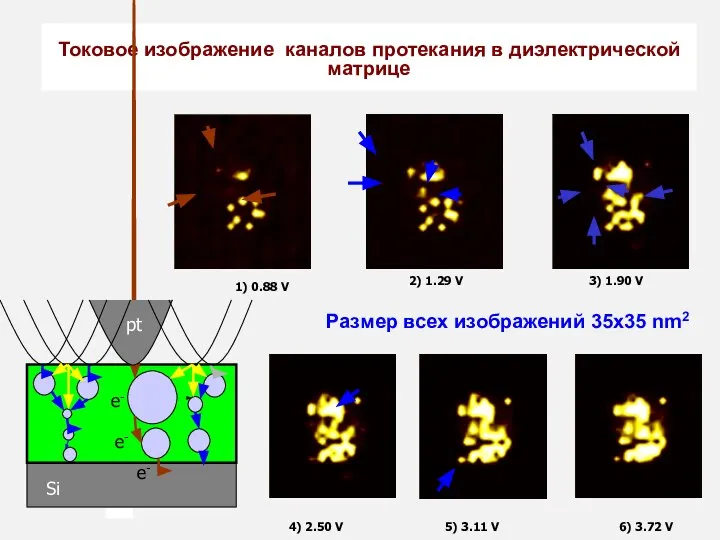
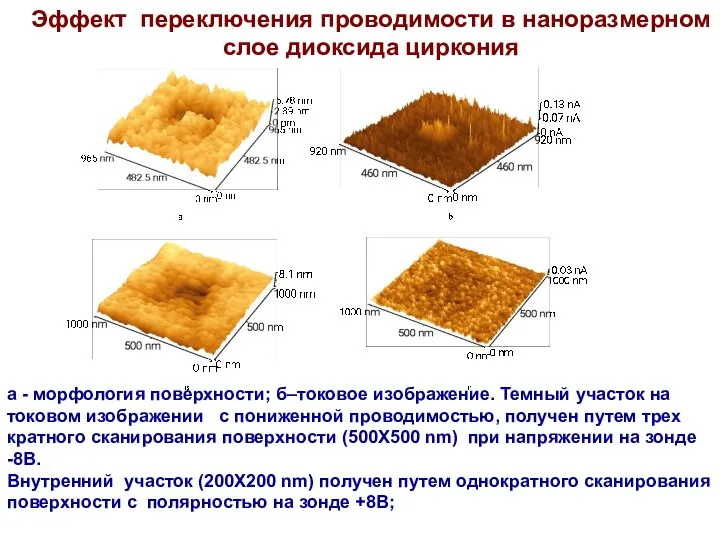


 Машиноведение
Машиноведение Методическая разработка по применению первого закона термодинамики к решению графических задач
Методическая разработка по применению первого закона термодинамики к решению графических задач Фотоэффект. Самостоятельная работа
Фотоэффект. Самостоятельная работа Прогнозирование изменения прочностных свойств резины при ее термическом старении
Прогнозирование изменения прочностных свойств резины при ее термическом старении Электромагнитное поле
Электромагнитное поле Проводники и диэлектрики
Проводники и диэлектрики Рассеяние света на шероховатой поверхности
Рассеяние света на шероховатой поверхности Единицы времени. Час. Минута
Единицы времени. Час. Минута Геометрическая оптика. (Лекция 6)
Геометрическая оптика. (Лекция 6) Вес. Невесомость. Перегрузки
Вес. Невесомость. Перегрузки Презентация на тему Великое открытие Архимеда
Презентация на тему Великое открытие Архимеда  Презентация на тему Волны. Звуковые волны. Звук
Презентация на тему Волны. Звуковые волны. Звук  Изобретение радио
Изобретение радио Технические измерения
Технические измерения Источники, концентраторы, приемники излучения
Источники, концентраторы, приемники излучения Сигналдар. Сигналдардың классификациясы
Сигналдар. Сигналдардың классификациясы Закон электромагнитной индукции
Закон электромагнитной индукции Определение объёма твердого тела
Определение объёма твердого тела Законы постоянного тока
Законы постоянного тока Основные детали остова двигателя. Станина и цилиндры. Картеры, крепление. Вентиляция. Урок № 7. Тема 2.4
Основные детали остова двигателя. Станина и цилиндры. Картеры, крепление. Вентиляция. Урок № 7. Тема 2.4 Назначение механических передач и их классификация по принципу действия
Назначение механических передач и их классификация по принципу действия Исследование оптических свойств халькогенидных стеклообразных полупроводников
Исследование оптических свойств халькогенидных стеклообразных полупроводников Сопротивление материалов
Сопротивление материалов IRS-P6 - усовершенствованный спутник дистанционного зондирования
IRS-P6 - усовершенствованный спутник дистанционного зондирования Силы. Сила тяжести
Силы. Сила тяжести Спектры. Устройство спектроскопа
Спектры. Устройство спектроскопа Классификация механических муфт
Классификация механических муфт Частотные методы оценки качества регулирования
Частотные методы оценки качества регулирования