Содержание
- 2. Достоинства ионного легирования точная дозировка примеси (теоретически – 1%, практически – 5%); высокая чистота; расширенная возможность
- 3. Схема установки ионного легирования Энергия ионов от десятков килоэлектронвольт до единиц мегаэлектронвольт вакуум порядка 10-4 Па
- 4. Оборудование ионной имплантации
- 5. Основные параметры ионного легирования Энергия ускоренных ионов. Ион с зарядом q [Кл], под действием разности потенциалов
- 6. источники с поверхностной термической ионизацией – нагреватель (вольфрамовая лента) на него насыпается соль металла – KJ,
- 7. Пробеги и дисперсии пробегов ионов
- 8. Распределение пробегов ионов
- 9. Теория Линдхарда, Шарфа и Шиотта Механизмы потерь энергии иона при его торможении в мишени независимы друг
- 10. Потери энергии иона при торможении
- 11. Проецированная длина (а) и рассеяние (б) пробега ионов а б
- 12. Каналирование ионов
- 15. Приближение Пирсона
- 17. Фронт р-п перехода при ионном (а) и диффузионном (б) локальном легировании Маскирование производится пленками окиси кремния;
- 18. Профили распределения дефектов и атомов бора дефекты Френкеля – вакансии и атомы в междуузлиях дефекты смещений
- 19. Структура нарушенных слоев
- 20. Дозы аморфизации кремния и германия (а) и температурные зависимости доз аморфизации кремния (б) критическая температура аморфизации
- 21. Влияние термообработки на распределение фосфора, внедренного в кремний
- 22. Импульсная термообработка Восстановление кристаллической структуры слоев практически без изменения профиля распределения примеси. Такая возможность обеспечивается за
- 23. Оказывается возможной рекристаллизация полностью аморфизированных и даже поликристаллических слоев. Может проводиться как при однородном нагреве всей
- 24. Импульсная термообработка Восстановление кристаллической структуры после ионной имплантации. Снижение плотности дислокаций на 2-3 порядка величины и
- 25. Применение ионного легирования 1. Введение примеси Загонка примеси с точной дозировкой Создание профиля с максимумом на
- 26. Геттерирование - удаление нежелательных примесей и дефектов. Высвобождение примесей или разложение протяженных дефектов на составные части.
- 27. Геттерирование - Диффузия фосфора - метод гетерирования Cu. Атомы Cu в Si находятся в междоузлиях, они
- 28. Диффузия в вакуум приводит к появлению у поверхности обедненного кислородом слоя В обедненном слое зародыши новой
- 32. Скачать презентацию



![Основные параметры ионного легирования Энергия ускоренных ионов. Ион с зарядом q [Кл],](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1178856/slide-4.jpg)




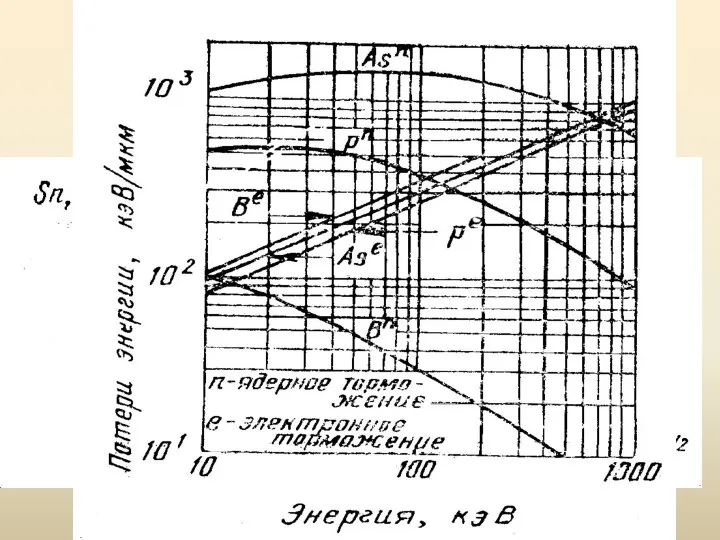



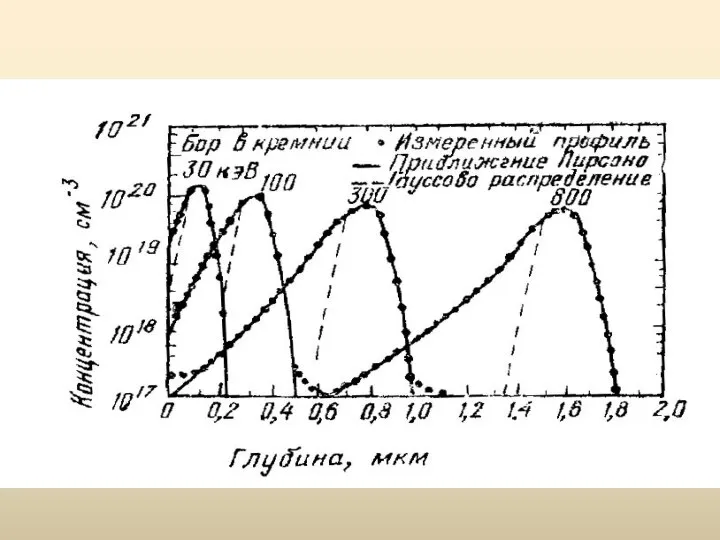















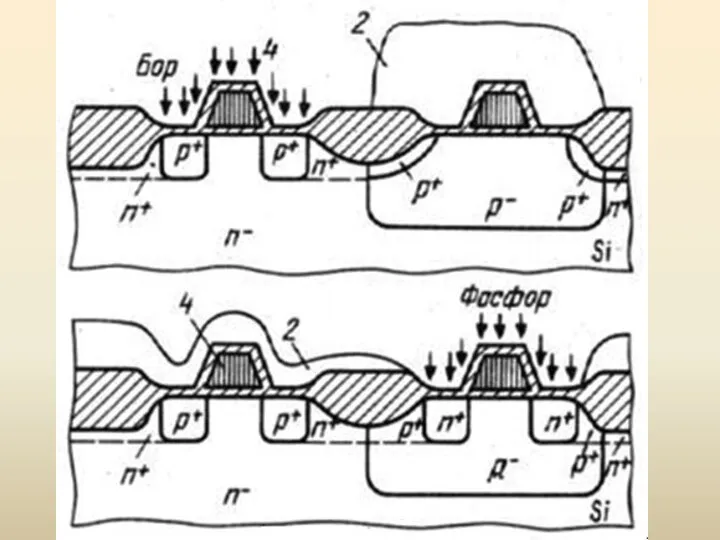
 Алгоритмизация и программирование, язык C++. 10 класс
Алгоритмизация и программирование, язык C++. 10 класс Алгоритм и его свойства
Алгоритм и его свойства Java. Сетевые приложения
Java. Сетевые приложения Братья Гримм. Сказки
Братья Гримм. Сказки Разработка eSIM
Разработка eSIM Создание презентации для выступления
Создание презентации для выступления Программа Microsoft Excel
Программа Microsoft Excel Приклад презентації. Реєстрація користувача
Приклад презентації. Реєстрація користувача Понятие и система средств массовой коммуникации
Понятие и система средств массовой коммуникации Формирование изображения на экране монитора
Формирование изображения на экране монитора Реляционная модель данных
Реляционная модель данных ДЗ_Данные в компьютере
ДЗ_Данные в компьютере Wprowadzenie do UML’a
Wprowadzenie do UML’a Занимательная информатика
Занимательная информатика Monatsübersicht august. Посещаемость, время на сайте
Monatsübersicht august. Посещаемость, время на сайте Кластерный анализ
Кластерный анализ Язык программирования Turbo Paskal
Язык программирования Turbo Paskal Компьютерная графика
Компьютерная графика Кучи. Применение
Кучи. Применение Компьютерная игра Управление развитием территории
Компьютерная игра Управление развитием территории Сетевое планирование (практическое занятие)
Сетевое планирование (практическое занятие) Mobirise - руководство
Mobirise - руководство QR-код создание и применение
QR-код создание и применение Оптимизация процедуры расчета нормированных метрологических характеристик при выездной поверке
Оптимизация процедуры расчета нормированных метрологических характеристик при выездной поверке Алгоритмы работы с графами с использованием MapReduce
Алгоритмы работы с графами с использованием MapReduce Кодирование информации. Мастер-класс
Кодирование информации. Мастер-класс Кибербезопасность и хакинг
Кибербезопасность и хакинг Программирование на языке Python
Программирование на языке Python