Содержание
- 2. План выступления 1. Рентгеновское излучение. Рентгенооптические элементы 2. Многослойные зеркала 3. Методы синтеза многослойных структур 4.
- 3. 1.1. Особенности рентгеновского излучения Рентгеновский и ЭУФ диапазон λ = 0.01- 60 нм ⏐1 - ε⏐
- 4. 1.2. Элементы рентгенооптики Элементы для управления рентгеновскими пучками (распространение, направление, угловые и спектральные характеристики) Кристаллы Зонные
- 5. Кристаллы Условие Вульфа-Брэгга: 2d⋅sinθ = nλ Достоинство: Сочетание высоких R с высокой селективностью E/ΔE Недостатки: Зачастую
- 6. Зонные пластинки Фокусирующий элемент, аналог линзы Чередующаяся последовательность прозрачных и непрозрачных кольцевых зон Френеля Достоинство: Высокое
- 7. «Линзы» Кумахова Принцип: многократное полное внешнее отражение от стенок Достоинство: Нет ограничения на апертуру – высокая
- 8. 2. Многослойные зеркала Принцип: интерференция волн, отражённых от границ раздела материалов 2d sin θ = mλ
- 9. Отражательные характеристики МЗ Для заданного угла падения Первостепенно: R(λ) в окрестности рабочей λ (Rпик, Δλ) Второстепенно:
- 10. Характеристики МЗ как элемента оптики Система подложка + покрытие Плоская или с кривизной Линейные размеры ~
- 11. Разработка и синтез МЗ Выбор материалов Расчёт отражательных характеристик Синтез структур Измерение характеристик, определение истинных параметров
- 12. Выбор материалов 1. Выбор базового материала Im (ε1) минимальна 2. Выбор контрастного материала |Re(ε2-ε1)|/Im (ε2) максимально
- 13. Расчёт характеристик 1. Приближённый метод медленных амплитуд | ε2-ε1| Преимущества: рецепт выбора материалов и параметров структуры,
- 14. Разработка и синтез МЗ Выбор материалов Расчёт отражательных характеристик Синтез структур Измерение характеристик, определение истинных параметров
- 15. 3.1. Вакуумный объём Приемлемое давление остаточных газов: P ~ 7 ÷ 8 ·10-5 Па Основной вклад
- 16. Электронно-лучевое испарение Принцип: нагрев мишени пучком электронов, испарение и конденсация на подложке Недостатки: низкая стабильность потока
- 17. Импульсно-лазерное напыление Принцип: использование лазерного излучения для «выбивания» материала с поверхности мишени с последующим его осаждением
- 18. Ионно-пучковое напыление Принцип: использование пучка ионов для распыления материала мишени с последующим осаждением его на подложке
- 19. Магнетронное напыление: магнетрон Принцип: ионы плазмы устремляются к мишени, находящейся под отрицательным потенциалом и выбивают атомы
- 20. Магнетронное напыление: установка Установки в ИФМ РАН: 2-х, 4-х и 6-ти магнетронные – распыление до 6
- 21. Магнетронное напыление: процесс
- 22. Разработка и синтез МЗ Выбор материалов Расчёт отражательных характеристик Синтез структур Измерение характеристик, определение истинных параметров
- 23. 4. Измерение характеристик Жест. рент. λ=0,154 нм Мягк. рент. и ЭУФ
- 24. Влияние межслоевой шероховатости Учёт шероховатости σ: R=Ridexp(- 4π2n2σ2/d2) МЗ Mg/Si d=15 нм МЗ La/B4C d=3.5 нм
- 25. Межслоевая шероховатость Методы: Вариация энергии распыляющих ионов Осаждение барьерных слоев Ионное ассистирование и полировка
- 26. Влияние плотности плёнок Поскольку ε=f(ρ), то R=F(ρ) Зависимость R от ρ La для МЗ La/B4C
- 27. Влияние непериодичности структуры Сравнение 1-го брэгговского пика (λ=0,154 нм) для периодического МЗ La/B4C d=3,5 нм и
- 28. Разработка и синтез МЗ Выбор материалов Расчёт отражательных характеристик Синтез структур Измерение характеристик, определение истинных параметров
- 29. Отслаивание плёнки Скручивание при стравливании Деформация подложки Внутренние напряжения в МЗ Негативные последствия
- 30. Внутренние напряжения в МЗ Требование: точность формы поверхности элемента схемы 0,3-0,6 нм Осаждённое на подложку МЗ
- 32. Скачать презентацию



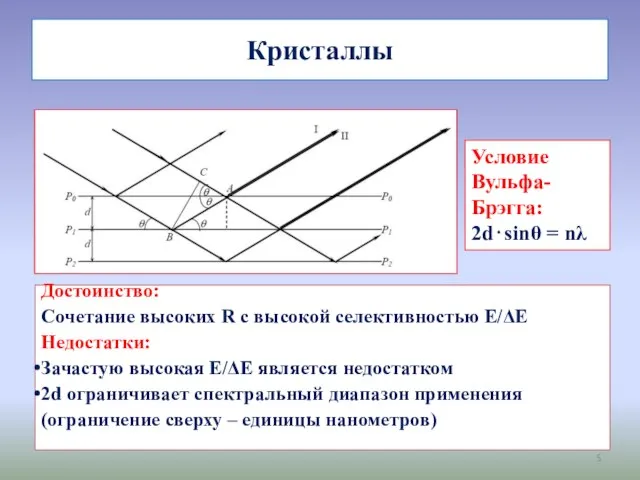


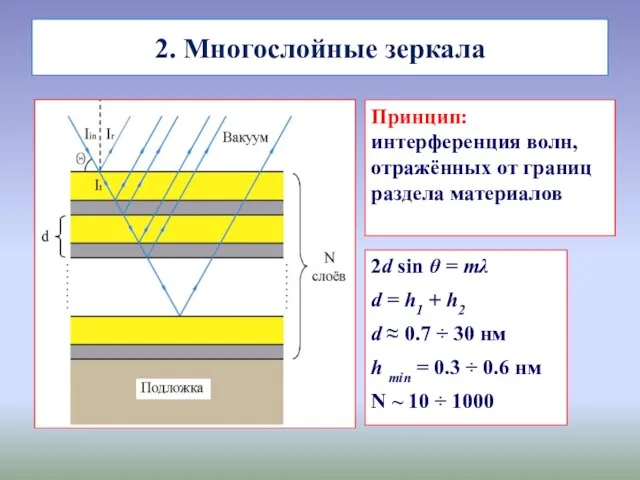









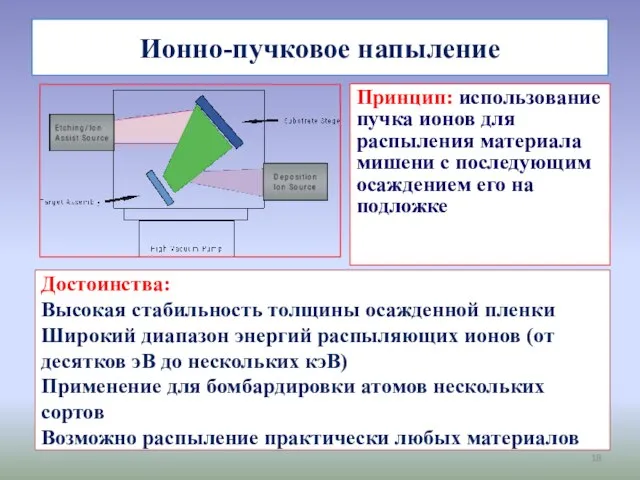

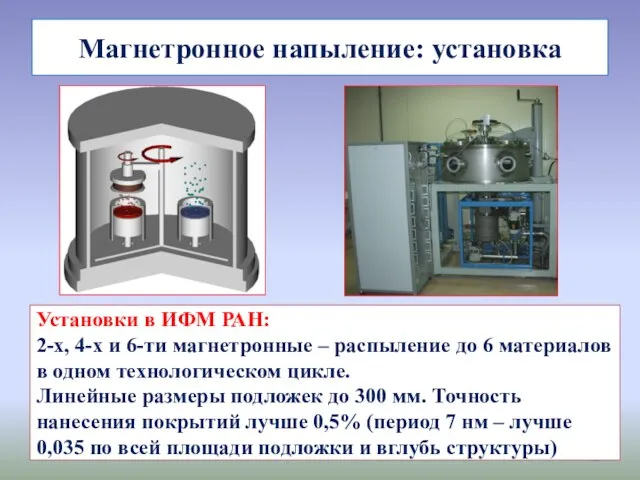




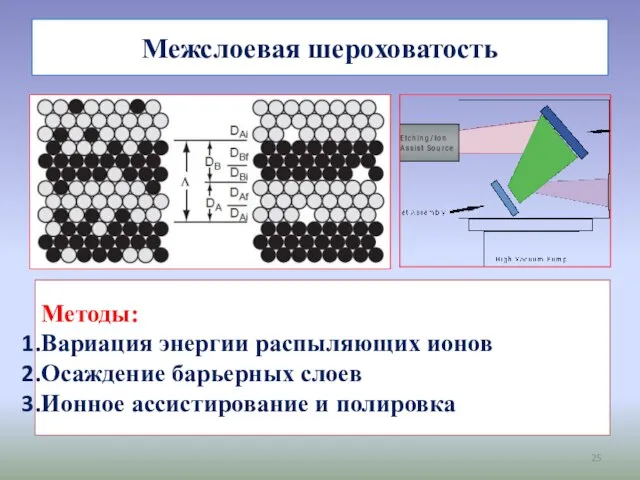




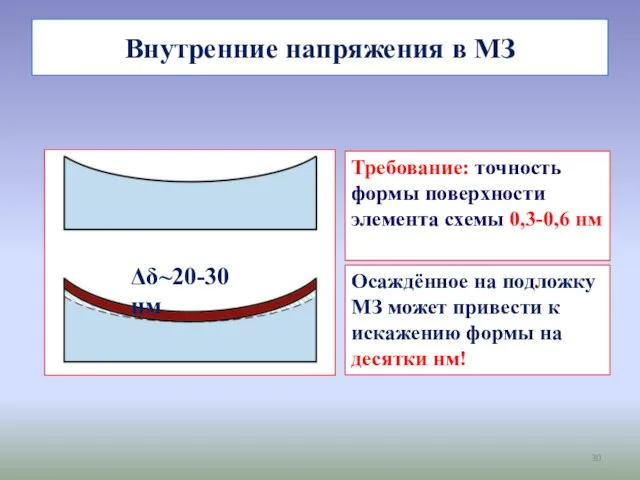
 Станковая скульптура: бюст
Станковая скульптура: бюст Отчёт директората цифрового телевидения Alma tv за период с 13 по 19 Октября 2017г
Отчёт директората цифрового телевидения Alma tv за период с 13 по 19 Октября 2017г Системный подход на благо людей и природы
Системный подход на благо людей и природы Живете
Живете Этико-правовые проблемы конца жизни человека
Этико-правовые проблемы конца жизни человека ПРИЧИНЫ ВОЗНИКНОВЕНИЯ ПОЖАРОВ В ЖИЛЫХ И ОБЩЕСТВЕННЫХ ЗДАНИЯХ.
ПРИЧИНЫ ВОЗНИКНОВЕНИЯ ПОЖАРОВ В ЖИЛЫХ И ОБЩЕСТВЕННЫХ ЗДАНИЯХ. УСПЕНСКИЙ СОБОР
УСПЕНСКИЙ СОБОР Опале листя: користь чи шкода
Опале листя: користь чи шкода Государственное управление в области природопользования и охраны окружающей среды
Государственное управление в области природопользования и охраны окружающей среды Магнитная гидродинамика солнечных явлений
Магнитная гидродинамика солнечных явлений Пишем проект!
Пишем проект! Этапы речевого развития
Этапы речевого развития Растения Чувашской республики
Растения Чувашской республики Эффективность стратегии диверсификации на российском рынке(эмпирическое исследование)
Эффективность стратегии диверсификации на российском рынке(эмпирическое исследование) Стресс и пути его преодоления
Стресс и пути его преодоления Интерактивные формы и методы в преподавании русского языка и литературы. Тема: Групповые формы работы на уроках русского языка и л
Интерактивные формы и методы в преподавании русского языка и литературы. Тема: Групповые формы работы на уроках русского языка и л Западный и Восточный типы культуры
Западный и Восточный типы культуры Упражнение Настроение
Упражнение Настроение Выполняй правила безопасности на дороге!
Выполняй правила безопасности на дороге! Тихонова Тамара Вячеславовна учитель истории и обществознания ГОУ лицей № 150
Тихонова Тамара Вячеславовна учитель истории и обществознания ГОУ лицей № 150 ОРКиСЭ
ОРКиСЭ Непревзойденные преимущества систем T2Red + T2Reflecta
Непревзойденные преимущества систем T2Red + T2Reflecta Модели данных
Модели данных  Модель организации внеурочной деятельности на основе краткосрочных курсов
Модель организации внеурочной деятельности на основе краткосрочных курсов История развития системы железнодорожной автоматики, применяемые на железнодорожном транспорте (АТМ) в России
История развития системы железнодорожной автоматики, применяемые на железнодорожном транспорте (АТМ) в России Высокоранговые и Низкопримативные правят миром
Высокоранговые и Низкопримативные правят миром Ртуть
Ртуть Презентация на тему: клавиатура.Авторы: Суханов Г.
Презентация на тему: клавиатура.Авторы: Суханов Г.