Содержание
- 2. Содержание Введение Обзор зарубежных исследований по сплавам GeSn Перспективы МЛЭ структуры GeSn/Si Имплантация Ge и Sn
- 3. Введение Современное состояние технологии микроэлектроники: Базовый материал - кремний. Более 95% полупроводниковых устройств создается на основе
- 4. Обзор зарубежных исследований по сплавам GeSn Выращивание когерентных, однородных эпитаксиальных пленок SnxGe1-x/Ge(001) Рис. 1. ПЭМ микрофотографии
- 5. Рис. 4. Зависимость ширины запрещенной зоны в сплаве SnxGe1-x от содержания Sn. Рис. 5. Зависимость пропускания
- 6. 1 НАПРАВЛЕНИЕ Исследование сплавов GeSn: Теория: Сплавы Ge1-xSnx: - имеют прямую запрещенную зону при x -
- 7. 2 НАПРАВЛЕНИЕ Исследование структур (Ge+Sn)/Si: Теория: Существует возможность реализации прямого оптического перехода в системе Si/Ge при
- 8. Методические особенности МЛЭ структуры GeSn/Si
- 9. Рис. 2. Светлопольные ПЭМ микрофотографии от образцов С2 а) 925 °С 60 мин б) 950 °С
- 10. Выводы Сформированные нанокластеры Ge1-xSnx имеют средний размер ~10 нм, поверхност-ную плотность ~4.5×1010 см-2 Формирование нанокластеров Ge1-xSnx
- 11. Методические особенности Имплантация Ge и Sn в SiO2/Si
- 12. Рис.1. Спектр РОР от образцов “A” (a) и “B” (б) после отжига в атмосфере сухого азота
- 13. Рис.3. Изображения электронной дифракции, полученные от образцов “B”, отожженных в атмосфере сухого азота в течение 30
- 14. Выводы Cлои SiO2 содержат нанокластеры Ge и Sn. Средний размер и плотность нанокластеров варьируются в зависимости
- 15. Методические особенности Малые концентрации Sn в МЛЭ слоях Ge/Si
- 16. Рис. 1. ПЭМ микрофотографии образцов структуры (11Å Ge + 2,5% Sn), выращенной при температурах МЛЭ: а
- 18. Скачать презентацию


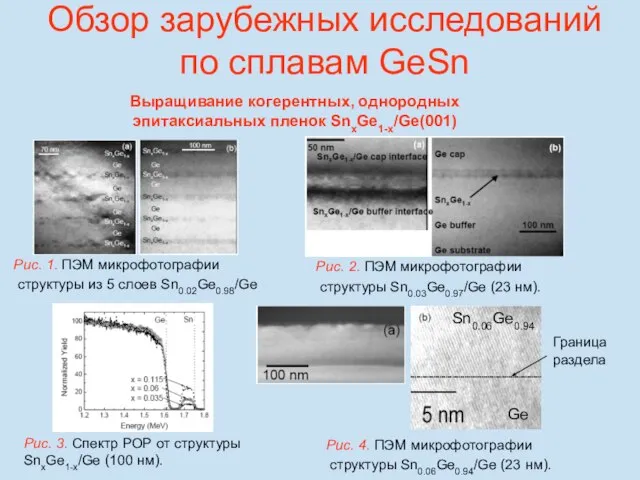
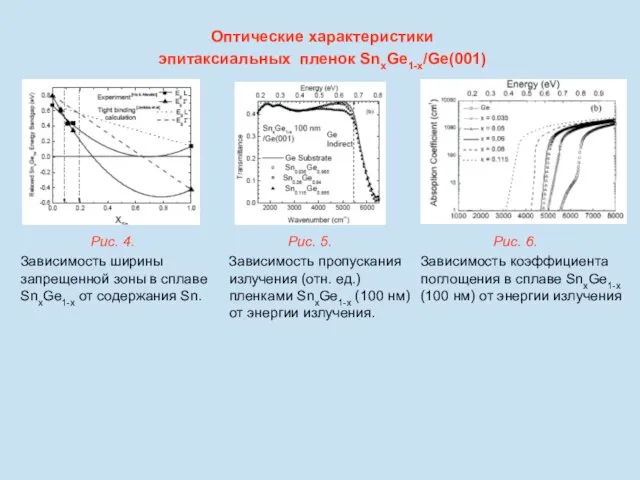



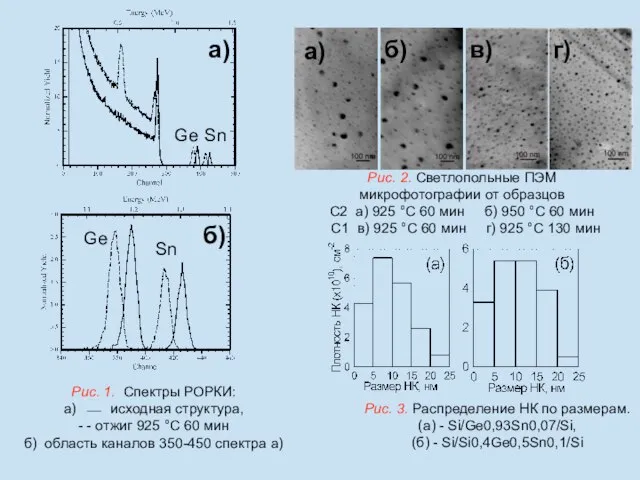


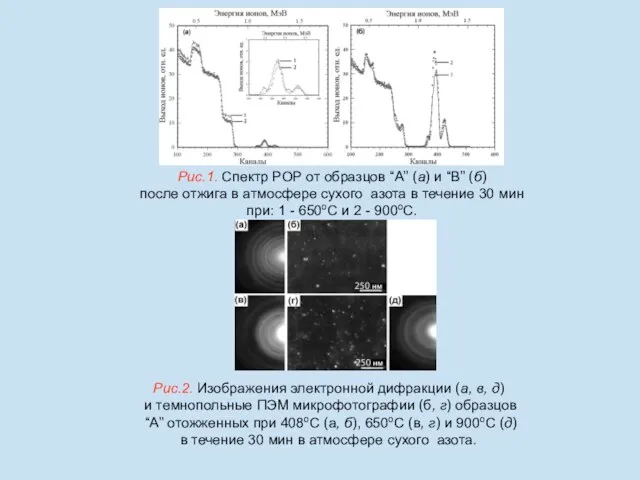



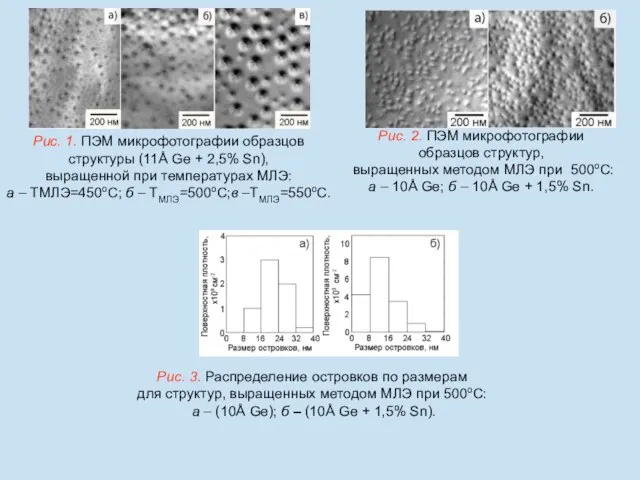
 Язык программирования QBASIC
Язык программирования QBASIC Практическое занятие № 2
Практическое занятие № 2 Как вы считаете, что выгоднее подключить жителю Кузбасса?
Как вы считаете, что выгоднее подключить жителю Кузбасса? Назначение и устройство компьютера
Назначение и устройство компьютера Первоочередные мероприятия по организации энергосервисного контракта Инвентаризация средств учета, разработка проектной докуме
Первоочередные мероприятия по организации энергосервисного контракта Инвентаризация средств учета, разработка проектной докуме «Друзья мои, прекрасен наш союз!»материалы к уроку по анализу стихотворения А.С.Пушкина «19 октября»
«Друзья мои, прекрасен наш союз!»материалы к уроку по анализу стихотворения А.С.Пушкина «19 октября» Презентация на тему Графы. Поиск путей в графе
Презентация на тему Графы. Поиск путей в графе  Сухой электростатический перенос
Сухой электростатический перенос Сложные эфиры. Жиры
Сложные эфиры. Жиры Кафедра конституционного и международного права
Кафедра конституционного и международного права Гепард (4 класс)
Гепард (4 класс) А. Платонов «Неизвестный цветок»
А. Платонов «Неизвестный цветок» Работа выполнена в рамках проекта «Повышение квалификации различных категорий работников образования и формирование у них базов
Работа выполнена в рамках проекта «Повышение квалификации различных категорий работников образования и формирование у них базов «Чтобы жить честно…». Жизненные искания героев романа «Война и мир» - Андрея Болконского и Пьера Безухова.
«Чтобы жить честно…». Жизненные искания героев романа «Война и мир» - Андрея Болконского и Пьера Безухова. La petite robe noir. Французкая киновесна GUERLAIN
La petite robe noir. Французкая киновесна GUERLAIN Трудовой кодекс. Дисциплина труда
Трудовой кодекс. Дисциплина труда Кормилица наша - Бурёнушка
Кормилица наша - Бурёнушка «Мастер и Маргарита»В. Лакшин отмечал, что, «выбирая посмертную судьбу Мастеру, Булгаков выбирал судьбу себе». Это его изм
«Мастер и Маргарита»В. Лакшин отмечал, что, «выбирая посмертную судьбу Мастеру, Булгаков выбирал судьбу себе». Это его изм Презентация на тему Цивилизации Востока
Презентация на тему Цивилизации Востока  Famous works by Salvador Dali
Famous works by Salvador Dali Органы пищеварения
Органы пищеварения Тестовые задания
Тестовые задания Федеральная служба по интеллектуальной собственности и патентам
Федеральная служба по интеллектуальной собственности и патентам Карты энергоресурсов
Карты энергоресурсов Мозаика
Мозаика Работа Куусик Марии 10б класс
Работа Куусик Марии 10б класс История появления цифр
История появления цифр Моральный выбор, разрешение конфликтных ситуаций в юридической деятельности
Моральный выбор, разрешение конфликтных ситуаций в юридической деятельности