Содержание
- 2. Пример конструкции радиоэлектронного узла со смешанным монтажом
- 3. Пример конструкции радиоэлектронного узла преимущественно с монтажом на поверхность
- 4. Разновидности электронных сборок (класcификация приведена в соответствии с IPC782) Тип 1В: SMT Только верхняя сторона Тип
- 5. Варианты конструкций радиоэлектронных узлов (по стандарту IPC 782A)
- 6. Конструктивные варианты и типы технологических процессов изготовления узлов с КМП (SMD) Примечание: ИК – пайка инфракрасным
- 7. Конструктивные варианты и типы технологических процессов изготовления узлов с ТМП ТМП +ТМО КМП1 КМП1 КМП2 КМО
- 8. Технологически маршрут сборки печатных плат
- 9. Основные преимущества ТМП ● увеличение плотности монтажа из-за существенно меньших размеров компонентов, возможности их расположения с
- 10. Состояние и тенденции развития элементной базы для поверхностного монтажа Дополнительная литература: 1. Монтаж на поверхность: Элементная
- 11. Состояние и тенденции развития элементной базы для поверхностного монтажа
- 12. Развитие корпусов микросхем BGA [ball grid array] — корпус ИМС с массивом шариковых выводов под корпусом
- 13. Эволюция корпусов микросхем
- 14. Разновидности корпусов КМП: Чип резисторы и чип конденсаторы
- 15. Конструкция толстопленочного чип-резистора 1 – Керамическое основание; 2 – Резистивный слой (окись рутения); 3 – Внутренний
- 16. Конструкция толстопленочного чип-резистора 1 – Керамическое основание; 2 – Резистивный слой (окись рутения); 3 – Внутренний
- 17. Конструкция толстопленочного чип-резистора .
- 18. Обозначение основных размеров чип- компонента
- 19. Сопоставительные размеры чип-компонентов (на фоне сетки 1 мм) .
- 20. Уменьшение размеров чип- компонентов
- 21. Уменьшение размеров чип- компонентов
- 22. Тенденции мирового потребления различных типоразмеров пассивных компонентов
- 23. Керамические чип-конденсаторы NPO (COG) – используется в прецизионных цепях. Имеет очень малые потери при изменениях температуры
- 24. Конструкция танталового конденсатора Диапазон емкостей – от 0,47 до 220 мкФ при рабочем напряжении от 6,3
- 25. Габаритный чертёж корпуса (а) и размеры контактных площадок (б) алюминиевого оксидно-электролитического конденсатора .
- 26. Обозначение номиналов чип-компонентов Резисторы: Маркировка резисторов состоит из трёх цифр для простых и четырёх цифр для
- 27. Обозначение номиналов чип-компонентов Конденсаторы: первые две цифры указывают номинал в пикофарадах, третья цифра – количество добавляемых
- 28. Обозначение номиналов чип-компонентов Конденсаторы: б) код содержит четыре знака (буквы и цифры), обозначающие номинальную емкость и
- 29. Обозначение номиналов чип-компонентов Конденсаторы: в) при большом размере корпуса код располагается в две строки. На верхней
- 30. Корпус типа MELF (Metal Electrode Face Bonded) . Малогабаритный диодный корпус SOD (Small Outline Diode) Разновидности
- 31. Конструкция корпуса типа MELF .
- 32. Резисторные и конденсаторные сборки
- 33. Малогабаритные транзисторные корпуса SOT (Small Outline Transistor)
- 34. Габаритные размеры корпусов типа SOT SOT-23 (KT-46) SOT-89 (KT-47) SOT-143 (KT-48)
- 35. Корпус для мощных транзисторов типа ТО-252
- 36. Корпуса транзисторов по стандарту EIAJ (Electronic Industries Association of Japan)
- 37. Корпуса транзисторов по стандарту EIAJ
- 38. Разновидности корпусов транзисторов фирмы NEC
- 39. Разновидности корпусов транзисторов
- 40. Конструкция выводов корпусов микросхем
- 41. Разновидности корпусов микросхем с двусторонним расположением выводов в форме крыла чайки а – корпус типа SOIC;
- 42. Обозначение корпусов для микросхем Корпуса типа SOIC (Small Outline Integrated Circuit) и SOP (Small Outline Packages)
- 43. Корпус микросхемы с J-образными выводами Корпуса типа SOJ (Small Outline with «J» leads) с двусторонним расположением
- 44. Отечественные корпуса микросхем Габаритные размеры корпусов подтипа 43 (аналог SOIC)
- 45. Корпус микросхемы с J-образными выводами и четырехсторонним расположением выводов (PLCC и PLCC-R) PLCC (Plastic Leaded Chip
- 46. Разновидности корпусов микросхем с четырехсторонним расположением выводов в форме крыла чайки (QFP)
- 47. Характеристики корпусов типа QFP Корпуса типа QFP (Quad Flat Pack) и SQFP (Shrink Quad Flat Pack),
- 48. Направления развития микрокорпусов Поэтому для решения проблемы коммутации кристаллов микросхем в настоящее время выход ищут в
- 49. Матричные корпуса для микросхем На сегодняшний день разработаны следующие типы матричных корпусов: PBGA – Plastic Ball
- 50. Конструкция корпуса типа BGA 0,36…0,6 0,8…1,2 Печатная плата корпуса BGA Золотой проводник Компаунд с наполнением Ag
- 51. Простая система в корпусе BGA
- 52. Матричный корпус типа BGA Вид снизу на корпус типа BGA Матрица шариковых выводов может быть полной
- 53. КОРПУСА типа CSP (Chip Scale Package) . Развитие технологии изготовления корпусов BGA привело к созданию корпусов
- 54. КОРПУСА типа CSP .
- 55. Микросхемы в корпусах FC (FCIP flip chip — перевёрнутый кристалл)
- 56. Эффективность использования площади печатной платы при монтаже микросхем в различных корпусах
- 57. QFP 900 мм2 - 100% TAB/TCP 400 мм2 — 44% COB/BGA 225 мм2 — 25% FCIP/CSP
- 58. Эффективность использования площади печатной платы при монтаже микросхем в различных корпусах .
- 59. Топологические возможности корпусов различного типа 600 800 1000 1200 0 20 40 60 80 100 120
- 60. Нестандартные корпуса для компонентов неправильной формы
- 61. Этапы развития микрокорпусов BGA [ball grid array] — корпус ИМС с массивом шариковых выводов под корпусом
- 62. Прогноз развития микроэлектронных технологий Примечание: МП – микропроцессор; ДЗУПВ – динамическое запоминающее устройство с произвольной выборкой;
- 63. Направления развития микрокорпусов Дальнейшее развитие микрокорпусов – в направлении уменьшения шага выводов и габаритных размеров, увеличения
- 64. Матричные корпуса для микросхем На сегодняшний день разработаны следующие типы матричных корпусов: PBGA – Plastic Ball
- 65. Максимальное количество выводов корпусов при заданном шаге Площадь корпуса при числе выводов 300 и заданном шаге
- 66. Рост уровней плотности компоновки
- 68. Скачать презентацию

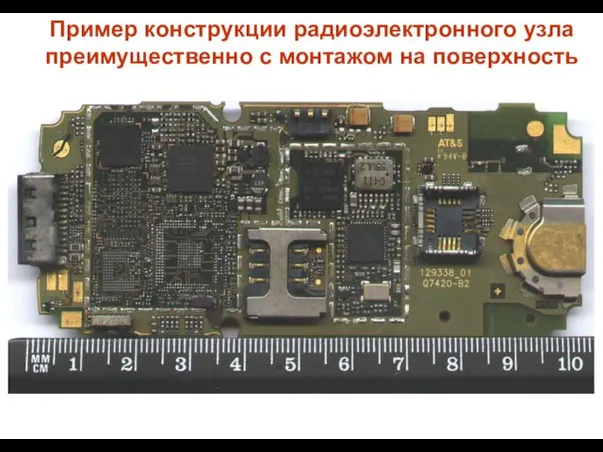
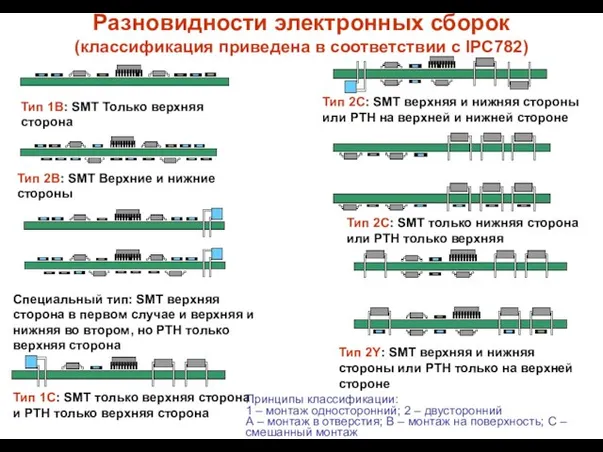






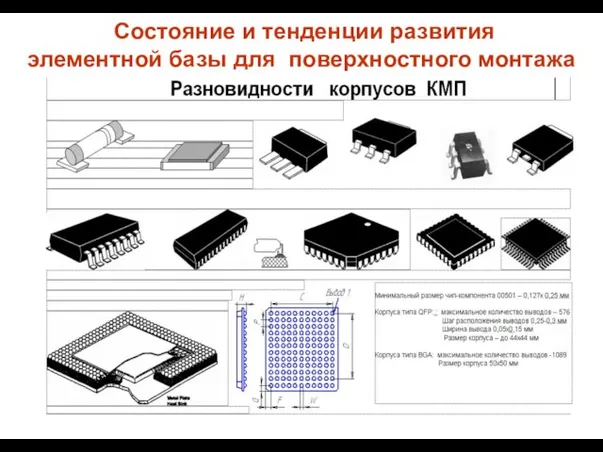
![Развитие корпусов микросхем BGA [ball grid array] — корпус ИМС с массивом](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/366271/slide-11.jpg)



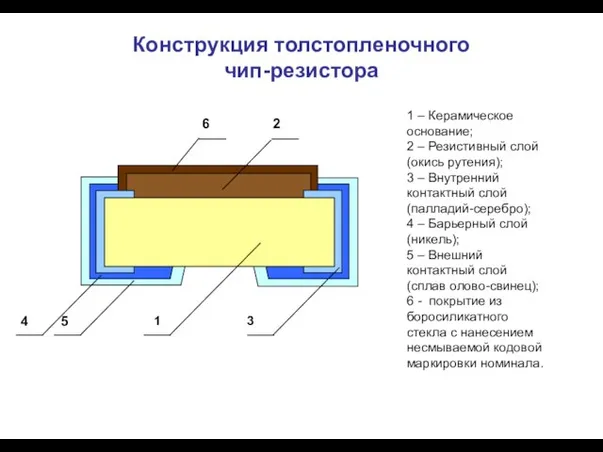


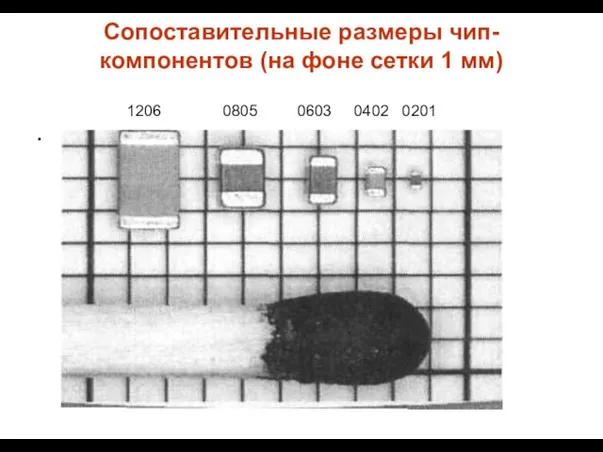



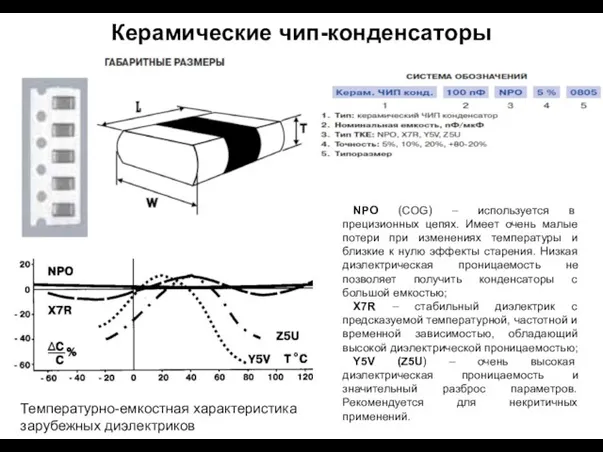

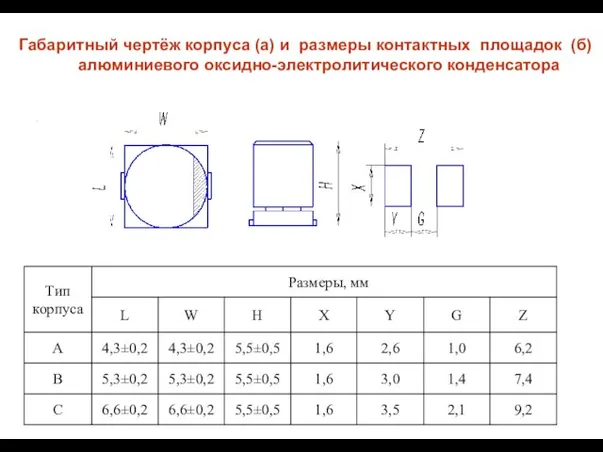










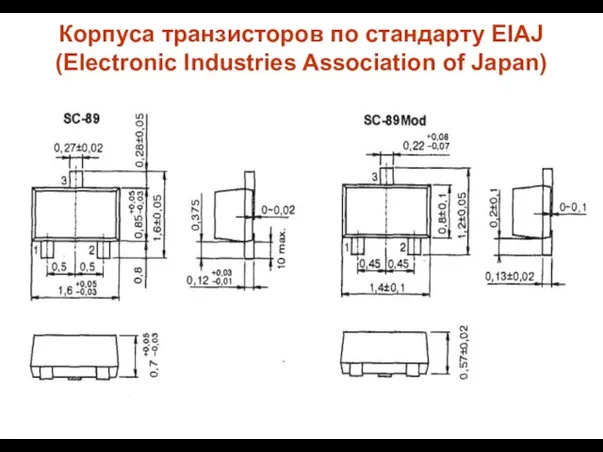




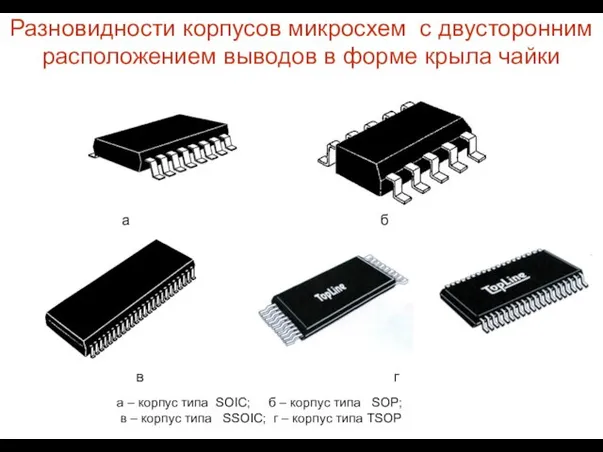




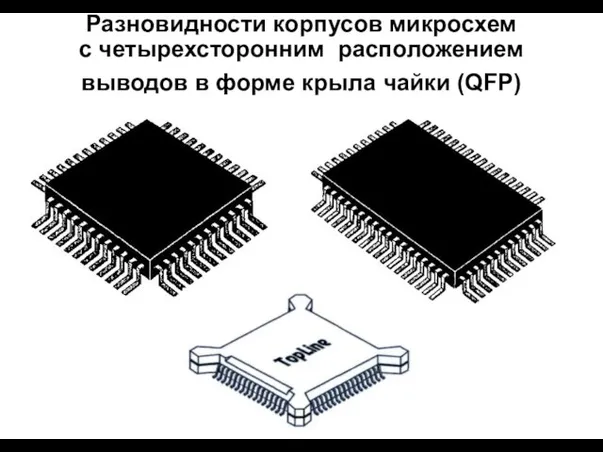





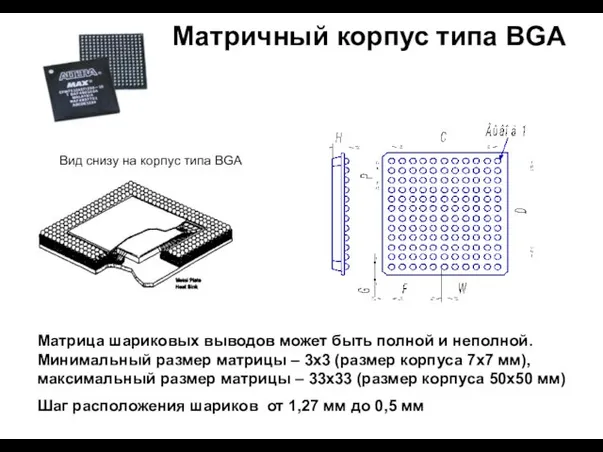
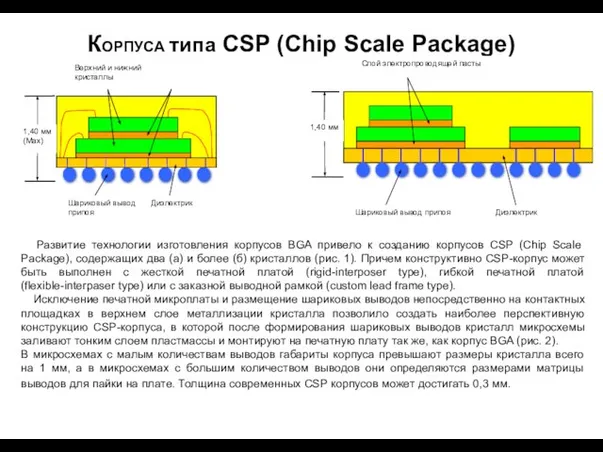
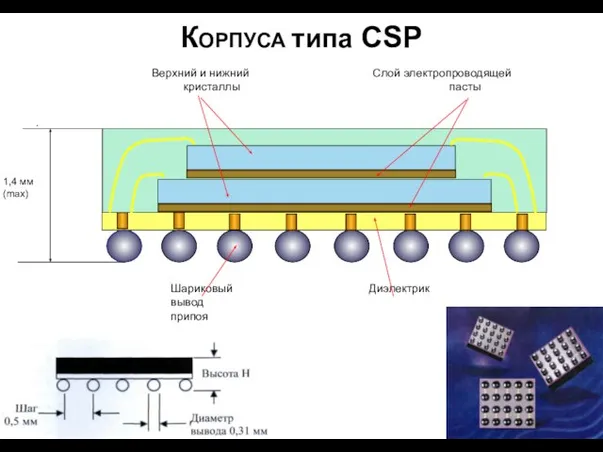


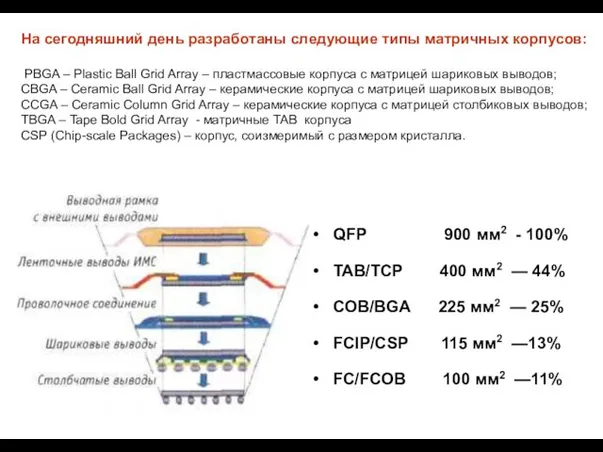
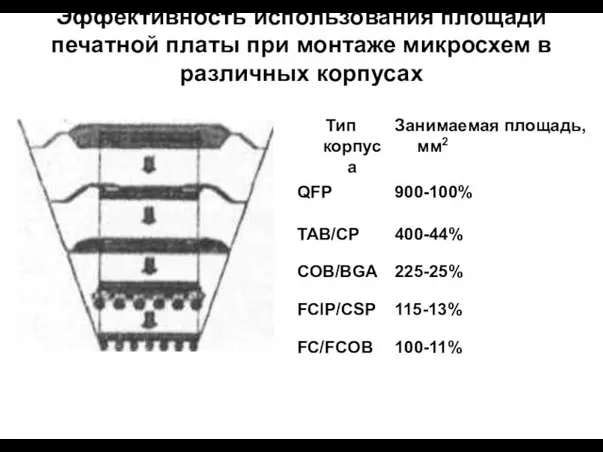
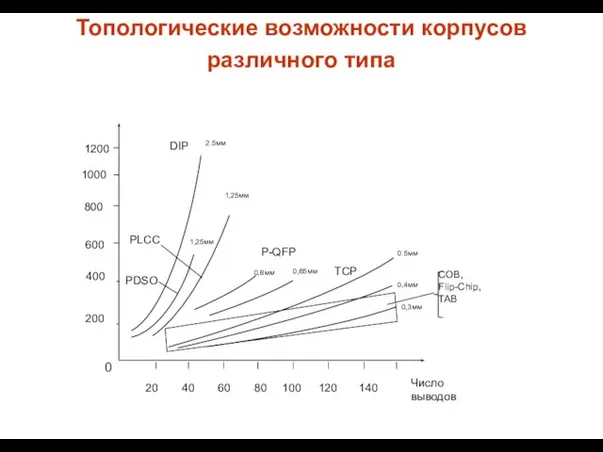

![Этапы развития микрокорпусов BGA [ball grid array] — корпус ИМС с массивом](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/366271/slide-60.jpg)





 Политические режимы
Политические режимы Тройникова Софья автор.
Тройникова Софья автор. Приостановление полномочий судьи и отставки судьи
Приостановление полномочий судьи и отставки судьи Административные правоотношения
Административные правоотношения Экология и культура -будущее России
Экология и культура -будущее России Рынок труда и заработная плата
Рынок труда и заработная плата КОМПЬЮТЕР И ВИДЕОКАМЕРА КАК ИНСТРУМЕНТЫ ОБУЧЕНИЯ ФИЗИКЕ
КОМПЬЮТЕР И ВИДЕОКАМЕРА КАК ИНСТРУМЕНТЫ ОБУЧЕНИЯ ФИЗИКЕ Саба районы Шынар авылы
Саба районы Шынар авылы Презентация на тему Уголовное право. Уголовный процесс
Презентация на тему Уголовное право. Уголовный процесс Новые технологии при тестоведении
Новые технологии при тестоведении ЮГОРСКИЙ ГОСУДАРСТВЕННЫЙУНИВЕРСИТЕТ
ЮГОРСКИЙ ГОСУДАРСТВЕННЫЙУНИВЕРСИТЕТ «Музыка и движение»
«Музыка и движение» ОЦЕНКА КАЧЕСТВА АНАЛЬГЕТИКОВ НЕКОТОРЫХ ПРОИЗВОДИТЕЛЕЙ
ОЦЕНКА КАЧЕСТВА АНАЛЬГЕТИКОВ НЕКОТОРЫХ ПРОИЗВОДИТЕЛЕЙ ДОБРОКАЧЕСТВЕННЫЕ ОПУХОЛИ ЖЕНСКИХ ПОЛОВЫХ ОРГАНОВ (лекция)
ДОБРОКАЧЕСТВЕННЫЕ ОПУХОЛИ ЖЕНСКИХ ПОЛОВЫХ ОРГАНОВ (лекция) Программа курса Семейная фотография
Программа курса Семейная фотография Охрана здоровья и безопасностьИТОГИ 2008 годаОАО «АрселорМиттал Кривой Рог», Украина
Охрана здоровья и безопасностьИТОГИ 2008 годаОАО «АрселорМиттал Кривой Рог», Украина Что такое вредные привычки и каковы причины их возникновения и последствия?
Что такое вредные привычки и каковы причины их возникновения и последствия? Кома
Кома  Презентация на тему Биография и творчество Чингиза Айтматова (1928 – 2008)
Презентация на тему Биография и творчество Чингиза Айтматова (1928 – 2008) Презентация на тему Периметр и площадь прямоугольника
Презентация на тему Периметр и площадь прямоугольника увтро
увтро Economic and Political unification
Economic and Political unification  Авторитет государственной власти
Авторитет государственной власти Провешивание прямой на местности
Провешивание прямой на местности Использование УМК в современной начальной школе. Федеральный перечень учебников
Использование УМК в современной начальной школе. Федеральный перечень учебников proekt_TTU (1)
proekt_TTU (1) Проект.pptx презентация ШЭПР
Проект.pptx презентация ШЭПР Беспроводное устройство управления элементами системы “Умный дом”
Беспроводное устройство управления элементами системы “Умный дом”