Содержание
- 2. Структура тонкопленочных покрытий Количество осаждающихся атомов или молекул n1 и задерживающихся на единице поверхности подложки на
- 5. Скорость образования зародышей Vз зависит от rа и rкр, потока осаждающихся на единицу поверхности в единицу
- 6. при T >T0 при T (n0 - количество отдельных атомов, которое может поместиться на единице площади
- 7. Толщина пленки оказывает существенное влияние на ее свойства, которые могут на порядки отличаться от свойств данного
- 8. Показателем качества тонкопленочных покрытий является неравномерность толщины пленки, которая возникает в результате косинусоидального распределения потока испаряемого
- 9. Согласно закону Кнудсена скорость осаждения (кг/(м2.с)), где q’и – удельная скорость испарения (кг/с), равна: Количество испаряемых
- 10. Dажным фактором обеспечения качества тонкопленочных покрытий является состав и свойства технологической среды – вакуума или рабочих
- 12. Скачать презентацию
Слайд 2Структура тонкопленочных покрытий
Количество осаждающихся атомов или молекул n1 и задерживающихся на единице
Структура тонкопленочных покрытий
Количество осаждающихся атомов или молекул n1 и задерживающихся на единице

Так как температура (энергия) осаждающихся атомов или молекул больше температуры поверхности подложки, то адатомы перемещаются (диффундируют) по поверхности и могут либо покинуть поверхность (десорбировать), либо остаться на ней. Процесс роста тонкой пленки включает в себя несколько стадий (Рис.20): 1) перемещение адатомов по поверхности, их соединение и образование зародышей; 2) укрупнение зародышей за счет захвата новых адатомов; 3) слияние зародышей и образование островков; 4) слияние островков; 5) образование несплошной пленки; 6) образование сплошной пленки.
«Критический радиус зародыша» - минимальное количество адатомов, при котором энергия (температура) десорбции зародыша меньше температуры поверхности подложки:
или
где ra – радиус одного адатома; ps и p - давление насыщенного пара при температуре испарения материала и температуре поверхности подложки T, соответственно; σ - коэффициент поверхностного натяжения (≈1Е-4 Дж/см2); ΔEдис - энергия диссоциации зародыша (≈2Е3 Дж/см3). При приведенных в скобках данных критический радиус зародыша и количество составляющих его атомов приблизительно равны: rкр ≈ 1 нм и nкр ≈ 6-7 шт.
Слайд 5Скорость образования зародышей Vз зависит от rа и rкр, потока осаждающихся на
Скорость образования зародышей Vз зависит от rа и rкр, потока осаждающихся на
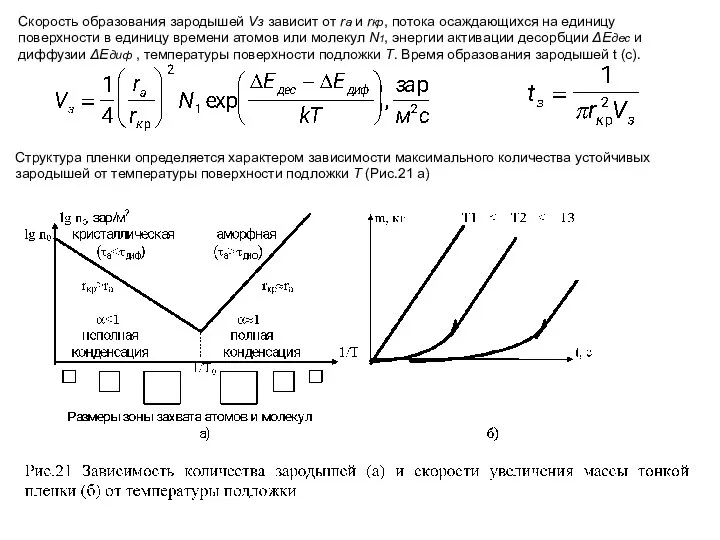
Структура пленки определяется характером зависимости максимального количества устойчивых зародышей от температуры поверхности подложки T (Рис.21 а)
Слайд 6при T >T0
при T< T0
(n0 - количество отдельных атомов, которое
при T >T0
при T< T0
(n0 - количество отдельных атомов, которое
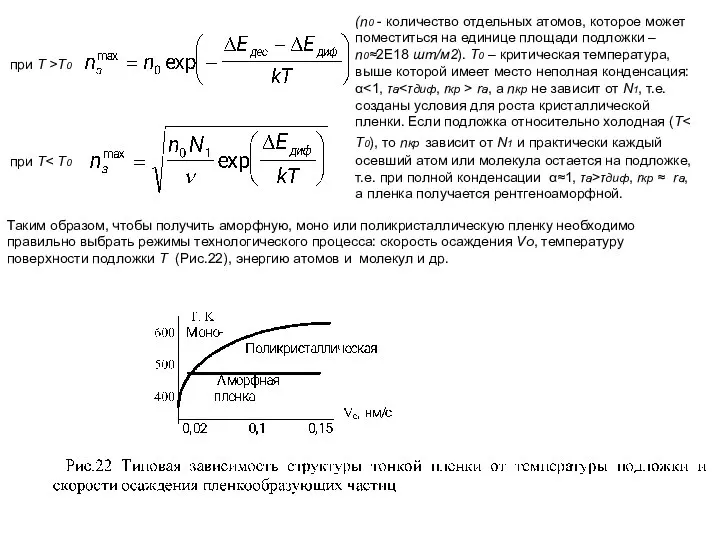
Таким образом, чтобы получить аморфную, моно или поликристаллическую пленку необходимо правильно выбрать режимы технологического процесса: скорость осаждения Vо, температуру поверхности подложки T (Рис.22), энергию атомов и молекул и др.
Слайд 7Толщина пленки оказывает существенное влияние на ее свойства, которые могут на порядки
Толщина пленки оказывает существенное влияние на ее свойства, которые могут на порядки

Сопротивление тонкой пленки R=ρc b/(ha)= ρ• b/a, где a и b – ширина и длина тонкопленочного резистивного элемента, м; ρс в Ом.м и ρ• (“ро квадрат”) в Ом/• являются константами материала, причем ρ• соответствует максимально возможному для данного материала значению удельного сопротивления при h=hmin и равен
Слайд 8Показателем качества тонкопленочных покрытий является неравномерность толщины пленки, которая возникает в результате
Показателем качества тонкопленочных покрытий является неравномерность толщины пленки, которая возникает в результате
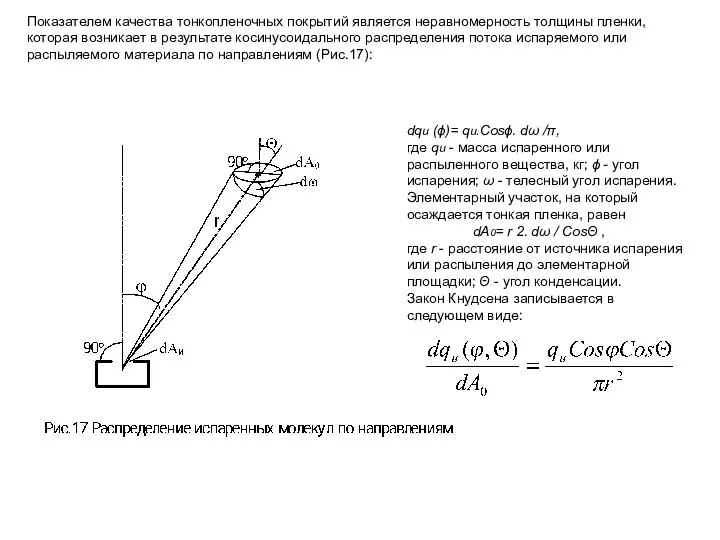
dqи (ϕ)= qи.Cosϕ. dω /π,
где qи - масса испаренного или распыленного вещества, кг; ϕ - угол испарения; ω - телесный угол испарения. Элементарный участок, на который осаждается тонкая пленка, равен
dA0= r 2. dω / CosΘ ,
где r - расстояние от источника испарения или распыления до элементарной площадки; Θ - угол конденсации.
Закон Кнудсена записывается в следующем виде:
Слайд 9Согласно закону Кнудсена скорость осаждения (кг/(м2.с)), где q’и – удельная скорость испарения
Согласно закону Кнудсена скорость осаждения (кг/(м2.с)), где q’и – удельная скорость испарения

Количество испаряемых или распыляемых атомов или молекул осаждающихся на единицу поверхности в единицу времени равно, атом/(м2.с)
Толщину пленки h (м) в произвольной точке подложки δ (Рис.18) можно рассчитать по формуле (l –расстояние от источника до подложки при ϕ=0, ρ-плотность материала).
Неравномерность толщины пленки при точечном испарителе (площадь испарителя пренебрежимо мала)
При испарителе с радиусом rи (Рис.18 в) толщину пленки в точке δ можно рассчитать по следующей формуле (α= 0 - 2π ):
Слайд 10Dажным фактором обеспечения качества тонкопленочных покрытий является состав и свойства технологической среды
Dажным фактором обеспечения качества тонкопленочных покрытий является состав и свойства технологической среды

pi - парциальное давление i-го газа (“загрязнения”),Па; αi - коэффициент аккомодации i-го газа (“загрязнения”); T - температура стенок вакуумной камеры, К; Mi - молекулярная масса i-го газа (“загрязнения”), кг/кмоль; Vо - скорость осаждения пленки, кг/(м2.с) (Vо’ в нм/с); Mм - молекулярная масса материала пленки, кг/кмоль.
При нормальном законе распределения γ вероятность обеспечения требуемой чистоты осаждаемой пленки равна
Математическое ожидание коэффициента загрязнения осаждаемой пленки равно
Допустимый коэффициент “загрязнения” пленки γ∂ можно оценить следующим неравенством: где n∂ - допустимая концентрация загрязнений в материале пленки (1Е12 – 1Е20 атом/см3); h - толщина пленки, м; t - длительность процесса осаждения пленки, с; среднее квадратичное отклонение коэффициента загрязнения пленки σγ зависит от: σx - среднее квадратичное отклонение параметра xj, k - количество параметров x, влияющих на чистоту технологической среды (в скобках – частные производные)

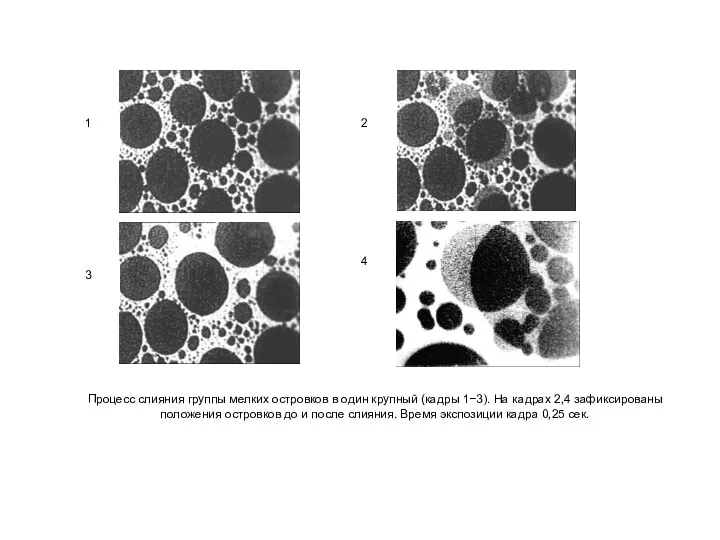
 Siła i ruch
Siła i ruch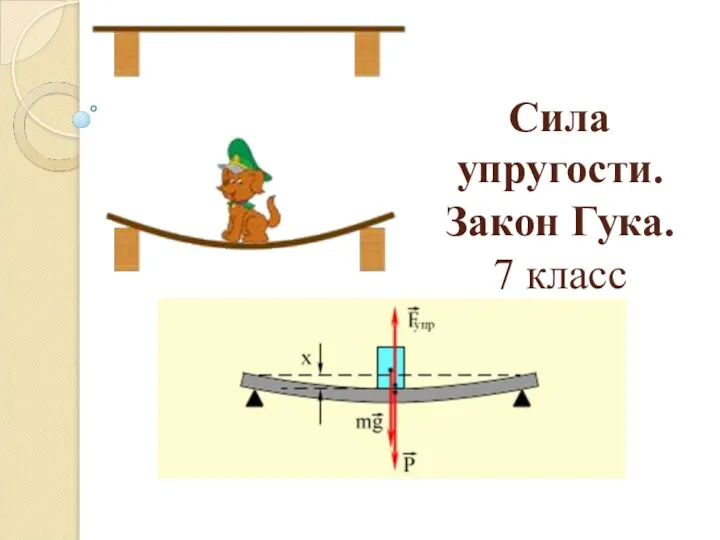 Сила упругости. Закон Гука. 7 класс
Сила упругости. Закон Гука. 7 класс Единая физическая картина мира
Единая физическая картина мира Презентация на тему Никола Тесла
Презентация на тему Никола Тесла  Типовые ошибки в курсовых работах. Примеры экзаменационных задач
Типовые ошибки в курсовых работах. Примеры экзаменационных задач Паровые машины. (8 класс)
Паровые машины. (8 класс) Важный раздел механики: Колебания и волны
Важный раздел механики: Колебания и волны Виды излучений. Источники света
Виды излучений. Источники света Материалы, используемые в конструкциях космических аппаратов
Материалы, используемые в конструкциях космических аппаратов Устройство карданной передачи, разработка технологической карты
Устройство карданной передачи, разработка технологической карты Тёмная материя и космология
Тёмная материя и космология Атмосферное давление
Атмосферное давление Элементы теории фредгольмовых отображений
Элементы теории фредгольмовых отображений Строение атома
Строение атома Определение технического состояния системы питания дизельных двигателей
Определение технического состояния системы питания дизельных двигателей Электрическое поле
Электрическое поле Упругая и пластическая деформация. Практика 2
Упругая и пластическая деформация. Практика 2 Современное состояние прецизионной кварцевой стабилизации частоты применительно к задачам частотно-временного обеспечения
Современное состояние прецизионной кварцевой стабилизации частоты применительно к задачам частотно-временного обеспечения Физический океан
Физический океан Моделирование термодинамических ансамблей
Моделирование термодинамических ансамблей Виды теплопередачи
Виды теплопередачи Электрический ток. Сила тока. Закон Ома. Сопротивление
Электрический ток. Сила тока. Закон Ома. Сопротивление Презентация на тему Строение и свойства вещества
Презентация на тему Строение и свойства вещества  Контрольная работа по теме МКТ
Контрольная работа по теме МКТ Расчёт пути и времени движения. Физика, 7 класс
Расчёт пути и времени движения. Физика, 7 класс Задачи
Задачи Решения задач по теме Механическое движение, 9 класс
Решения задач по теме Механическое движение, 9 класс Плавание судов. Воздухоплавание
Плавание судов. Воздухоплавание