Содержание
- 2. Емкость DRAM и размер элементов МОП-ПТ. Прогноз Ассоциации Полупроводниковой Промышленности (Semiconductor Industry Association – SIA) Пути
- 3. ТРАДИЦИОННАЯ ТЕХНОЛОГИЯ ЛЕГИРОВАНИЯ 1. Низкоэнергетическая ионная имплантация Влияние эффекта каналирования на профили бора Проблемы: эффект каналирования
- 4. ТРАДИЦИОННАЯ ТЕХНОЛОГИЯ ЛЕГИРОВАНИЯ 2. Термообработка Проблемы: неравновесная ускоренная диффузия примеси; компромисс между максимальной степенью активации примеси,
- 5. НЕРАВНОВЕСНАЯ УСКОРЕННАЯ ДИФФУЗИЯ Основные характеристики НУД: 1) Диффузионная способность легирующей примеси может быть в 102 –106
- 6. ДЕФЕКТЫ СТРУКТУРЫ Отжиг неаморфизованного слоя I-V-пары –> кластеры дефектов (междоузельного типа) –> {311}-дефекты –> СМА. Время
- 7. 1. Скорость набора дозы Увеличение генерации дефектов, что позволяет получать аморфные слои при меньших дозах имплантации.
- 8. 4. Сверхбыстрый нагрев при БТО Получают переходы с меньшей глубиной залегания и меньшим количеством дефектов. Причина
- 9. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Электронные микрофотографии кремния, имплантированного ионами В+
- 10. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Изменение периода решетки Δа в имплантированном кремнии в зависимости от плотности тока ионов Jэф.:
- 11. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Доля атомов углерода в узлах решетки кремния в зависимости от плотности ионного тока
- 12. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Восстановление периода решетки в кремнии, имплантированном ионами В+ 1 – Si:P, ρ0= 0,5 Ом·см;
- 13. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ
- 14. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ
- 15. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ
- 16. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ
- 17. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ
- 18. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Электрическая активация имплантированных атомов бора (1, 2) и фосфора (3, 4); 2, 4 –
- 19. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Движение атома Si в кремнии в поле упругих деформаций, создаваемых примесью замещения
- 20. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ
- 21. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Зависимость коэффициента усиления горизонтальных транзисторов от напряжения на базе для опытной (3 шага) и
- 22. ДЕФЕКТО-ПРИМЕСНАЯ ИНЖЕНЕРИЯ Обратная ветвь вольт-амперной характеристики входных планарных диодов на опытной (3 шага) и текущей (1
- 23. Имплантация: ионы Sb+: 60 кэВ, 1.25×1014 см-2; ионы P+: 20 кэВ, 8.13×1014 см-2. Отжиг: 550 °С,
- 24. ИСПОЛЬЗОВАНИЕ ДОПОЛНИТЕЛЬНЫХ РЕЖИМОВ ТЕРМООБРАБОТКИ ФОРМИРОВАНИЕ МЕЛКОЗАЛЕГАЮЩИХ p+-n – ПЕРЕХОДОВ В КРЕМНИИ Профили электрически активного бора в
- 25. ИСПОЛЬЗОВАНИЕ СОВМЕСТНОЙ С ИОНАМИ BF2+ ИМПЛАНТАЦИИ ИОНОВ УГЛЕРОДА Профили электрически активного бора в p+-n переходах. Имплантация:
- 26. ИСПОЛЬЗОВАНИЕ СОВМЕСТНОЙ С ИОНАМИ BF2+ ИМПЛАНТАЦИИ ИОНОВ УГЛЕРОДА Значения слоевого сопротивления и слоевой концентрации в p+-n
- 27. ИСПОЛЬЗОВАНИЕ СОВМЕСТНОЙ С ИОНАМИ BF2+ ИМПЛАНТАЦИИ ИОНОВ УГЛЕРОДА Светлопольные микрофотографии структуры кремния. Имплантация ионов BF2+ (20
- 29. Скачать презентацию
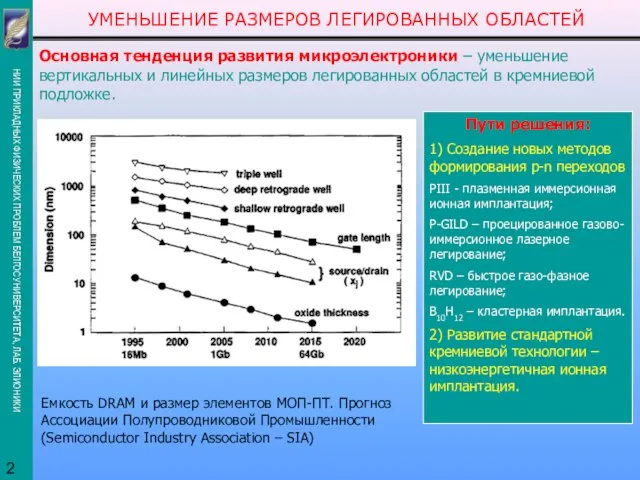






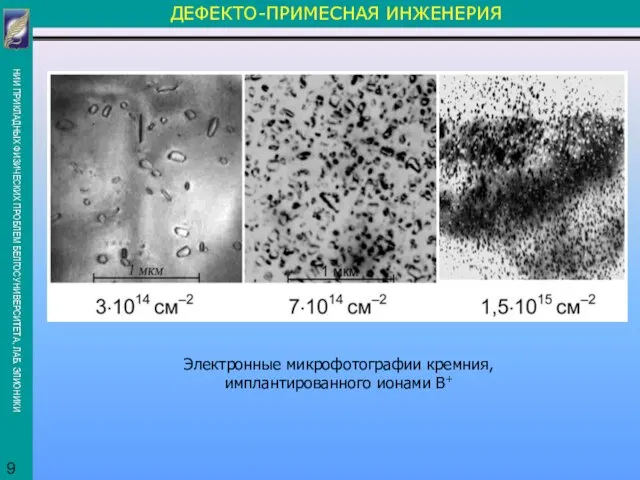




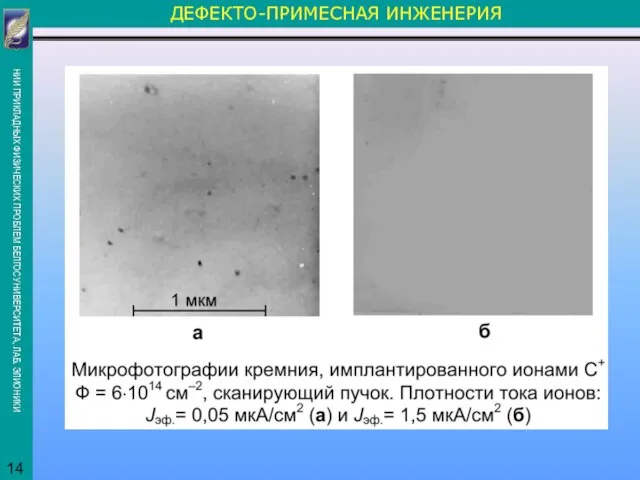








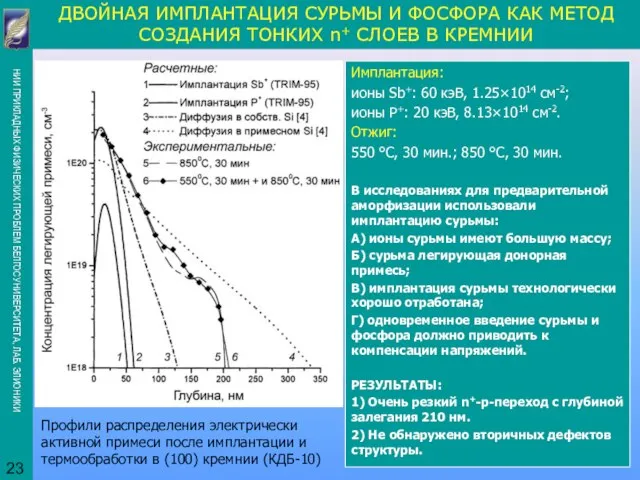
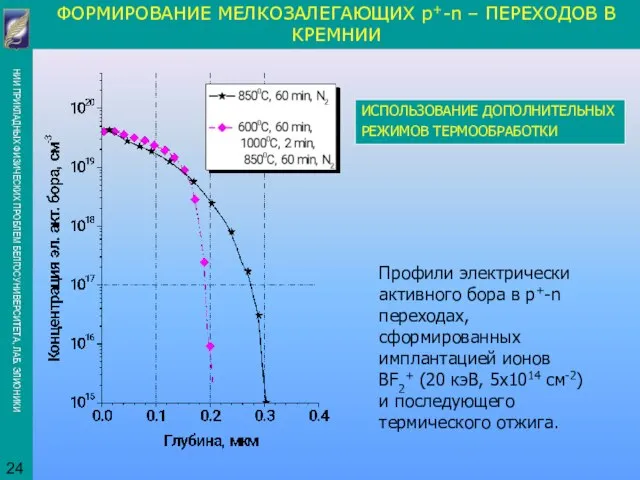
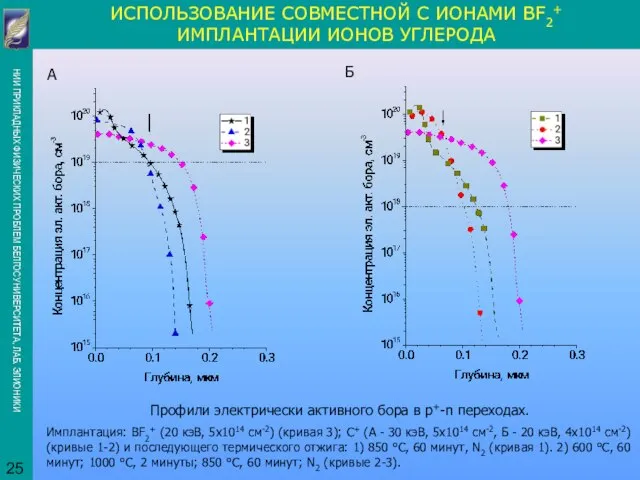

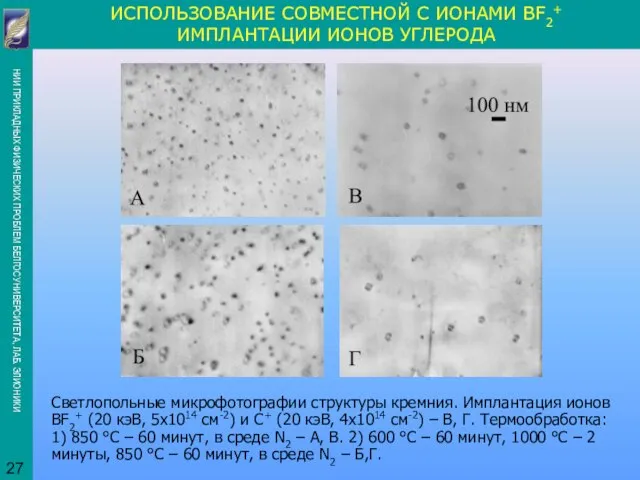
 Роль физической культуры и спорта в нашей жизни
Роль физической культуры и спорта в нашей жизни Джеймс Олдридж
Джеймс Олдридж Соли аммония
Соли аммония Романовская игрушка
Романовская игрушка Построение автоматов
Построение автоматов Перевозка детей на воздушном транспорте
Перевозка детей на воздушном транспорте 1 Художній твір як явище мистецтва, новий ірреальний
1 Художній твір як явище мистецтва, новий ірреальний Сопровождение региональных инновационных площадок в 2022 году
Сопровождение региональных инновационных площадок в 2022 году Структура книги
Структура книги Котёл низкого давления
Котёл низкого давления Оставьте цветы весне
Оставьте цветы весне Презентация на тему Стресс, стрессовое состояние
Презентация на тему Стресс, стрессовое состояние  Актуальность, проблемы и перспективы развития профессионального признания в России Владивосток 2011
Актуальность, проблемы и перспективы развития профессионального признания в России Владивосток 2011 СИЛА ТОКА Кл t А q ЗАРЯД Дж U U q НАПРЯЖЕНИЕ А I I t РАБОТА с А q t ВРЕМЯ В q.
СИЛА ТОКА Кл t А q ЗАРЯД Дж U U q НАПРЯЖЕНИЕ А I I t РАБОТА с А q t ВРЕМЯ В q. Обязательства и ответственность по правам человека
Обязательства и ответственность по правам человека Учебные вопросы: Техника скоростной записи слов и предложений. Применение цветных ручек и карандашей при конспектировании
Учебные вопросы: Техника скоростной записи слов и предложений. Применение цветных ручек и карандашей при конспектировании Упражнения для мышц брюшного пресса (юноши)
Упражнения для мышц брюшного пресса (юноши) Вычисление площади криволинейной трапеции
Вычисление площади криволинейной трапеции Машиностроительное черчение
Машиностроительное черчение Хакасия – моя Родина!
Хакасия – моя Родина! Презентация на тему Как вести себя во время теракта
Презентация на тему Как вести себя во время теракта Мониторинг Active Session History c использованием ASH Viewer
Мониторинг Active Session History c использованием ASH Viewer История моды 20 века
История моды 20 века Союз поисковых отрядов
Союз поисковых отрядов Промоакции и их роль в продвижении товаров
Промоакции и их роль в продвижении товаров Christmas what are they doing fun
Christmas what are they doing fun Олимпийские игры
Олимпийские игры Как правильно передвигаться по загородной дороге?
Как правильно передвигаться по загородной дороге?