TCAD моделирование характеристик кремниевых и кремний-германиевых биполярных транзисторов с учетом радиационных эффектов
Содержание
- 2. Актуальность Для проектирования схем спец. применений, в существующие промышленные САПР встраиваются специальные подсистемы САПР: RHCAD –
- 3. Современное состояние проблемы для Si БТ и SiGe ГБТ Sentaurus Synopsys Silvaco TCAD Механизм учета ионизационных
- 4. Модели основных физических эффектов системы Synopsys Sentaurus
- 5. Взаимодействие гамма-квантов с атомами п/п S Nit Qox Ионизационные эффекты Основные деградирующие параметры Положительный заряд в
- 6. Математическая модель Si БТ и SiGe ГБТ, учитывающая влияние гамма-излучения Преимущества по сравнению с ранее существующими
- 7. Модель, учитывающая влияние гамма-излучения в структурах Si БТ и SiGe ГБТ, Наиболее чувствительные области Зависимости Nit
- 8. Результаты моделирования влияния гамма-излучения в системе TCAD ВАХ 0,13 мкм SiGe ГБТ 8WL с параметрами: β
- 9. τ II. Математическая модель Si БТ и SiGe ГБТ, учитывающая влияние нейтронного излучения μ N Образование
- 10. II. Математическая модель Si БТ и SiGe ГБТ, учитывающая влияние нейтронного излучения Зависимость времени жизни носителей
- 11. Для n-типа материала: Для p-типа материала: II. Математическая модель Si БТ и SiGe ГБТ, учитывающая влияние
- 12. II. Результаты расчетов по модели, учитывающей влияние нейтронного излучения в структурах Si БТ и SiGe ГБТ
- 13. III. Модель, учитывающая влияние протонного излучения на структуры Si БТ и SiGe ГБТ Факторы повреждения Ионизационные
- 14. III. Модель, учитывающая влияние протонного излучения на структуры Si БТ и SiGe ГБТ В системе TCAD
- 15. III. Модель, учитывающая влияние протонного излучения на структуры Si БТ и SiGe ГБТ Используется комбинация моделей
- 16. III. Расчет характеристик с помощью модели, учитывающей влияние протонного излучения на Si БТ и SiGe ГБТ
- 17. , 1) Разработаны приборно-технологические модели для расчета электрофизических и электрических характеристик Si БТ и SiGe ГБТ
- 18. Спасибо за внимание!
- 19. Результаты измерения SiGe ГБТ SGB25V до и после облучения
- 21. Скачать презентацию



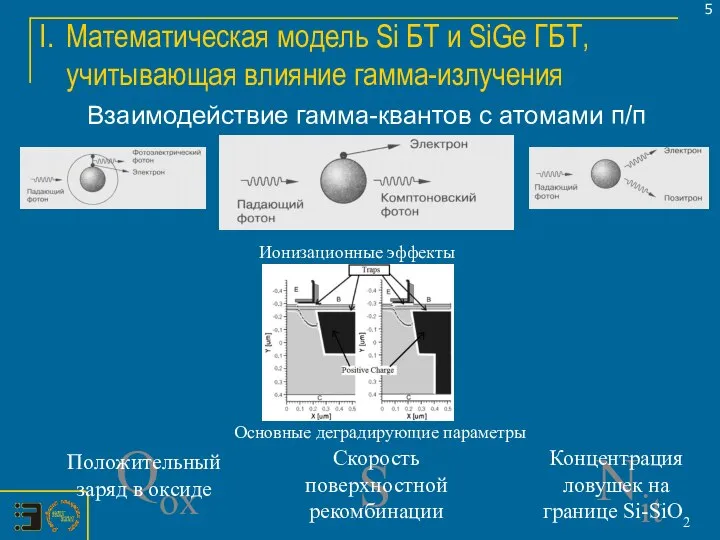
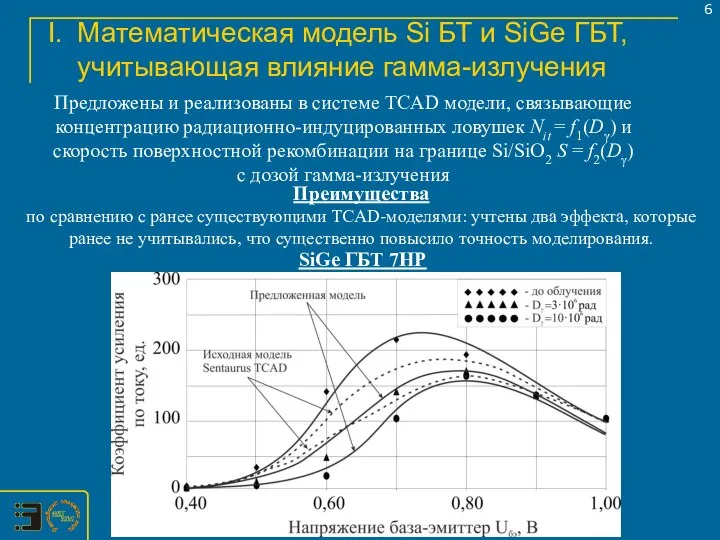
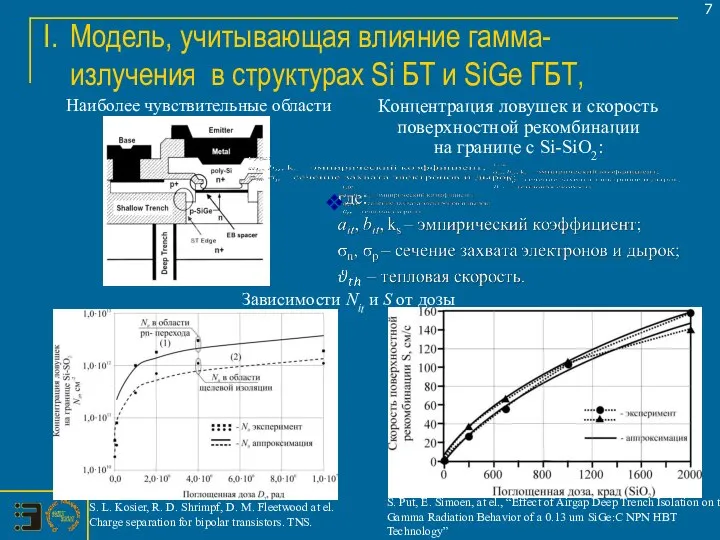
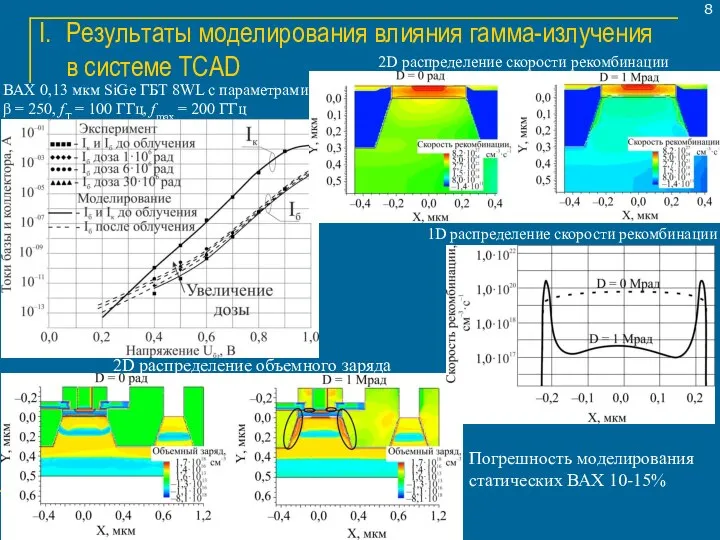



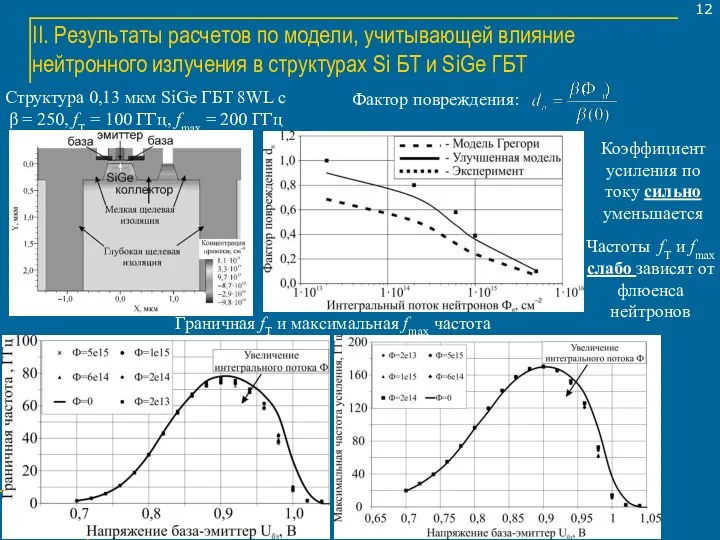


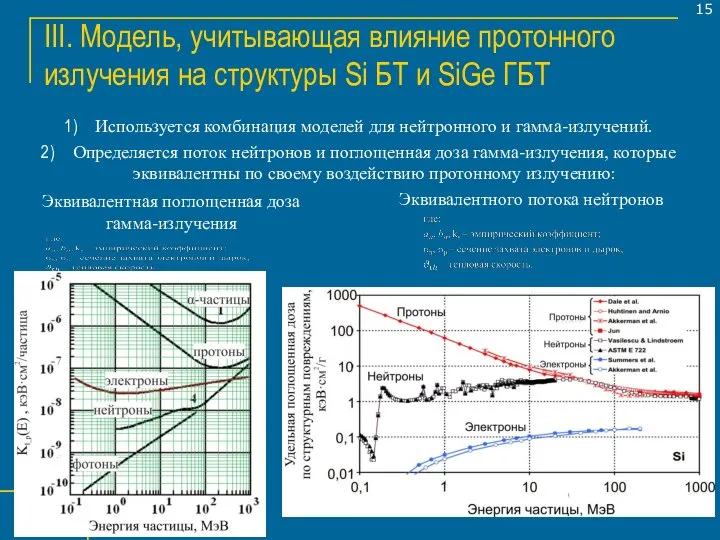
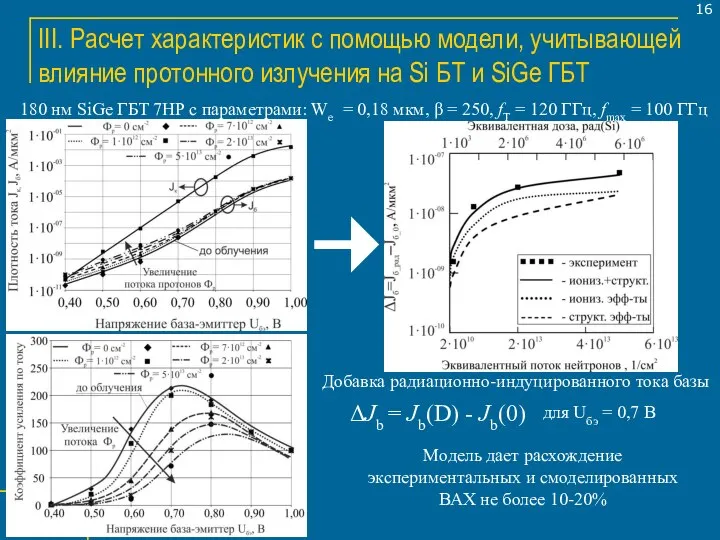


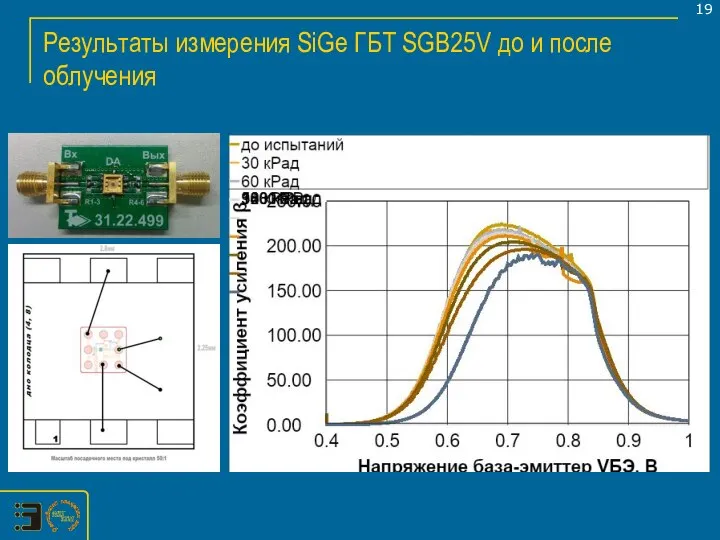
 Прикладные исследования и МЛУ-ТБ
Прикладные исследования и МЛУ-ТБ Освоение и использование учащимися УУД. Ресурсы педагогической деятельности. Мониторинг уровня сформированности УУД.
Освоение и использование учащимися УУД. Ресурсы педагогической деятельности. Мониторинг уровня сформированности УУД. Процесс разложения органических азотистых соединений
Процесс разложения органических азотистых соединений  Оплата труда. Охрана труда
Оплата труда. Охрана труда Промежуточный отчет
Промежуточный отчет Использование ИКТ на уроках биологии в целях повышения качества знаний обучающихся
Использование ИКТ на уроках биологии в целях повышения качества знаний обучающихся Организационная структура вооруженных сил РФ
Организационная структура вооруженных сил РФ Автоматизация процесса сепарации попутного нефтяного газа
Автоматизация процесса сепарации попутного нефтяного газа 1 Тестирование производительности веб–приложений: Как перестать беспокоиться и начать делать ЭТО Тимур Хайруллин Организатор.
1 Тестирование производительности веб–приложений: Как перестать беспокоиться и начать делать ЭТО Тимур Хайруллин Организатор. Психологическая практика ЦНО
Психологическая практика ЦНО Влияние музыки на детей
Влияние музыки на детей Презентация на тему Убийца со множеством имен - ГРИПП
Презентация на тему Убийца со множеством имен - ГРИПП Рефлексия цикла ОУП 2020-2021. Воспроизводство и проектирование цикла ОУП 2021-2022
Рефлексия цикла ОУП 2020-2021. Воспроизводство и проектирование цикла ОУП 2021-2022 Презентация на тему Игрушки наших предков
Презентация на тему Игрушки наших предков  Ураганы
Ураганы Презентация на тему «Русская культура в конце 19 начала 20 века»
Презентация на тему «Русская культура в конце 19 начала 20 века» Өнеркәсіп саласының негізгі көрсеткіштері
Өнеркәсіп саласының негізгі көрсеткіштері Управление и менеджмент
Управление и менеджмент ТЕСТИРОВАНИЕ
ТЕСТИРОВАНИЕ Automotive Industry. Основы теории бережливого производства
Automotive Industry. Основы теории бережливого производства Летний оздоровительный отдых учащихся МОУ СОШ 6 Пришкольный оздоровительный лагерь дневного прибывания (с 1 по 22 июня 2006 г. ) 100 дете
Летний оздоровительный отдых учащихся МОУ СОШ 6 Пришкольный оздоровительный лагерь дневного прибывания (с 1 по 22 июня 2006 г. ) 100 дете Отличие управления персоналом от управления человеческими ресурсами
Отличие управления персоналом от управления человеческими ресурсами Ангиография
Ангиография Война и мир Толстого
Война и мир Толстого «Огонь – друг, огонь – враг»
«Огонь – друг, огонь – враг» f_066630fa0a76b92a
f_066630fa0a76b92a Чайный клуб Гармония. Меню. Чаи и аксессуары
Чайный клуб Гармония. Меню. Чаи и аксессуары Содоклад заместителя председателя Правительства Пермского края Цветова В.Ю. «Об итогах социально-экономического развития Осинск
Содоклад заместителя председателя Правительства Пермского края Цветова В.Ю. «Об итогах социально-экономического развития Осинск