ВЛИЯНИЕ ИМПЛАНТАЦИИ ИОНОВ ФОСФОРА НА СТРУКТУРНЫЕ ИЗМЕНЕНИЯ В ПОВЕРХНОСТНЫХ СЛОЯХ МОНОКРИСТАЛЛА КРЕМНИЯ
Содержание
- 2. Цель работы Исследование структурных изменений в приповерхностных слоях монокристаллов Si после имплантации ионов фосфора. Энергия имплантованных
- 3. Для реализации цели: Использовано методы рентгеновской топографии и двухкристального спектрометра; Использовано численные методы решения системы дифференциальных
- 4. 1 исходная 2 имплантация Образец кремния схематично Исходная область Ионная имплантация: фосфор (Е=180кеВ, D=8·1014cм-2)
- 5. КОСОНЕСИММЕТРИЧНАЯ ДИФРАКЦИИ В ГЕОМЕТРИИ НА ОТРАЖЕНИЕ И – источник рентг. излучения Щ – щель П –
- 6. Топография монокристалов Si а) Lext=2,1мкм б) Lext=1,05мкм в) Lext=0,75мкм Х-лучевые топограмы монокристала Si: CuKα-излучение, входящая плоскость
- 7. Атомно-силовая микроскопия образца Si б) а) Объёмное изображение микрорельефа поверхности образца Si а) исходная область б)
- 8. Схема трехосного рентгеновского дифрактометра Високоразрешающий трехосный рентгеновский дифрактометр PANalytical X’Pert MRD PRO. используется для измерения кривых
- 9. Кривые дифракционного отражения монокристалла Si -800 -600 -400 -200 0 200 400 600 800 ∆θ lg(I/I0)
- 10. Кривые дифракционного отражения монокристалла Si: сопоставление теоретической и экспериментальных кривых -600 -400 -200 0 200 400
- 12. Скачать презентацию





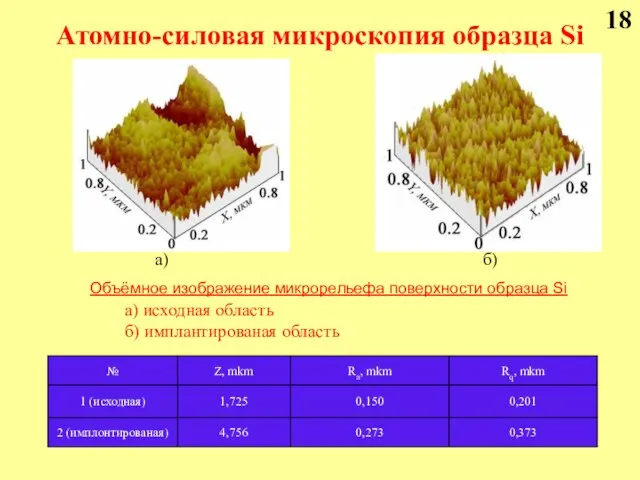
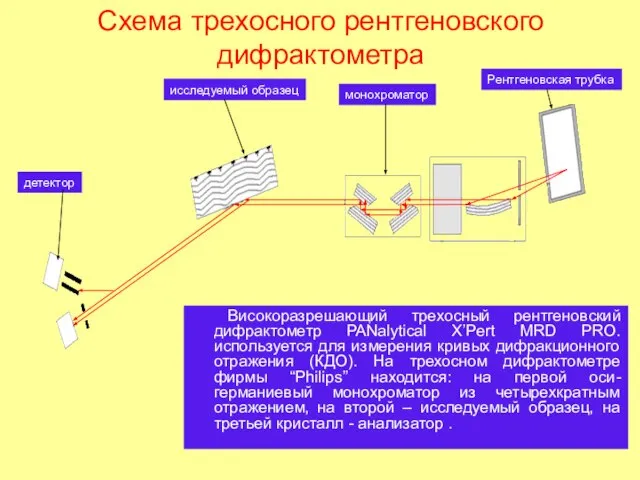


 Презентация на тему Have got
Презентация на тему Have got Процесс разработки ПО
Процесс разработки ПО Операционный рычаг и операционный анализ
Операционный рычаг и операционный анализ Профессия юрист
Профессия юрист PR-проект «Возьми за правило творить чудо»
PR-проект «Возьми за правило творить чудо» Why do people like travelling ?
Why do people like travelling ? Разработка нового типа оборудования для ранней диагностики рака молочной железы у женщин репродуктивного возраста.
Разработка нового типа оборудования для ранней диагностики рака молочной железы у женщин репродуктивного возраста. Сотворение первобытного искусства и его характер
Сотворение первобытного искусства и его характер Сертификация в авто
Сертификация в авто Информация. Виды и свойства
Информация. Виды и свойства Бизнес-план. Состав разделов практика бизнес-плана
Бизнес-план. Состав разделов практика бизнес-плана Презентация на тему Альтернативные источники электроэнергии
Презентация на тему Альтернативные источники электроэнергии  Сервировка чайного стола
Сервировка чайного стола Сеньоры и вассалы
Сеньоры и вассалы Презентация на тему День победы классный час
Презентация на тему День победы классный час Песец
Песец Империя инков
Империя инков Магазин ООО Тринити-К
Магазин ООО Тринити-К Презентация на тему Словосочетание
Презентация на тему Словосочетание  Программное обеспечение компьютера
Программное обеспечение компьютера Поможем птицам
Поможем птицам Анализ отрасли образования
Анализ отрасли образования Как сделать карьеру в маркетинге
Как сделать карьеру в маркетинге Helen Beatrix Potter
Helen Beatrix Potter Энергосбережение в наших домах
Энергосбережение в наших домах Изменения законодательства в сфере обращения с отходами I и II классов опасности
Изменения законодательства в сфере обращения с отходами I и II классов опасности Дети с тяжелыми нарушениями речи
Дети с тяжелыми нарушениями речи Конституционное (государственное) право
Конституционное (государственное) право