Содержание
- 2. Вопросы к экзамену Алгоритм струны в моделировании травления и осаждения слоев. Расчет процесса травления для заданного
- 3. Минимальные воспроизводимые размеры и многие проектные нормы определяются в первую очередь процессами травления. Профиль травления и
- 4. Выбор моделей травления/осаждения Следует учитывать трудоемкость процесса разработки высокоточных моделей и программных средств, а также самого
- 5. Примеры различных типов моделей.
- 6. Особенности использования геометрических алгоритмов Геометрические модели не учитывают суть происходящих физических и химических процессов, особенности формы
- 7. Примеры моделирования процессов травления/осаждения Изотропное травление Анизотропное травление
- 8. Примеры моделирования процессов травления/осаждения Изотропное осаждение Анизотропное осаждение и планаризация
- 9. Алгоритм струны В моделях травления/осаждения используется геометрический принцип преобразования толщин слоев в зависимости от локально рассчитываемых
- 10. Алгоритм струны (продолжение) Результирующий профиль обработанной поверхности определяется положением первоначального профиля, который двигается через среду с
- 11. Схема расчета элементарных продвижений точек закрепления струны изотропное травление di = V0 ∙ Δ t. анизотропное
- 12. Расчет результирующего перемещения изотропное травление di = V0 ∙ Δ t. анизотропное травление d = Vn∙cos[(θ1
- 13. Расчет результирующего перемещения показатель анизотропии VY/ VX = 3 d1-3 = V0 ∙ Δ t +
- 14. Точность алгоритма продвижения струны Зависит от дискретности представления границы раздела, т.е. от длины сегментов струны В
- 15. Алгоритм продвижения струны в присутствии маски Маска Подложка Изотропное травление
- 16. Преобразования струны с добавлением новой точки Новая точка Новая точка вводится путем деления пополам угла, образованного
- 17. Сужение углов между сегментами Требуется уменьшение сегментов и удаление лишних точек сжатие элементов струны образование петли
- 18. Образование областей затенения Скорость травления точек, которые затенены другими отрезками, принимается равной фоновой изотропной скорости травления.
- 19. Выделение участков затенения Области затенения определяются путем сравнения координат точек (xi, yi) с вертикальными направляющими, проходящими
- 20. Обобщенная геометрическая модель травления В самом общем случае может быть промоделирован процесс, включающий несколько составляющих скорости
- 21. Результаты моделирования Травление, задаваемое параметрами A0 = -30, A1 =150, A2 = -30;
- 22. Моделирование фотолитографии
- 23. Цель моделирования фотолитографии получение расчетного профиля резистивной пленки по краю прорисовки как результата экспонирования и проявления
- 24. Основные этапы численного моделирования фотолитографии расчет распределения интенсивности света, падающего на поверхность резистивной пленки, или фронтального
- 25. Расчет изображения на поверхности фоторезиста Распределение интенсивности света на поверхности фоторезиста, называемое также фронтальным изображением, зависит
- 26. Распределение освещенности в плоскости фоторезиста В идеальном случае интенсивность света должна быть нулевой внутри темных полей
- 27. Распределение освещенности в плоскости фоторезиста в случае точечного источника Если размеры источника света очень малы, и
- 28. Распределение освещенности в плоскости фоторезиста для протяженного источника Если источник света из-за конечности его линейных размеров
- 29. дифракционные максимумы, которые уменьшаются при увеличении размера источника света; область полутени, которая увеличивается при увеличении размера
- 30. Формирование изображения на поверхности фоторезиста метод проекционной печати метод контактной с зазором печати
- 31. Параметры, характеризующие маску Маски амплитудного типа характеризуются функцией пропускания интенсивности T(x, y), такой, что интенсивность освещения,
- 32. Параметры, характеризующие маску В результате рассеяния на маске каждой из падающих плоских волн образуется спектр когерентных
- 33. Полная интенсивность I0 уменьшается с глубиной в результате поглощения света резистивным материалом Отражение света от подложки
- 34. Физические и химические факторы, учитываемые при расчете распределения интенсивности по глубине интенсивность освещения на поверхности резистивной
- 35. Моделирование нестационарного процесса отбеливания материала резиста При моделировании процесса отбеливания позитивного фоторезиста считается, что он имеет
- 36. Схема алгоритма анализа прохождения света в тонких пленках Расчет пропускания и отражения проводится на каждой границе
- 37. Пример расчетных кривых для распределения интенсивности света в пленке фоторезиста Расчетные распределения интенсивности света (сплошная линия)
- 38. Моделирование процесса проявления Для выполнения расчета профиля резистивной пленки после проявления необходимо задать распределение локальной скорости
- 39. Скорость травления химически однородных резистов 1/R(M) = (1-M∙P)/R1 + M∙P/R2 , или R1 и R2 –
- 40. Полиномиальная аппроксимация скорости травления R(M) = exp(E1 + E2∙M + E3∙M2). При использовании таких эмпирических выражений
- 41. Типичный профиль края линии в фоторезисте Расчет процесса проявления методом продвижения струны начинается с поверхности резиста.
- 43. Скачать презентацию

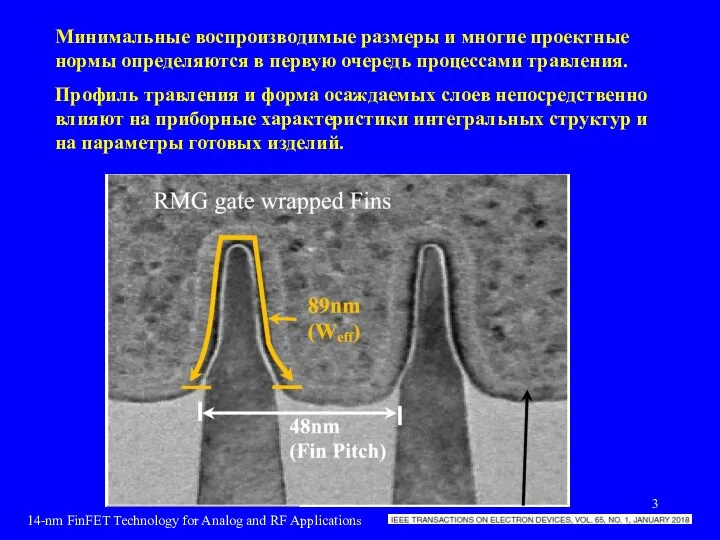



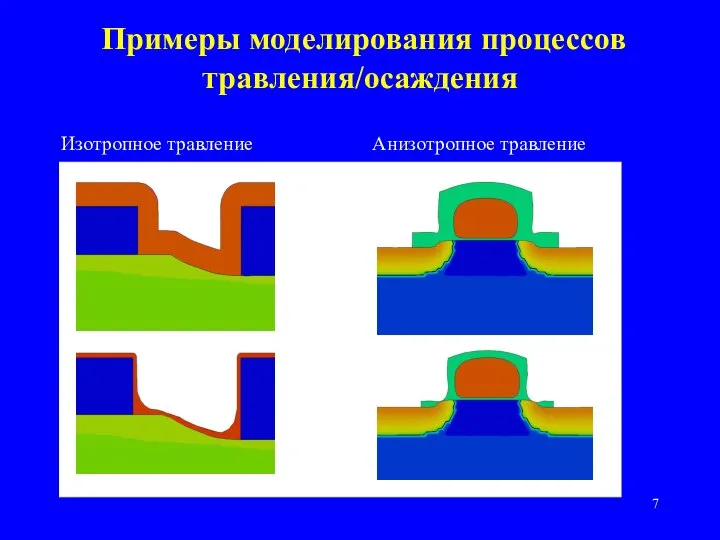
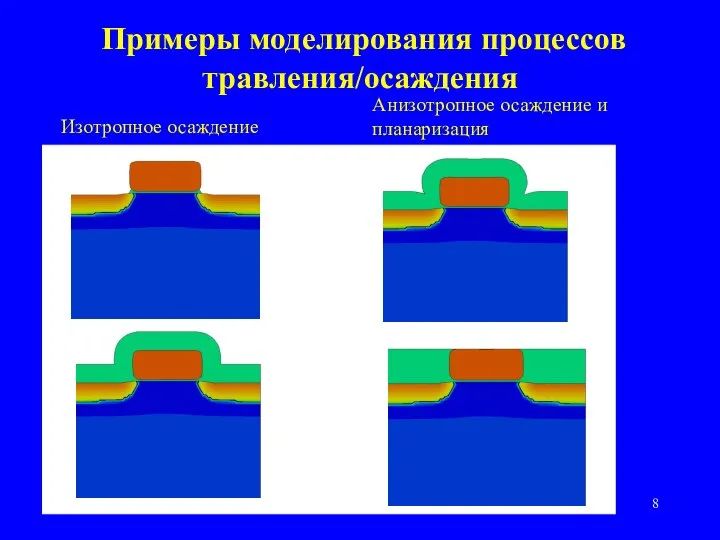




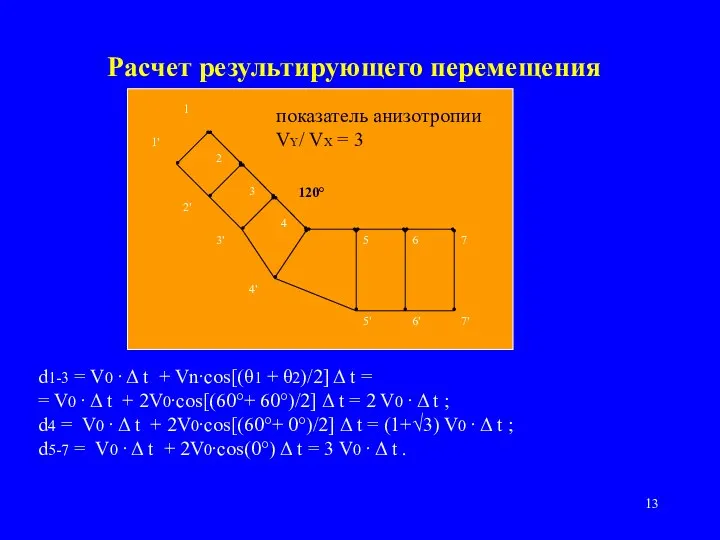







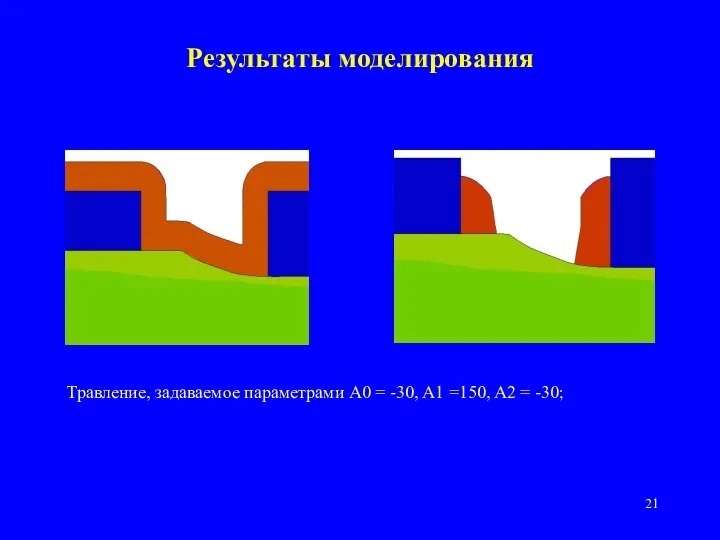



















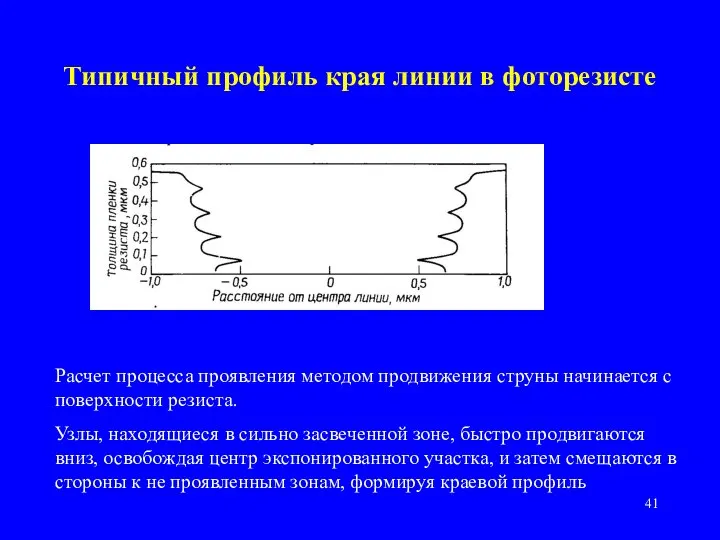
 Программное обеспечение компьютера. Мини - диктант. 8 класс
Программное обеспечение компьютера. Мини - диктант. 8 класс Программирование линейных алгоритмов
Программирование линейных алгоритмов Медиация в моей жизни
Медиация в моей жизни Продвижение учреждения дополнительного образования в социальных сетях
Продвижение учреждения дополнительного образования в социальных сетях Установка программного обеспечения и прошивки
Установка программного обеспечения и прошивки База данных
База данных Написание программы
Написание программы Модернизация ИТ-инфраструктуры
Модернизация ИТ-инфраструктуры Презентация на тему Биты и байты
Презентация на тему Биты и байты  10u-8_С -I_функции
10u-8_С -I_функции Средства анализа и визуализации данных. Обработка числовой информации в электронных таблицах
Средства анализа и визуализации данных. Обработка числовой информации в электронных таблицах Языки. Системы и среды программирования. Основные понятия языка Паскаль. Типы данных
Языки. Системы и среды программирования. Основные понятия языка Паскаль. Типы данных Базовые классы Java
Базовые классы Java Научные электронные библиотеки
Научные электронные библиотеки Презентация на тему Характеристики процессора и оперативной памяти
Презентация на тему Характеристики процессора и оперативной памяти  HTML+CSS. Весенняя композиция. Урок 6
HTML+CSS. Весенняя композиция. Урок 6 ТЗ сайту Зрозуміло
ТЗ сайту Зрозуміло Мой Первый Код” - бесплатное игровое программирование
Мой Первый Код” - бесплатное игровое программирование Вход в АПС Личный кабинет
Вход в АПС Личный кабинет Структура новостей
Структура новостей Безопасность в интернете
Безопасность в интернете Операционная система MacOS
Операционная система MacOS Интернет-предпринимательство. Как собрать и мотивировать команду стартапа
Интернет-предпринимательство. Как собрать и мотивировать команду стартапа Системы объектов
Системы объектов Вася на Сене
Вася на Сене Обращение. Урок в 7 классе
Обращение. Урок в 7 классе Компьютерные презентации
Компьютерные презентации Fakty z chuseok
Fakty z chuseok