ФОРМИРОВАНИЕ ВОДОРОДНО-ИНДУЦИРОВАННЫХ ДЕФЕКТОВ И ИХ ПРИМЕНЕНИЕ В ТЕХНОЛОГИЯХ МИКРО- И ОПТОЭЛЕКТРОНИКИ
Содержание
- 2. Создание структур кремний-на-изоляторе Перспективность использования структур кремний-на-изоляторе (КНИ) в микроэлектронике Использование для построения аппаратуры с высокой
- 3. Формирование КНИ-пластин методом smart-cut 1. Отбор пластин {100} КДБ - 12 ЕТО.035.206ТУ отклонение от плоскостности прогиб
- 4. 4. Очистка поверхностей и соединение пластин Комбинированный метод подготовки гидрофильных поверхностей пластин - сочетание процедур плазменной
- 5. Рисунок 1 — ПЭМ фотографии дефектного слоя после имплантации ионов водорода (А) и отжига при 450
- 6. Формирование КНИ-структур Формирование КНИ-пластин методом smart-cut Рисунок 3 — Светлопольное ПЭМ – изображение структуры поперечного сечения
- 7. Формирование КНИ-структур Формирование КНИ-пластин методом smart-cut Рисунок 4 — Случайные и каналированные спектры РОР от КНИ-пластин:
- 8. Формирование КНИ-структур Формирование КНИ-пластин методом smart-cut Рисунок 5 — Топография и профили шероховатости поверхности КНИ-пластины (метод
- 9. Применение КНИ структур Объемный кремний Тонкопленочная КНИ структура Рисунок 6 — Использование КНИ структур позволяет упростить
- 10. Применение КНИ структур Объемный кремний Тонкопленочная КНИ-структура Рисунок 7 — Уменьшение паразитных емкостей При использовании КНИ
- 11. Применение КНИ структур Рисунок 8 — Формирование трека при попадании энергетической частицы Высокая радиационная стойкость КНИ
- 12. Применение КНИ структур Рисунок 9 — Использование методики КНИ в SiGe - технологии 1 2 3
- 13. Формирование внутреннего геттера Рисунок 10 — Светлопольные ПЭМ изображения в поперечном сечении структуры внутреннего дефектного слоя
- 14. Формирование внутреннего геттера
- 15. Формирование внутреннего геттера Рисунок 11 — Зависимость высокочастотной проводимости от глубины в обратносмещенных диодах Шоттки в
- 16. Формирование внутреннего геттера Рисунок 12 — Зависимость времени жизни неосновных носителей заряда от плотности тока обратносмещенного
- 17. Формирование внутреннего геттера Рисунок 13 — DLTS спектры тестовых диодов Шоттки в образцах без (1) и
- 18. Полиэнергетическая ионная имплантация Результирующий профиль распределения примеси при многократной имплантации ионов можно представить как суперпозицию профилей,
- 19. Полиэнергетическая ионная имплантация Расчеты проводились исходя из условия минимизации интегрального отклонения полученных с помощью полиэнергетической имплантации
- 20. Полиэнергетическая ионная имплантация Рисунок 15 — Структура для оценки качества изоляции
- 21. Полиэнергетическая ионная имплантация Рисунок 16 — Зависимость слоевого сопротивления от температуры отжига, измеренная при различных частотах
- 22. РОР-анализ наноразмерных структур Рисунок 17 — Энергетический спектр РОР протонов с энергией 214 кэВ в отожженном
- 24. Скачать презентацию

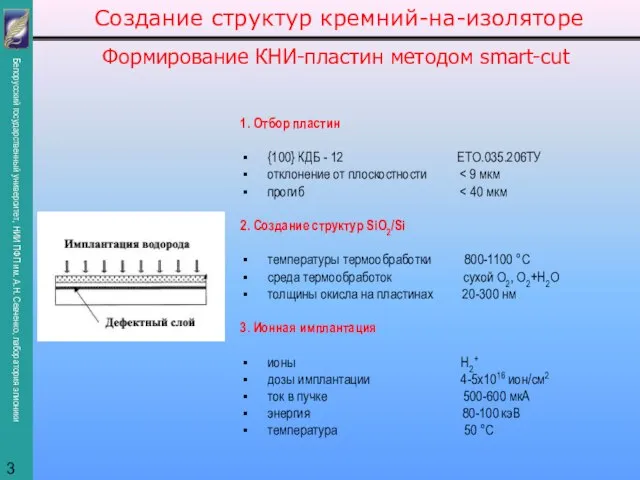

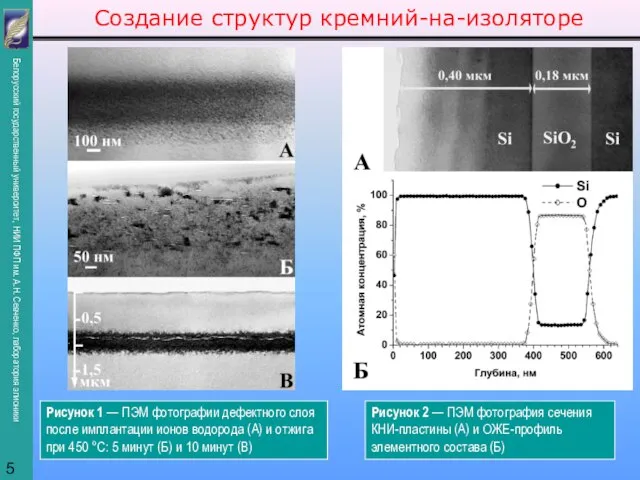
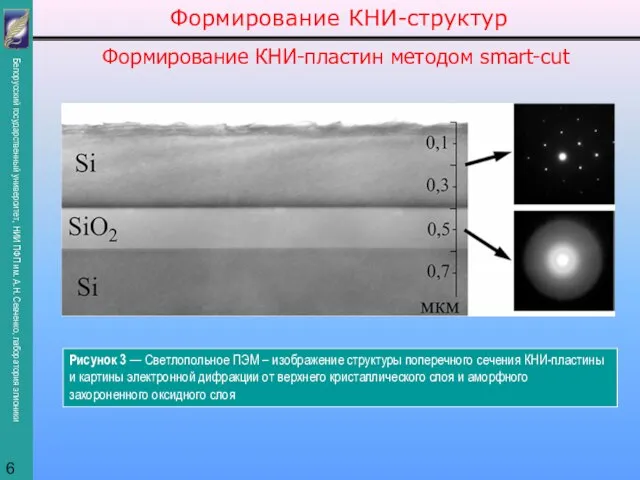
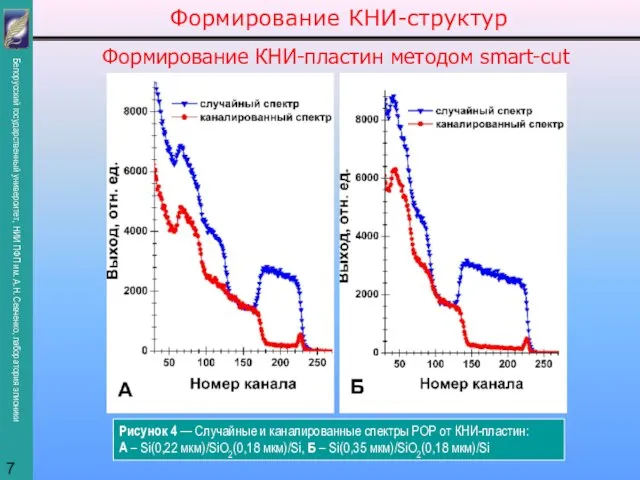
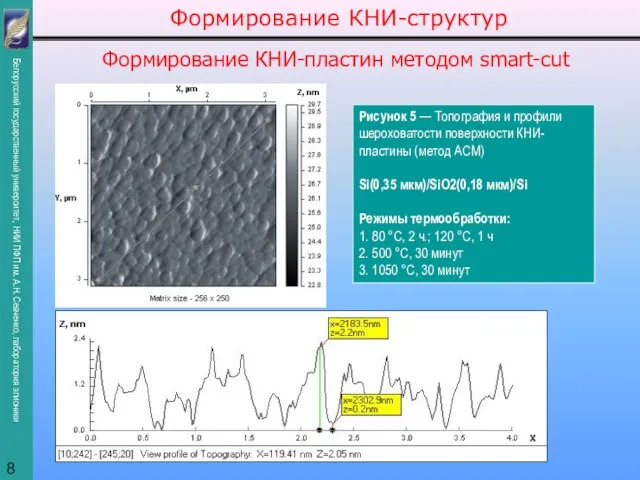
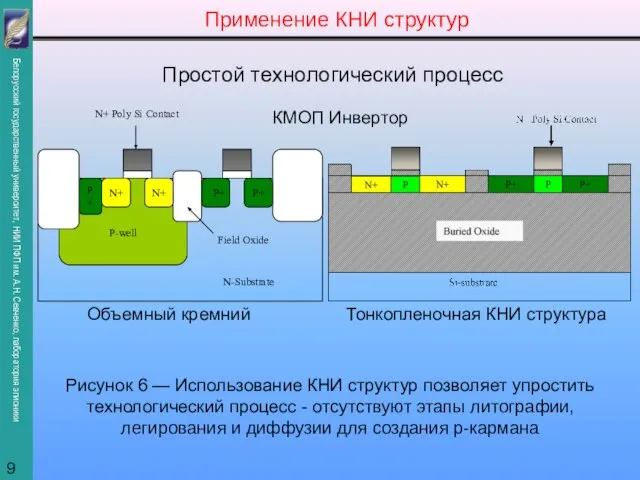
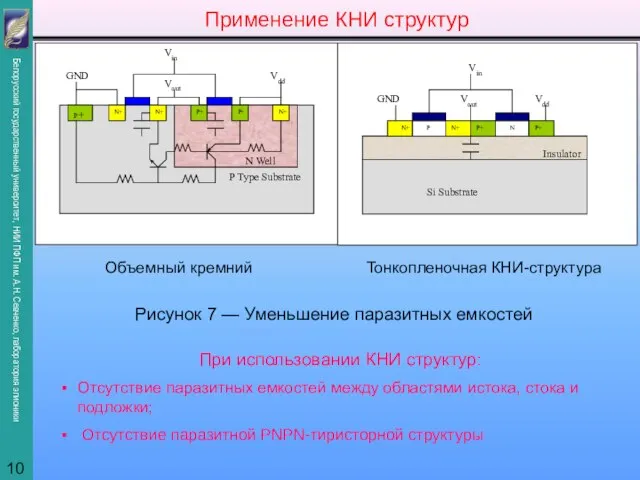

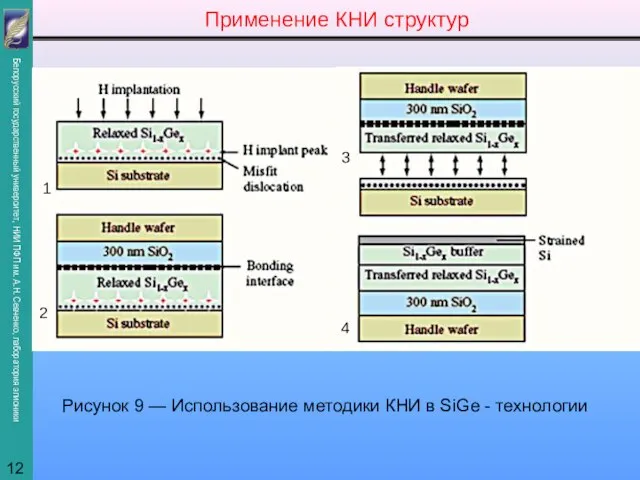


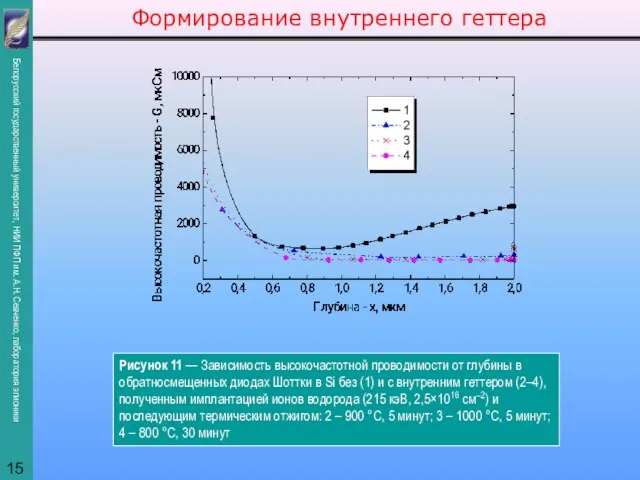
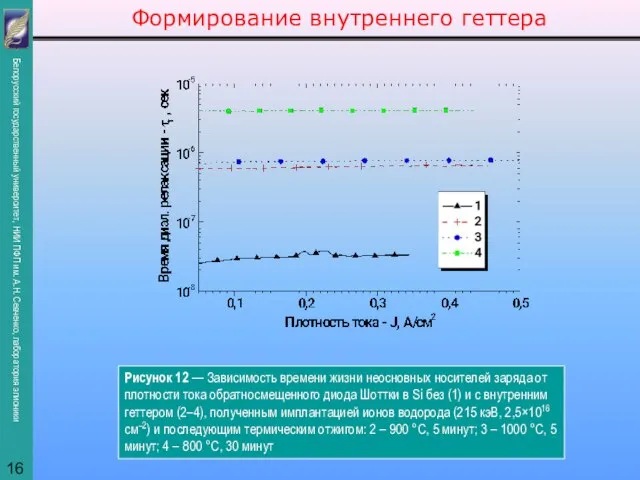





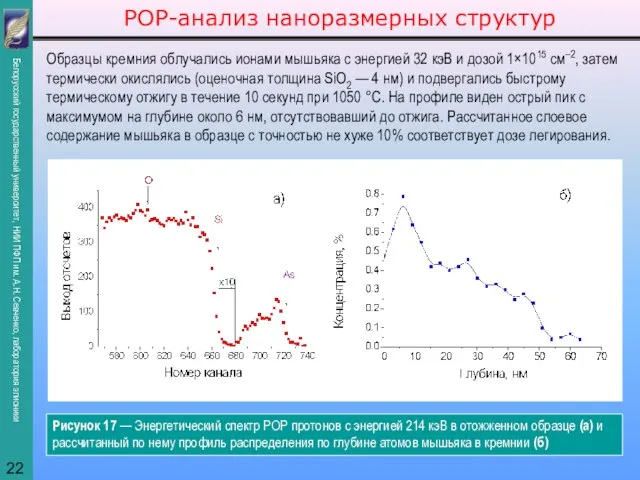
 آموزش سواد رسانه ای – درس سوم
آموزش سواد رسانه ای – درس سوم Раскрытие скобок. Линейные уравнения. Повторение
Раскрытие скобок. Линейные уравнения. Повторение История Древнего Рима (МХК 10 класс)
История Древнего Рима (МХК 10 класс) МОДУЛЬНАЯ
МОДУЛЬНАЯ Лучшие инструменты для сведения звука (саундпродюссинг)
Лучшие инструменты для сведения звука (саундпродюссинг) Деловые документы (автобиография, заявление, резюме )
Деловые документы (автобиография, заявление, резюме ) MixMarket.BIZ
MixMarket.BIZ Практика-Инфекции-3 (Бактериальные)
Практика-Инфекции-3 (Бактериальные) природные условия
природные условия Презентация на тему Правописание сочетаний Чк чн
Презентация на тему Правописание сочетаний Чк чн Реконструкция системы водоснабжения п. Гирей, Краснодарского края
Реконструкция системы водоснабжения п. Гирей, Краснодарского края Правила проведения банных процедур
Правила проведения банных процедур Лексические нормы
Лексические нормы Организация общения дошкольников в повседневной жизни и разнообразных видах деятельности
Организация общения дошкольников в повседневной жизни и разнообразных видах деятельности Натюрморт в графике. ИЗО. 6 класс
Натюрморт в графике. ИЗО. 6 класс Каким ты видишь мир?
Каким ты видишь мир? Завоевание Римом Италии 5 класс
Завоевание Римом Италии 5 класс Как продавать продукцию IEK® в розницу: формула успеха
Как продавать продукцию IEK® в розницу: формула успеха Мини-волейбол
Мини-волейбол Подача питательной воды в парогенератор при запроектной аварии
Подача питательной воды в парогенератор при запроектной аварии Мы дарим впечатления, которые хочется хранить всю жизнь!
Мы дарим впечатления, которые хочется хранить всю жизнь! Алгоритм выбора профессии. Занятие 15
Алгоритм выбора профессии. Занятие 15 Crisis del Salitre
Crisis del Salitre The obligation
The obligation  Презентация на тему Что надо знать про жевательную резинку
Презентация на тему Что надо знать про жевательную резинку Анализ сайта Развитие ребёнка
Анализ сайта Развитие ребёнка Производственный комплекс АГАМА
Производственный комплекс АГАМА Современное состояние, перспективы развития общин КМНС. - презентация
Современное состояние, перспективы развития общин КМНС. - презентация